英特爾未來將推出十六核心的第十二代酷睿處理器的消息(詳見《8+8+1架構(gòu)見過沒!英特爾第十二代酷睿竟抄襲ARM?》)。不過,不少小伙伴都擔(dān)心這次又是“膠水”多核,而且一提到“膠水”就感覺非常Low。實(shí)際上,在當(dāng)前的處理器市場(chǎng),膠水已經(jīng)泛濫,而且它也沒有我們想象的那般不堪。
源于“膠水”的多核心
現(xiàn)在的我們都知道,在絕大多數(shù)情況下處理器的性能與核心數(shù)量成正比,多核“吊打”單核就是天經(jīng)地義。
然而,如何在1顆芯片里塞進(jìn)(通過封裝技術(shù))更多核心?這個(gè)問題曾一度困擾著整個(gè)半導(dǎo)體行業(yè)。
將時(shí)間的指針撥回到1995年P(guān)entium Pro的誕生前夜,受當(dāng)年落后制程工藝(350nm~500nm)的拖累,別說在1顆芯片內(nèi)實(shí)現(xiàn)雙核設(shè)計(jì),就連高速二級(jí)緩存單元都無法同時(shí)與運(yùn)算核心在1顆晶圓顆粒內(nèi)共存。
因此,當(dāng)時(shí)英特爾的解決思路是使用2顆晶圓顆粒,分別用于制造運(yùn)算核心與高速二級(jí)緩存(L2),再將它們一起封裝進(jìn)1塊CPU的基板上,最終造出了Pentium Pro。而這種將雙晶圓“膠合”在一起設(shè)計(jì),就是“膠水雙核”概念的最早來源。
在未來的時(shí)間里,英特爾將“膠水”設(shè)計(jì)進(jìn)一步發(fā)揚(yáng)光大——先是將2個(gè)單核心整合封裝的“奔騰D”(Pentium D)雙核處理器,再到將2個(gè)雙核心整合封裝的Core 2 Quad四核處理器,“膠水”的工藝和配方不斷成熟,這種“膠合”在一起的多核處理器的表現(xiàn)也有所改善。
當(dāng)然,這種由膠水粘貼出來的多核處理器依舊飽受爭(zhēng)議,在當(dāng)年曾一度掀起了“真假雙核”和“真假四核”的討論,大體結(jié)論是“真多核”性能大多領(lǐng)先“假多核”,以至于一提到“膠水多核”大家就一臉鄙夷。
時(shí)至今日,類似的“膠水”技術(shù)仍在處理器領(lǐng)域混的風(fēng)生水起,只是它已經(jīng)不僅限于單純CPU運(yùn)算單元,而是可以“膠合”更多模塊。
“膠水”技術(shù)再度興盛
所謂的“膠水”,主要指的就是MCM (MCM-Multichip Module,多芯片模塊)技術(shù),它能將多顆芯片和其他單元組裝在同一塊多層互連基板上,然后進(jìn)行封裝,從而形成高密度和高可靠性的微電子組件。
第一代酷睿Westmere處理器,將CPU和GPU封裝在同一塊基板內(nèi),它們之間使用QPI總線相連
繼Pentium Pro、Pentium D和Core 2 Quad之后,英特爾還利用MCM技術(shù)先后將CPU和GPU、CPU和PCH、CPU和eDRAM緩存打包組合。
自第二代酷睿起英特爾將內(nèi)存控制器、PCI控制器、GPU全部整合進(jìn)單CPU芯片后,從第四代移動(dòng)版酷睿Haswell開始,英特爾又將PCH南橋芯片與CPU封裝在同一塊基板內(nèi)
集成Iris核顯的28W處理器,其中較小的芯片為eDRAM緩存
AMD也沒閑著。
進(jìn)入Zen架構(gòu)時(shí)代之后,AMD在Ryzen銳龍及EPYC霄龍?zhí)幚砥魃弦惨肓薓CM技術(shù)(官方稱為CCX多核架構(gòu)),它們可以在一塊基板上封裝多個(gè)CPU Die,每個(gè)CPU Die都集成最多8核心16線程的CPU和32MB三級(jí)緩存等單元。
想擁有更多的物理核心和性能,只需搭配不同數(shù)量的CPU Die即可。
I/O die單元為14nm,CPU Die單元為10nm,同一基板上不同的Die由MCM技術(shù)膠合封裝
類似的“膠水多核”還見于英特爾最新的Cascade Lake-AP 48核處理器,其本質(zhì)是由兩個(gè)24核的Cascade Lake處理器通過MCM技術(shù)組合而來,也并非原生48核。
雖然在歷史上“膠水多核”的名聲非常不好,但這項(xiàng)技術(shù)在今天卻有著浴火重生的態(tài)勢(shì)。究其原因,還是摩爾定律逐漸失效,提升頻率和增加核心之路變得越發(fā)艱難。
理論上講,將CPU、GPU、緩存、I/O等控制器打包到同一塊晶圓芯片上(單片電路)最是完美,但在半導(dǎo)體工藝逐漸逼近物理極限的情況下,既想要更多核心,還要更高主頻,集成包括CPU、PCH、I/O單元、DDR內(nèi)存控制器、PCIe控制器和IF控制器在內(nèi)的所有常見功能模塊,成本還不能太高——純屬做夢(mèng)!
因此。在現(xiàn)有工藝的水平上,最經(jīng)濟(jì)可行的解決方案,唯有異構(gòu)MCM之路。
然而,處理器基板的面積有限,表面多顆芯片之間的通訊還存在延遲的隱患,這就需要處理器廠商優(yōu)化封裝技術(shù),并引入更高速的總線接口。
封裝技術(shù)的立體演進(jìn)
想將不同功能模塊單元膠合在同一塊基板上看起來很容易,但現(xiàn)實(shí)情況卻是困難重重。
比如,不是所有功能模塊都需要最先進(jìn)的工藝,CPU和GPU用7nm,內(nèi)存控制器14nm就足夠了,想將這些不同工藝的芯片融合在一起,還要降低成本和保證良品率,這可不是傳統(tǒng)2D封裝技術(shù)能搞定的,于是就有了2.5D封裝技術(shù)。
在2.5D封裝技術(shù)上,知名的方案主要以臺(tái)積電的“InFO”(整合型扇出)和英特爾“EMIB”(嵌入式多芯片互連橋接)為主,前者能以較低成本的有機(jī)封裝來鏈接芯片,但在密度上不如EMIB。
此外。AMD曾在Fury X顯卡首次商業(yè)化的HBM顯存技術(shù)、新一代銳龍?zhí)幚砥?nm CPU Die和14nm I/O Die單元分離的設(shè)計(jì),也是利用了2.5D封裝將GPU核心與HBM核心整合在一個(gè)底座上。
我們可以將以英特爾EMIB為代表的2.5D封裝技術(shù)理解為“平面版”的樂高積木,可以在一個(gè)固定大小的平面上,橫向固定不同樣式和大小的積木塊。
在處理器領(lǐng)域,這些積木塊就變成了由不同工藝打造的不同功能模塊,比如將7nm工藝的CPU、10nm的GPU、14nm的I/O單元、22nm的通訊單元等等。
EMIB的意義就在于能將不同制程的芯片組合在同一基板的封裝之中,同時(shí)它還具有正常的封裝良品率、不需要額外的工藝、設(shè)計(jì)簡(jiǎn)單等優(yōu)點(diǎn)。
英特爾和AMD攜手打造的“Kaby Lake-G”平臺(tái)處理器(整合CoffeeLake-H架構(gòu)的CPU、AMD Vega架構(gòu)的GPU以及4GB HBM2顯存)以及Stratix 10 FPGA就是EMIB技術(shù)的首次預(yù)演。
問題來了,2.5D封裝技術(shù)可以容納多少功能模塊取決于基板大小,對(duì)于絕大多數(shù)處理器的芯片尺寸而言,空間總是不夠用的。
此時(shí),就需要一種類似“立體版”的樂高積木了,可以像蓋樓一般將所有需要的功能模塊一層層地縱向疊加累積起來。
引領(lǐng)未來的3D封裝技術(shù)
提起芯片的堆疊,可能很多朋友都會(huì)想到智能手機(jī)——幾乎所有的新款手機(jī)都會(huì)選擇將內(nèi)存芯片覆蓋在處理器芯片上以節(jié)省主板空間,疊放還能讓處理器和內(nèi)存間的引線長(zhǎng)度最短,從而降低線路噪音、訪問延遲、電力損耗。手機(jī)領(lǐng)域的這種內(nèi)存和處理器“疊羅漢”的設(shè)計(jì)即PoP(元件堆疊裝配),它并非3D封裝,而是“堆疊”,屬于一種多成品芯片之間的焊接技術(shù)。
真正的“3D封裝”,應(yīng)該是一種晶圓對(duì)晶圓(Wafer-On-Wafer)無凸起的鍵合(Bonding)3D IC制程技術(shù)。目前符合這一標(biāo)準(zhǔn)的技術(shù),主要以臺(tái)積電旗下的“SoIC”,以及英特爾主推的“Foveros”的3D封裝技術(shù)為主。
先來看看臺(tái)積電的SoIC技術(shù),它是基于CoWoS與多晶圓堆疊技術(shù)開發(fā)的新一代創(chuàng)新封裝技術(shù),利用硅穿孔(TSV)技術(shù)將多種不同性質(zhì)的臨近芯片整合在一起,用于結(jié)合的機(jī)密材料(號(hào)稱價(jià)值十億美元)能直接透過微小的孔隙溝通多層的芯片,在減少厚度的同時(shí)還能增加多倍以上的性能。
英特爾的Foveros技術(shù)的原理是通過TSV和微凸塊(Micro-Bumps)技術(shù),堆疊其他的晶圓芯片和微芯片。
它可以讓只能在EMIB封裝技術(shù)中以平面分布的功能模塊縱向立體的摞在一起,在犧牲一點(diǎn)點(diǎn)厚度的前提下就可進(jìn)一步壓縮處理器基板的尺寸。
以英特爾Lakefield處理器為例,它在12mm×12mm的面積里就集成了1個(gè)10nm制程的Sunny Cove架構(gòu)CPU大核、4個(gè)10nm制程的Tremont架構(gòu)CPU小核、以及LPDDR4內(nèi)存控制器、L2和L3緩存以及Gen11 GPU單元。
Lakefield處理器和主板與簽字筆的大小對(duì)比
作為目前最高級(jí)的“膠水”,3D封裝技術(shù)能在更小尺寸的芯片里就整合更多的功能模塊。
然而,在制程工藝已逼近物理極限,異構(gòu)計(jì)算大行其道,更多不同類型的芯片需要被集成在一起的大環(huán)境下,無論SoIC還是Foveros似乎都還有所不足。
為了實(shí)現(xiàn)基于封裝技術(shù),就能在更小尺寸的基板上打造出集成多類型小芯片的SoC系統(tǒng)級(jí)單芯片的夢(mèng)想,英特爾祭出了“終極膠水”——將2.5D封裝EMIB和3D封裝Foveros技術(shù)優(yōu)勢(shì)集于一身的“Co-EMIB”方案,它能在將多芯片橫向拼接的同時(shí),還能在任意芯片的表面繼續(xù)疊高樓,并通過全方位互連(ODI)技術(shù)、裸片間接口(MDIO)技術(shù)和硅通孔(TSV)技術(shù)解決多芯片矩陣之間互聯(lián)通訊和延遲等問題。
值得一提的是,AMD在推出HBM顯存產(chǎn)品,實(shí)現(xiàn)了GPU芯片和顯存芯片的2.5D整合封裝后,也即將跟進(jìn)3D封裝技術(shù),初級(jí)目標(biāo)是將DRAM/SRAM和處理器(CPU/GPU)通過TSV(硅穿孔)的方式整合在一顆芯片中,雖然形式上與手機(jī)領(lǐng)域的PoP封裝處理器+內(nèi)存顆粒相似,但底層技術(shù)卻更加先進(jìn)。
總之,在異構(gòu)計(jì)算時(shí)代,“膠水多核”已經(jīng)不再是招人嘲笑的對(duì)象,而是一種符合歷史發(fā)展潮流的必然選擇。只是,借助封裝技術(shù)將更多芯片靈活的“打包”后,需要面臨更為嚴(yán)苛的散熱問題,開發(fā)人員需要更加精心地考慮系統(tǒng)的結(jié)構(gòu)(甚至影響系統(tǒng)的物理結(jié)構(gòu)和芯片的核心架構(gòu)),以適應(yīng)、調(diào)整各個(gè)熱點(diǎn)。
-
處理器
+關(guān)注
關(guān)注
68文章
19535瀏覽量
231858 -
amd
+關(guān)注
關(guān)注
25文章
5516瀏覽量
135018 -
內(nèi)存控制器
+關(guān)注
關(guān)注
0文章
40瀏覽量
9006 -
異構(gòu)計(jì)算
+關(guān)注
關(guān)注
2文章
104瀏覽量
16403
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
光電共封裝技術(shù)CPO的演變與優(yōu)勢(shì)


三分鐘帶你搞懂,芯片封裝的發(fā)展路徑!你知道封裝技術(shù)都有哪些嗎?#華芯邦 #芯片封裝 #封裝路徑 #芯片制造
SIP封裝技術(shù):引領(lǐng)電子封裝新革命!

玻璃基芯片先進(jìn)封裝技術(shù)會(huì)替代Wafer先進(jìn)封裝技術(shù)嗎

先進(jìn)封裝技術(shù)-19 HBM與3D封裝仿真

先進(jìn)封裝技術(shù)-17硅橋技術(shù)(下)

BGA封裝技術(shù)的發(fā)展 BGA封裝的優(yōu)勢(shì)與應(yīng)用
led封裝技術(shù)有哪些
0.5mm層疊封裝應(yīng)用處理器的PCB組裝指南,第II部分





 處理器封裝“膠水”技術(shù)再度興盛 封裝技術(shù)的立體演進(jìn)
處理器封裝“膠水”技術(shù)再度興盛 封裝技術(shù)的立體演進(jìn)
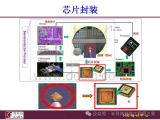
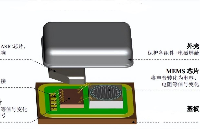










評(píng)論