目前國(guó)內(nèi)絕大多數(shù)IGBT模塊廠家采用傳統(tǒng)硅膠灌封方式;
隨著國(guó)內(nèi)客戶在新能源車用電網(wǎng)電力風(fēng)電方面(1200V以上領(lǐng)域)對(duì)IGBT模塊要求越來(lái)越高;硅膠灌封有不足之處;連續(xù)在高溫200度環(huán)境下工作;性能變差;底部會(huì)產(chǎn)生VOLD;鋁線形變;器件容易擊穿燒毀
代表世界最新技術(shù)的日本超級(jí)IGBT模塊大廠(M社/F社)已逐步采用高耐熱;低熱膨脹低收縮性液態(tài)環(huán)氧來(lái)代替硅膠灌封,國(guó)內(nèi)已有電力方面IGBT模組大公司在進(jìn)行環(huán)氧灌封技術(shù)試驗(yàn)(1200V以上領(lǐng)域)

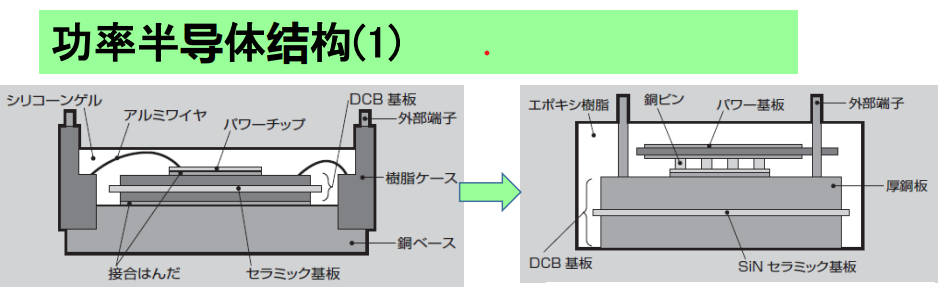
審核編輯:符乾江
-
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28563瀏覽量
232212 -
IGBT
+關(guān)注
關(guān)注
1277文章
4022瀏覽量
253279
發(fā)布評(píng)論請(qǐng)先 登錄
IGBT模塊封裝:高效散熱,可靠性再升級(jí)!

下一代高速銅纜鐵氟龍發(fā)泡技術(shù)

IGBT模塊封裝中環(huán)氧樹脂技術(shù)的現(xiàn)狀與未來(lái)發(fā)展趨勢(shì)探析
納米壓印技術(shù):開創(chuàng)下一代光刻的新篇章
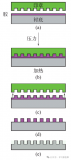
IGBT模塊的環(huán)氧灌封膠應(yīng)用工藝介紹
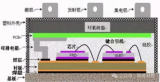
下一代機(jī)器人技術(shù):工業(yè)自動(dòng)化的五大趨勢(shì)
IGBT和SiC封裝用的環(huán)氧材料

通過下一代引線式邏輯IC封裝實(shí)現(xiàn)小型加固型應(yīng)用

日產(chǎn)汽車與本田推進(jìn)下一代軟件平臺(tái)技術(shù)的共同研發(fā)項(xiàng)目
IaaS+on+DPU(IoD)+下一代高性能算力底座技術(shù)白皮書
指紋模組封裝應(yīng)用中有哪些部位用到低溫環(huán)氧膠?

蘋果暫停下一代高端頭顯研發(fā)
24芯M16插頭在下一代技術(shù)中的潛力







 下一代主流IGBT模塊封裝技術(shù)研發(fā)趨勢(shì)--環(huán)氧灌封技術(shù)
下一代主流IGBT模塊封裝技術(shù)研發(fā)趨勢(shì)--環(huán)氧灌封技術(shù)













評(píng)論