短路耐受時間(tsc)對于功率半導(dǎo)體器件來說是一個比較重要的參數(shù),這也是為什么它會成為目前SiC推廣和應(yīng)用中被多次提及的原因。從目前來看,SiC的短路能力相對于先進(jìn)的Si基IGBT來講是低的。有的人就會說了,SiC宣傳得如此強(qiáng)大的材料特性,為什么如此,短路能力這么不夠看呢?當(dāng)然了,萬物皆不可十全十美,有強(qiáng)有弱才是推動發(fā)展的驅(qū)動力。
我們都知道,IGBT發(fā)生短路時,需要在10us或者更短的時間內(nèi)關(guān)閉IGBT,在相同的短路能耗下可以由其他參數(shù)來進(jìn)行調(diào)節(jié),如柵極電壓VGE,母線電壓等,但最終都是為了保證IGBT不會因?yàn)檫^熱而失效。而SiC MOSFET的固有短路能力較小,根本原因也是因?yàn)闊幔窃谟?strong>短路事件前后的溫度分布不合理!
溫度分布
我們來看一下在一定短路時間前后Si IGBT和SiC MOSFET的溫度分布,

可以看出,SiC MOS在3us短路前后,整個器件結(jié)構(gòu)的溫度分布情況,幾乎整個短路能量都在整個結(jié)構(gòu)的前端便面附近產(chǎn)生和消耗。而對于1200V SiC MOSFET,這個有源基區(qū)僅僅在10um的范圍內(nèi)。短路產(chǎn)生的能耗主要產(chǎn)生在這個區(qū)域前端,導(dǎo)致前端區(qū)域溫度升高,尤其在前端的金屬層、柵極氧化物和其他前端部分造成很大的熱應(yīng)力。而這個較大的溫度梯度使得背面的溫度幾乎沒有變化。而Si IGBT的溫度在整個器件結(jié)構(gòu)上分布的更為均勻,最高溫度出現(xiàn)在整個厚度的2/3處。
因此,★為了提高SiC MOSFET的短路耐受性,特別是正面附近相關(guān)的互連結(jié)構(gòu)必須進(jìn)行熱優(yōu)化。
當(dāng)然,從SiC MOSFET的內(nèi)部特性也可以調(diào)整其短路特性(這無可厚非,內(nèi)部權(quán)衡是功率器件一直以來所具有的), 但是這又變得“眾口難調(diào)”的情況,只能“折中”。
內(nèi)部特性權(quán)衡
從SiC MOSFET結(jié)構(gòu)出發(fā),大致由一下幾種方式,這些可以從其飽和電流的公式大致看出,SiC MOSFET飽和電流
ID,sat=k/2*(Vgs-Vgs,th)2
Vgs為柵極電壓,Vgs,th為柵極閾值電壓。
其中,k為通道電導(dǎo)率,可表示為
k=(W*Cox*μn)/L
下面是一個DMOSFET的結(jié)構(gòu),
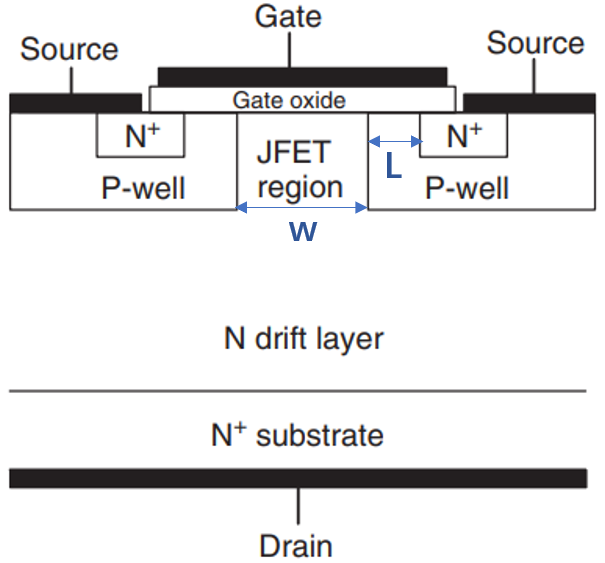
其中,W為JFET寬度,L為溝道長度,Cox為單位面積氧化物電容,μn為電子遷移率。
基于短路時間耐量和飽和電流的關(guān)系,我們可以看出,通過調(diào)整內(nèi)部特性來提高SiC MOSFET的短路耐量,一般由下面幾種權(quán)衡:L通道寬度權(quán)衡、Vgs,th權(quán)衡、Vgs偏置權(quán)衡;也可通過Rds,on來權(quán)衡(所有短路時間都可以通過犧牲Rds,on來實(shí)現(xiàn))。
但是,這種權(quán)衡相應(yīng)地會對溝道電阻產(chǎn)生影響,從下面的溝道電阻公式我們可以看出來,
RCH=1/((W/L)*Cox*μn*(Vgs-Vgs,th))
柵極偏置控制已經(jīng)在SiC MOSFET短路保護(hù)中被應(yīng)用,在檢測到短路時,Vgs立即降低。
下圖給到了這些權(quán)衡的關(guān)系依賴示意圖:
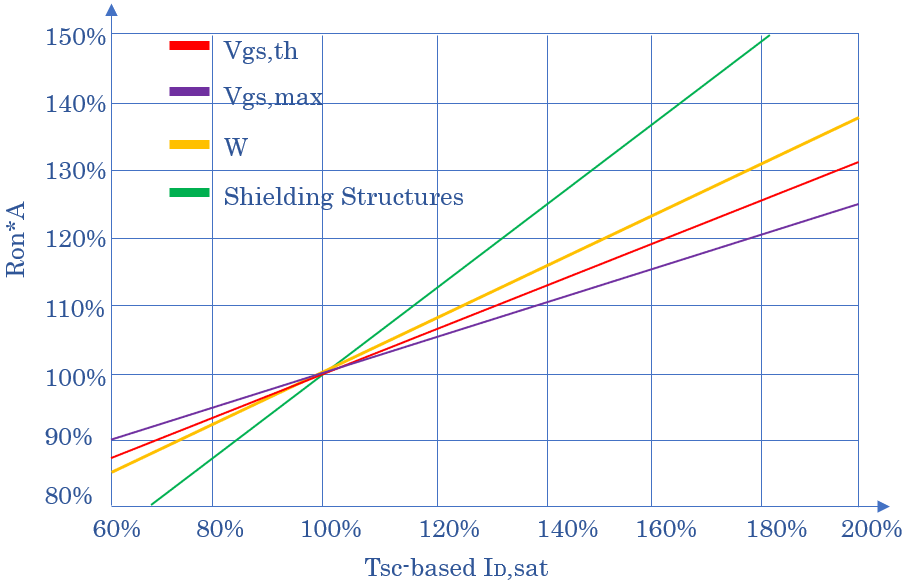
所以,★短路時間和Rds,on之間存在取舍,這也部分說明了SiC MOSFET做出選擇的出發(fā)點(diǎn)。值得一提的是,以短路時間為代價的低Rds,on只可能在一定程度上實(shí)現(xiàn),因?yàn)樽銐虻膱銎帘谓Y(jié)構(gòu)和實(shí)現(xiàn)高柵極氧化物的最小柵極氧化層厚度是有限的。這由于元胞設(shè)計(jì)和電壓等級有關(guān)聯(lián)。
為了實(shí)現(xiàn)高溝道寬度的低Rds,on,與相同電壓等級的Si IGBT相比,SiC MOSFET的"飽和電流和額定電流"的比值ID,sat/Inom往往高很多,一般在10~15倍的范圍內(nèi);而我們知道的10us短路耐受的IGBT來說一般在4~6倍(有助于保證整體較低的短路能耗)的范圍內(nèi)。
另外,飽和電流和電壓等級也有密切關(guān)系。這個關(guān)系的原因歸結(jié)于DIBL,即漏感應(yīng)勢壘降低效應(yīng)(和元胞結(jié)構(gòu)、P屏蔽區(qū)域有關(guān)),該效應(yīng)與SiC MOSFET中的短n溝道有關(guān)。當(dāng)漏源電壓增加時,電場/空間電荷區(qū)域向溝道區(qū)域靠近,有效地縮短了溝道。因此,隨著漏源電壓升高,Vth,gs減小,ID,sat增加(可以結(jié)合上面的飽和電流公式來看)。下圖是DIBL效應(yīng),Vgs,th隨VDS升高而減小,ID,sat隨VDS升高而升高的示意圖。
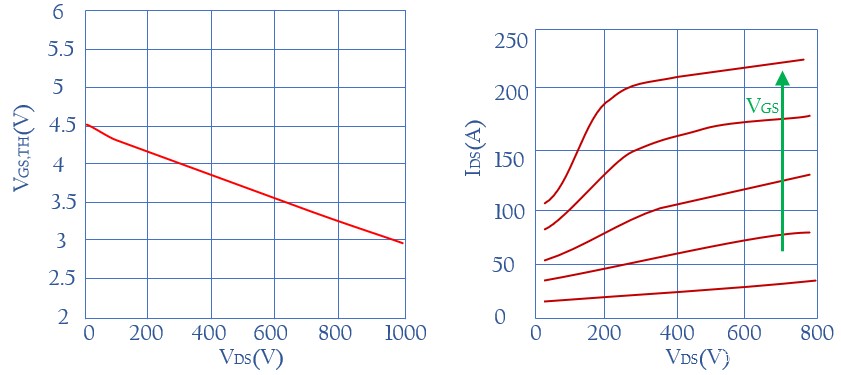
小結(jié)
為了克服Rds,on和短路能力之間的艱難權(quán)衡,越來越多的保護(hù)措施被提出,比如智能門極驅(qū)動方案;好像有的因?yàn)镾iC MOSFET短路時間短,干脆不進(jìn)行短路保護(hù)。當(dāng)然,相信未來會發(fā)展,一切都有希望......
審核編輯:劉清
-
MOSFET
+關(guān)注
關(guān)注
147文章
7572瀏覽量
215474 -
IGBT
+關(guān)注
關(guān)注
1271文章
3876瀏覽量
251106 -
SiC
+關(guān)注
關(guān)注
30文章
2985瀏覽量
63433 -
柵極電壓
+關(guān)注
關(guān)注
0文章
69瀏覽量
12903
原文標(biāo)題:SiC MOSFET短路時間為什么短?!
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導(dǎo)體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
相關(guān)推薦
如何實(shí)現(xiàn)SiC MOSFET的短路檢測及保護(hù)?
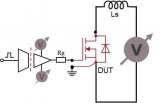
淺談SiC MOSFET芯片的短路能力
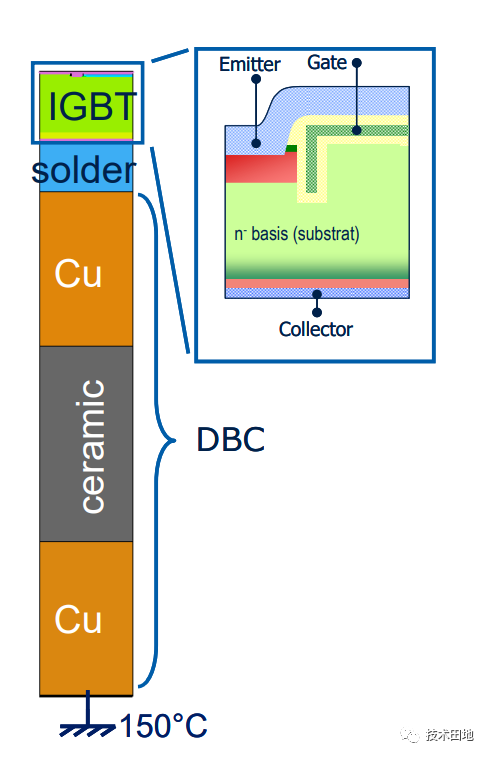
羅姆第4代SiC MOSFET在電動汽車電控系統(tǒng)中的應(yīng)用及其優(yōu)勢
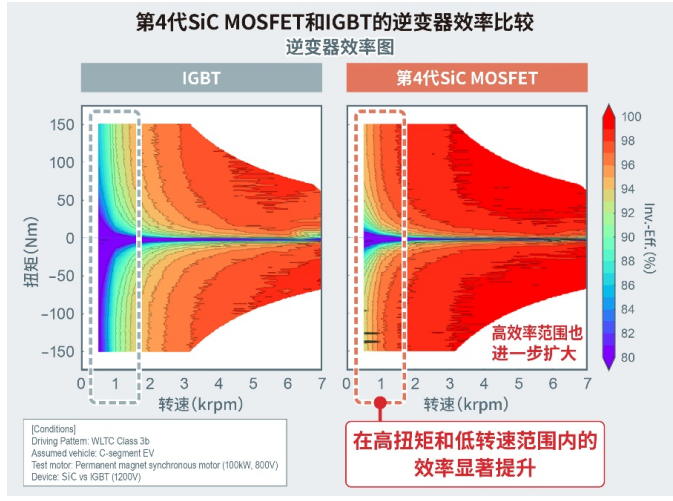
為何使用 SiC MOSFET
SiC-MOSFET的應(yīng)用實(shí)例
SiC-MOSFET功率晶體管的結(jié)構(gòu)與特征比較
SiC-MOSFET與Si-MOSFET的區(qū)別
SiC-MOSFET的可靠性
SiC MOSFET:經(jīng)濟(jì)高效且可靠的高功率解決方案
ROHM開發(fā)出業(yè)界先進(jìn)的第4代低導(dǎo)通電阻SiC MOSFET
SiC MOSFET學(xué)習(xí)筆記1:短路保護(hù)時間

IGBT中的短路耐受時間是什么
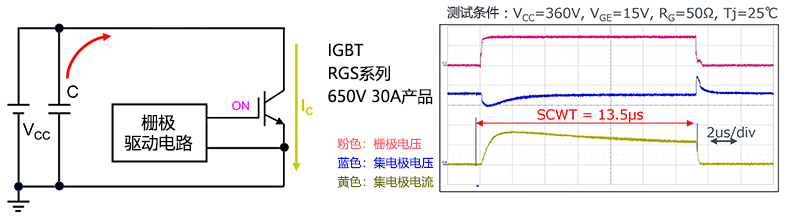
IGBT短路耐受時間的重要性
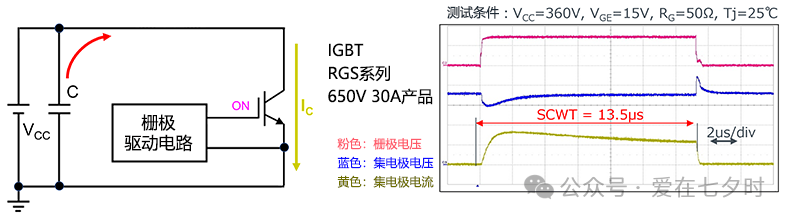




 為什么SiC MOSFET的短路耐受時間比較小
為什么SiC MOSFET的短路耐受時間比較小












評論