選擇性外延工藝
通過圖形化硅氧化或氮化硅掩蔽薄膜生長,可以在掩蔽膜和硅暴露的位置生長外延層。這個過程稱為選擇性外延生長(SEG)。
下圖顯示了利用SEG SiC形成NMOS拉伸應變溝道,以及利用SEG SiGe形成PMOS壓縮應變溝道。
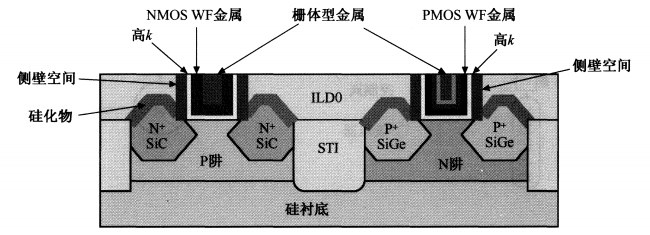
多晶硅沉積
自從20世紀70年代中期離子注入被引入IC生產中作為硅摻雜工藝后,多晶硅就作為柵極材料使用,同時也廣泛用于DRAM芯片的電容器電極。
下圖顯示了多晶硅在先進DRAM 芯片上的應用。
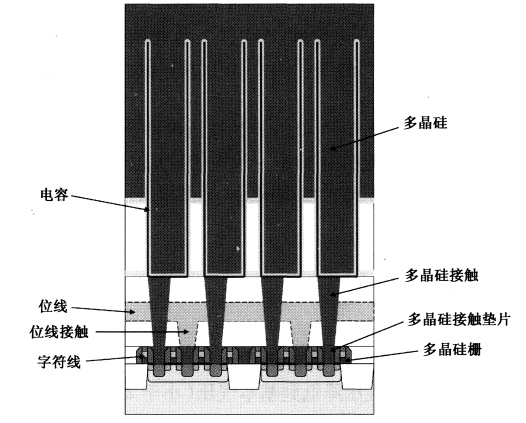
硅化物疊在第一層多晶硅(Poly 1)上形成柵電極和局部連線,第二層多晶硅(Poly 2)形成源極/漏極和單元連線之間的接觸栓塞。
硅化物疊在第三層多晶硅(Poly 3)上形成單元連線,第四層多晶硅(Poly 4)和第五層多晶硅(Poly 5)則形成儲存電容器的兩個電極,中間所夾的是高介電系數的電介質。
為了維持所需的電容值,可以通過使用高介電系數的電介質減少電容的尺寸。
多晶硅沉積是一種低壓化學氣相沉積(UPCVD), 一般在真空系統的爐管中進行(見下圖) 。
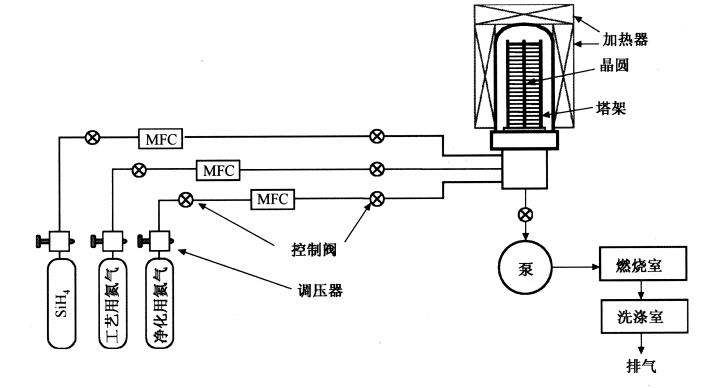
多晶硅沉積一般釆用硅烷(SiH4)化學反應。高溫條件下硅烷將分解并在加熱表面形成硅 沉積,該化學反應可以表示如下:
SiH4 --> Si+2H2
多晶硅也可以使用二氯W(SiH2Cl2, DCS)的化學反應形成沉積。高溫狀態下DCS將和氫反應并在加熱表面形成硅沉積,DCS過程需要的沉積溫度比硅烷過程高。
DCS的化學反應為:
SiH2Cl2+H2 --> Si+2HCl
通過在反應室內(即爐管中)將三氫化碑(ah3 )、三氫化磷(PH3)或二硼烷的摻雜氣體直接輸入硅烷或DCS的硅材料氣體中,就可以進行臨場低壓化學氣相沉積(LPCVD)的多晶硅摻雜過程。
一般情況下,多晶硅沉積是在0.2-1 Torr的低壓條件及600 ~650攝氏度之間的沉積溫度下進行,使用純硅烷或以氮氣稀釋后純度為20% ~30%的硅烷。
這兩種沉積過程的沉積速率都在100?200A/min之間,主要由沉積時的溫度決定。晶圓內的薄膜厚度不均勻性低于4%。
多晶硅沉積過程如下:
?系統閑置時注入吹除凈化氮氣
?系統閑置時注入工藝氮氣
?注入工藝氮氣并載入晶圓
?注入工藝氮氣并降下反應爐管(鐘形玻璃罩)
?關掉氮氣,抽真空使反應室氣壓降低到基本氣壓(小于2 mTorr)
?注入氮氣并穩定晶圓溫度、檢查漏氣
?關掉氮氣,抽真空使氣壓回升到基本氣壓(小于2 mTorr)
?注入氮氣并設置工藝過程所需的氣壓(約250 mTorr)
?開啟SiH4氣流并關掉氮氣,開始沉積
?關掉硅烷氣流并打開柵極活塞,抽真空使氣壓回升到基本氣壓
?關閉柵極活塞,注入氮氣并將氣壓提高到一個大氣壓力
?注入氮氣降低晶圓溫度,然后升起鐘形玻璃罩
?注入工藝氮氣并卸載晶圓 ?
?系統閑置時注入吹除凈化氮氣
LPCVD多晶硅沉積過程主要由工藝溫度、工藝壓力、稀釋過程的硅烷分壓及摻雜物的濃度決定。雖然晶圓的間距和負載尺寸對沉積速率的影響較小,但對晶圓的均勻性相當重要。
多晶硅薄膜的電阻率很大程度上取決于沉積時的溫度、摻雜物濃度及退火溫度,而退火溫度又會影響晶粒的大小。
增加沉積溫度將造成電阻率降低,提高摻雜物濃度會降低電阻率,較高的退火溫度將形成較大尺寸晶粒,并使電阻率隨之下降。
多晶硅的晶粒尺寸越大,其刻蝕工藝就越困難,這是因為大的晶粒尺寸將造成粗糙的多晶側壁,所以必須在低溫下進行多晶硅沉積以獲得較小的晶粒尺寸,經過多晶硅刻蝕和光刻膠剝除,再經過高溫退火形成較大的晶粒尺寸和較低的電阻率。
某些情況是在450攝氏度左右沉積非晶態硅后再進行圖形化、刻蝕及退火,最后形成具有更大、更均勻晶粒尺寸的多晶硅。
審核編輯:劉清
-
電容器
+關注
關注
64文章
6560瀏覽量
101929 -
DRAM芯片
+關注
關注
1文章
88瀏覽量
18282 -
PMOS
+關注
關注
4文章
266瀏覽量
30340
原文標題:半導體行業(一百三十三)——加熱工藝(十四)
文章出處:【微信號:FindRF,微信公眾號:FindRF】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
半導體選擇性外延生長技術的發展歷史

選擇性焊接的工藝流程及特點
PCB選擇性焊接技術介紹
PCB選擇性焊接技術詳細
PCB選擇性焊接工藝難點解析
深度解析PCB選擇性焊接工藝難點
PCB選擇性焊接工藝難點解析
PCB板選擇性焊接工藝
PCB選擇性焊接的工藝特點及流程
半導體前端工藝:刻蝕——有選擇性地刻蝕材料,以創建所需圖形





















評論