引 言
倒裝陶瓷球柵陣列(FC-CBGA:Flip Chip Ceramic Ball Grid Array)封裝技術是IBM公司開發的一種技術,其采用高熔點90Pb-10Sn合金制作焊料球,通過低熔點共晶焊料63Sn/37Pb連接到封裝體及后續的PCB板上[1,2]。由于該封裝具有優秀的電性能、熱性能和可靠性,因而其應用已相當廣泛。
由于業界缺乏統一的工業標準,且出于技術保密和經濟成本的考慮,器件生產廠商提供的器件內部數據和熱參數非常有限,隨著芯片的制程越來越先進,目前7 nm工藝已經量產,芯片的功率和功率密度越來越高,因此對此類倒裝球柵陣列的詳細熱模型進行分析變得十分必要。
國內對CBGA焊球可靠性的熱分析研究得較多,但是對整個封裝體,尤其是封裝體本身的熱衷研究卻很少。高輝等[3]對多芯片陶瓷封裝的結-殼熱阻分析方法進行了研究,研究了多芯片熱耦合對熱阻的影響;Ravl等[4]對FC-CBGA進行了研究,分析了有蓋板和無蓋板的封裝、不同芯片尺寸和不同熱沉條件下芯片結點與環境之間的熱阻Rja的變化,并按照JEDEC標準進行了實驗;謝秀娟等[5]對裸芯式、平板式和蓋板式3種形式、不同芯片尺寸和不同潤滑劑材料對系統熱阻的影響進行了仿真分析,但是都沒有對FC-CBGA結殼熱阻進行分析研究。
本文針對非氣密倒裝焊陶瓷封裝,擬采用現成的熱阻測試芯片設計典型熱阻測試器件,通過有限元建立三維有限元熱模型,分析芯片尺寸、熱沉和導熱膠材料對FC-CBGA結殼熱阻的影響,通過對一種典型器件的熱阻測試驗證了仿真結果的準確性。
1熱阻測試器件設計
采用單元尺寸為2.54 mm×2.54 mm的熱阻測試芯片(如圖1所示)為基礎,考慮陶瓷基板的加工成本,并同時兼顧芯片尺寸、熱沉蓋板和導熱膠對結殼熱阻的測試研究,定制了一款能夠兼容1×1、3×3和5×5熱阻測試單元的通用的陶瓷基板,熱阻測試用CGA管腳從基板的四周引出,如圖2所示。
非氣密性的FC-CCGA的基礎結構如圖3所示,由圖3中可以看出,其由熱沉、導熱膠、芯片、C4凸點陣列、陶瓷基板和測試管腳銅柱組成。
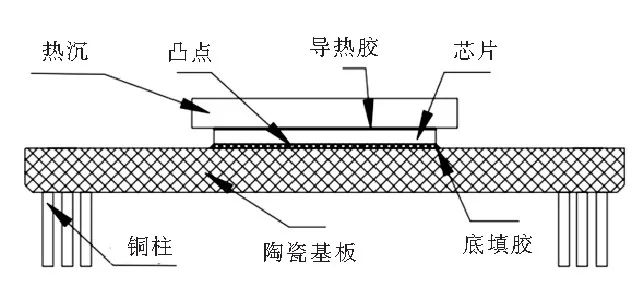
圖3 非氣密性封裝FC-CBGA結構圖
2非氣密倒裝焊陶瓷封裝熱仿真分析
2.1 模型尺寸參數
三維熱模型的結構尺寸參數如表1所示,非氣密性FC-CCGA不同組成部分的熱參數如表2所示。表1 模型結構尺寸非氣密性FC-CCGA不同組成部分熱參數
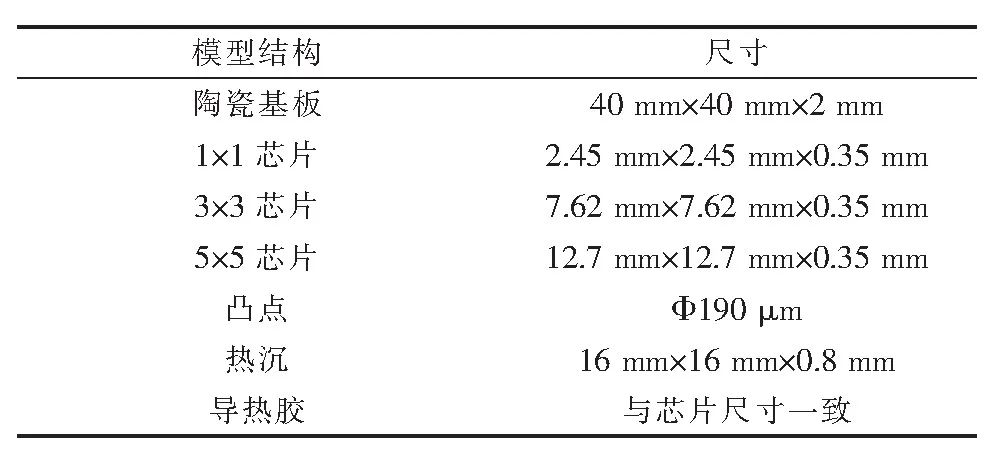
表2 非氣密性FC-CCGA不同組成部分的熱參數

2.2 熱仿真邊界條件
結到殼頂θj-top熱阻的仿真設置為:對封裝體設置四周與底部絕熱,蓋板上表面設置固定參考溫度為60℃,不考慮對流和輻射對散熱的影響。
結到殼底θj-bottom熱阻的仿真設置為:不考慮導熱膠對散熱的影響,對封裝體設置四周與頂部絕熱,下表面設置固定參考溫度為60℃,不考慮對流和輻射對散熱的影響。
2.3 芯片尺寸對熱阻的影響
在基板、熱沉尺寸都相同的情況下,分別仿真1×1、3×3和5×5這3種芯片尺寸對陶瓷封裝熱阻的影響,仿真結果如圖4所示,從圖4中可以看出θj-bottom的熱阻比θj-top的熱阻要大一倍左右。從趨勢上看,芯片尺寸越大,θj-top和θjbottom越小。隨著芯片尺寸的增大,熱阻減小的幅度越大。以θj-top為例,芯片從1×1變為3×3時,尺寸增大了9倍,熱阻降低了6.93倍;從3×3變大到5×5倍時,尺寸增大了2.7倍,熱阻降低了2.6倍。
文獻[6]認為,當熱量從窄區域的芯片傳遞到寬截面基板時,熱流是與材料截面成45°角擴散的。從該角度可以分析,對于1×1的芯片,雖然基板和熱沉尺寸很大,但是對降低熱阻有明顯效果的只有45°角對應的區域。因此對于倒裝焊封裝,從散熱角度考慮,設計與芯片尺寸匹配的基板和熱沉能夠最大化兼顧成本和散熱效率。熱阻45°計算方法示意圖如圖5所示。
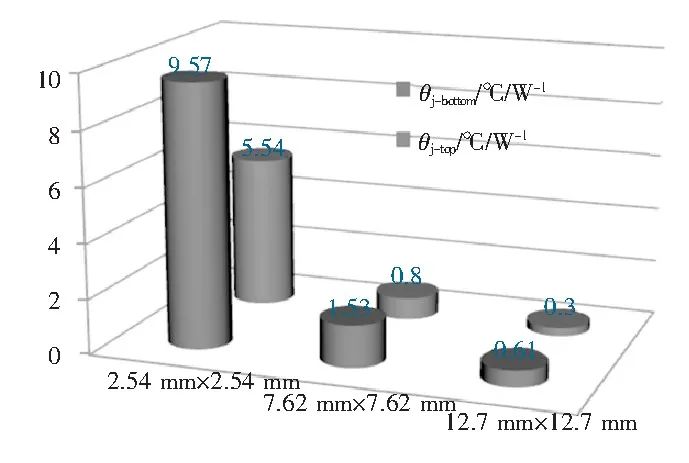
圖4 芯片尺寸對結殼熱阻的影響

圖5 熱阻45°計算方法示意圖
2.4 熱沉及導熱膠對θj-top的影響
對于非氣密性倒裝焊陶瓷封裝而言,熱沉是最重要的散熱路徑,從上面的分析中可以看出,θj-top比θj-bottom還小很多,熱沉蓋板和導熱膠的材料選擇將直接影響封裝體的散熱效果。
為了研究熱沉蓋板材料對熱阻的影響,選取了5組常使用的熱沉蓋板材料,管殼采用40 mm×40 mm×2 mm的尺寸、陶瓷為A440材料,以5×5單元滿陣列發熱的芯片為研究對象進行結殼熱阻仿真分析。熱沉的材料參數特性如表3所示。
結到殼頂熱阻仿真溫度云圖如圖6所示,熱沉熱導率與結-殼頂熱阻θj-top的關系如圖7所示。從圖7中可以看出,θj-top隨著熱沉材料的熱導率的升高而降低,但兩者之間并不是一個線性的關系。材料4J42與AlSiC的熱導率相差10倍,但是熱阻只相差30%。
導熱膠用于粘接芯片和熱沉,導熱膠的選擇需要考慮固化溫度、粘接強度和熱導率。文中選用兩款常用的導熱膠作為分析對象,其材料特性如表4所示。
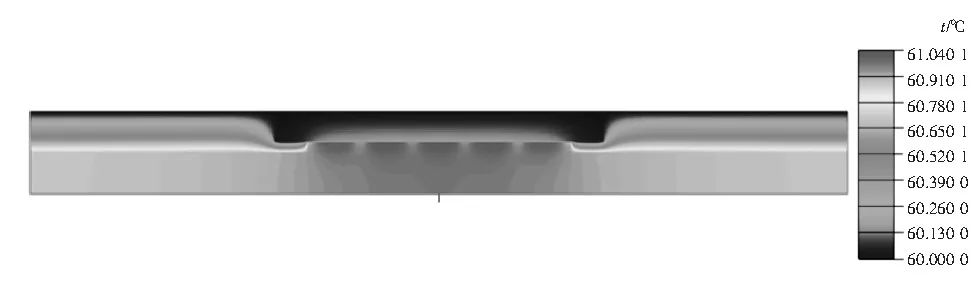
圖6 結到殼頂熱阻仿真溫度云圖
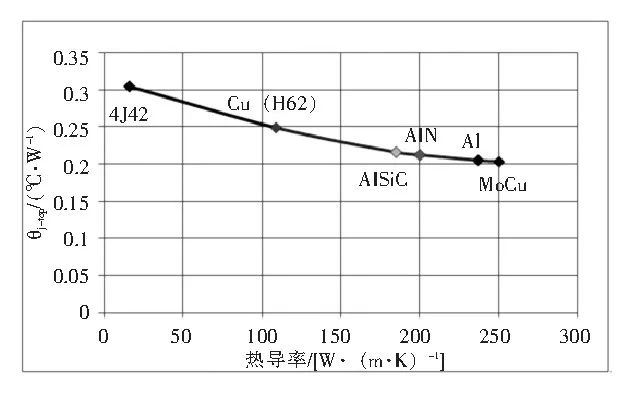
圖7 熱沉蓋板熱導率與θj-top影響
因為導熱膠的熱導率較低,對于θj-top導熱膠的熱導率占比很大,具體的表現形式為,結到殼頂的熱阻隨著導熱膠材料的熱導率的升高而降低,如表5所示。 表5 不同導熱膠對應的θj-top值

3典型器件的結殼熱阻測試驗證
對1×1單元的芯片的典型器件使用熱阻測試儀進行結殼熱阻測試,器件測試圖如圖8所示,測試結果如圖9-10所示。結殼熱阻仿真與實測結果對比如表6所示。從結果看,θj-top與θj-bottom仿真結果與測試結果的誤差小于10%,從而驗證了仿真結果的準確性。
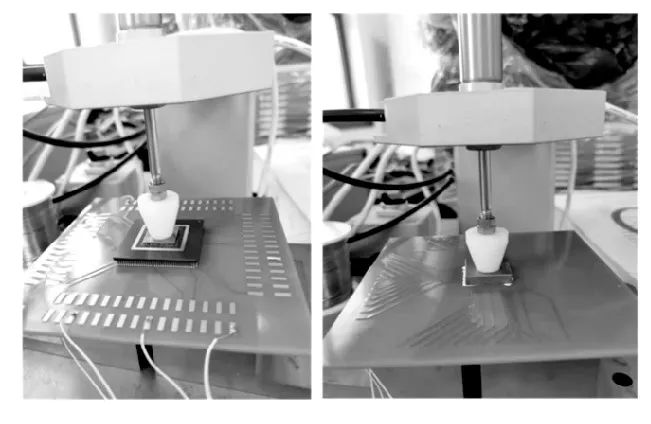
圖8 1×1單元的芯片結殼熱阻側視圖

圖9 θj-top熱阻測試結果

圖10 θj-top熱阻測試結果
表6 結殼熱阻仿真與實測結果對比

4結 束 語
通過上述分析,可以得到以下幾點結論。
a)芯片的尺寸越大,θj-top和θj-bottom越小。隨著芯片尺寸的增大,熱阻減小的幅度越大。設計與芯片尺寸匹配的基板和熱沉能夠最大化兼顧成本和散熱效率。
b)θj-top隨著熱沉材料的熱導率的升高而降低,但并不是一個線性的關系。材料4J42與AlSiC的熱導率相差10倍,但是熱阻只相差30%。
c)θj-top中導熱膠的熱導率占比很大,結到殼頂的熱阻隨著導熱膠材料的熱導率的升高而降低。
d)對1×1單元的芯片的典型器件進行了熱阻測試,并將測試結果與仿真結果進行了對比,結果表明,θj-top和θj-bottom的仿真結果與測試結果之間的誤差小于10%,從而驗證了仿真結果的正確性。
審核編輯:郭婷
-
芯片
+關注
關注
459文章
51607瀏覽量
430031 -
封裝
+關注
關注
127文章
8161瀏覽量
143888
原文標題:非氣密倒裝焊陶瓷封裝熱特性分析及測試驗證
文章出處:【微信號:中科聚智,微信公眾號:中科聚智】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
全面剖析倒裝芯片封裝技術的內在機制、特性優勢、面臨的挑戰及未來走向
基于RC熱阻SPICE模型的GaNPX?和PDFN封裝的熱特性建模

焊接強度測試儀如何助力冷/熱焊凸塊焊接質量評估,一文詳解
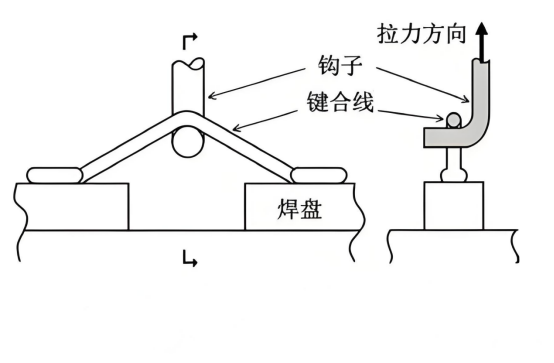
一文弄懂,推拉力測試儀在集成電路倒裝焊試驗中的應用
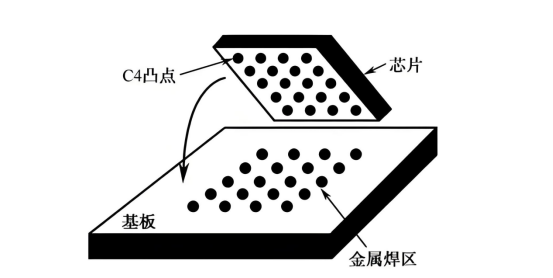
倒裝芯片的優勢_倒裝芯片的封裝形式

倒裝芯片(flip chip)算先進封裝嗎?未來發展怎么樣?

BGA封裝的測試與驗證方法
京瓷光源用的陶瓷封裝產品介紹

OPA2210的熱焊盤是接GND還是V-?
倒裝芯片封裝凸點剪切力測試實例,推拉力測試機應用全解析!
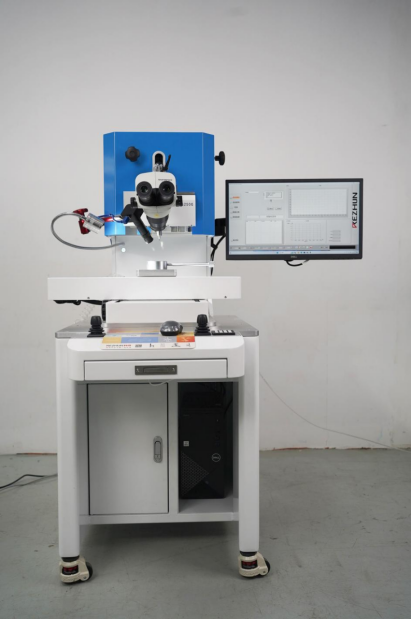








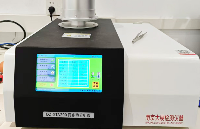












評論