以系統應用為出發點,各種技術進行異質整合的先進封裝技術持續演進。先進封裝也稱為高密度先進封裝HDAP(High Density Advanced Package)。 采用了先進的設計思路和先進的集成工藝、縮短引線互連長度,對芯片進行系統級封裝的重構,并且能有效提高系統功能密度的封裝。現階段的先進封裝是指:倒裝焊(FlipChip)、晶圓級封裝(WLP)、2.5D封裝(Interposer、RDL)、3D封裝(TSV) 與傳統封裝相比,先進封裝的應用范圍不斷擴大,根據Yole數據,預計到 2026 年將占到整個封裝市場的 50% 以上。半導體先進封裝市場簡析(2022)”報告從半導體先進封裝發展背景、半導體先進封裝定義、半導體先進封裝市場結構及規模、半導體先進封裝產業鏈圖譜、半導體先進封裝產業競爭格局進行分析。







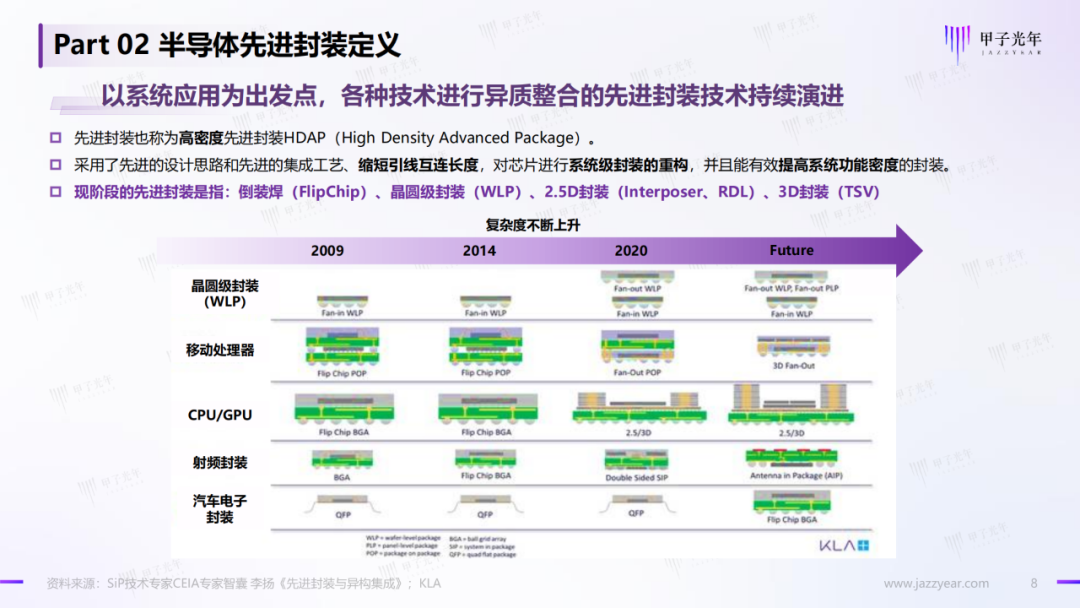





審核編輯 :李倩
-
半導體
+關注
關注
335文章
28754瀏覽量
234883 -
封裝
+關注
關注
128文章
8614瀏覽量
145080 -
先進封裝
+關注
關注
2文章
466瀏覽量
564
原文標題:半導體先進封裝市場簡析(2022)
文章出處:【微信號:AI_Architect,微信公眾號:智能計算芯世界】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
先進碳化硅功率半導體封裝:技術突破與行業變革

芯和半導體將參加重慶半導體制造與先進封測產業發展論壇
制局半導體先進封裝模組制造項目開工

半導體行業加速布局先進封裝技術,格芯和臺積電等加大投入
Silicon Box在意大利建先進半導體封裝廠
半導體材料市場規模不斷增長 國產化持續推進
齊力半導體先進封裝項目一期工廠啟用
人工智能半導體及先進封裝技術發展趨勢

























評論