光刻技術簡單來講,就是將掩膜版圖形曝光至硅片的過程,是大規模集成電路的基礎。目前市場上主流技術是193nm沉浸式光刻技術,CPU所謂30nm工藝或者22nm工藝指的就是采用該技術獲得的電路尺寸。
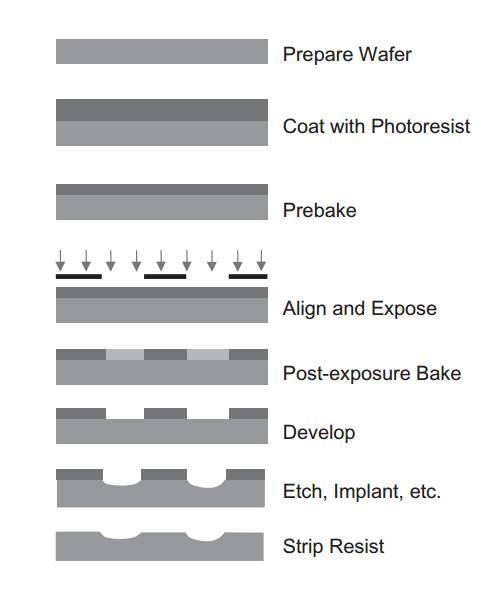
圖1:基本的光刻過程

圖2:核心的曝光成像部分
光刻技術的三大指標分別是焦深、分辨率和產率,下面分別就其中的光學原理進行介紹,簡化后的光路結構示意圖如下:

圖3:簡化光路原理圖(Light Source光源,Condenser Lens聚焦透鏡,Mask掩膜板,Objective Lens投影物鏡,Wafer硅片)
光源和聚焦透鏡構成曝光系統,將特定方向、光譜特征和均勻性的光照投射到圖形制備好的掩膜板上,光照在掩膜板處發生夫瑯禾費衍射,衍射場特定級次的衍射光通過投影物鏡在硅片上成像,這就是基本的成像過程。
從夫瑯禾費衍射的數學表達形式看,積分項經過簡單的線性變換,夫瑯禾費衍射場可以看做是掩膜板處光場的傅里葉變換,不同的衍射級次相對于掩膜板中心有不同的衍射角度,對應頻域中不同空間頻率的平面波。
從對稱的角度考慮,投影物鏡只需要能夠給出掩膜板衍射場的傅里葉逆變換,就可以在硅片上成完善的像,實際無法實現,因為實際投影透鏡總是有限孔徑的,并非掩膜板衍射場的所有衍射級次都可以通過投影物鏡,投影物鏡相當于一個低通濾波器。這里引出一個很有意思的概念-衍射極限,假若成像質量缺陷完全是光學系統的孔徑尺寸限制導致,那么可以說該系統達到了衍射極限。

圖4:波像差示意圖
對于實際投影物鏡,像差會導致點源的波面在傳播過程中偏離球面,偏離光程差采用Zernike多項式表達,因此實際的投影物鏡的光瞳函數還需要乘以像差導致的位相差項。系統離焦可歸結為投影物鏡出瞳出的波像差,由于實際的投影物鏡重達500kg,往往采用階梯曝光加逐場調平的方法,實現硅片對實際投影物鏡焦點的對準,波像差示意圖如下所示:

圖5:硅片處離焦量示意圖
焦深定義為成像質量允許的焦距變化,由上面的概念,實際上是光程差允許的變化。考慮極端情況,一階衍射光處光程差為1/4波長,則0階和1階衍射光不再發生干涉。利用這個概念,有焦深的表達公式:

進一步,可以得出成像分辨率的概念。投影物鏡的數值孔徑決定了能夠進入投影物鏡的衍射光場最大衍射角,對應于最大空間頻率;從干涉成像的角度來說,至少零級和一級衍射光通過投影物鏡,成像才能反映掩膜板圖形的特征尺寸(實際光刻系統0級和±1級衍射光參與成像),最終可以得到:

上式說明為了提升分辨率,必須降低工藝系數k和光源波長,提升投影物鏡數值孔徑,實際上***的發展過程也正是這樣一個過程(參考:***發展歷程)。投影物鏡的光瞳函數表示對光場的調制,當掩膜板趨近于無窮小,利用Point Spread Function可以衡量系統最終分辨率。
下面再來討論產率。硅片往往需要曝光多層,每層曝光采用逐場掃描/曝光的方式,整個光刻系統的產出能力與投影物鏡的設計和加工水平密切相關。實際投影物鏡為雙遠心系統,視場為一個狹縫;曝光系統采用柯拉照明,在該狹縫處形成均勻照明;狹縫和硅片做相對運動,即可完成整個掩膜板的單層曝光過程,經過顯影測量即可完成單層光刻,多層光刻需要更換掩膜板,即單機套刻或流水線作業,進行機機套刻,難點在于不同曝光層的對準。
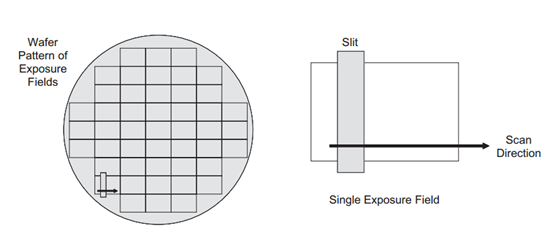
圖6:硅片曝光方式
上面僅僅討論了硅片表面成像的基本光學原理,沒有涉及投影物鏡的放大倍率、光源的斜入射、非相干照明的疊加、光的偏振特性、像方非空氣(沉浸式光刻),也沒有討論光刻膠內成像部分。
相對于激光雷達技術來說,光刻技術由于原理復雜、器件昂貴、工藝繁瑣等,充分利用了計算機仿真技術,從光學成像到工藝,從機械設計到環境變量,從硬件開發到軟件系統,全部實現了關鍵技術仿真,為核心科學問題和關鍵技術問題解決指明了方向,實現了全流程開發的可控,值得我們學習。當然,成本也非常高昂,一切盡在取舍。
-
cpu
+關注
關注
68文章
11029瀏覽量
215862 -
硅片
+關注
關注
13文章
376瀏覽量
35043 -
光刻技術
+關注
關注
1文章
149瀏覽量
16102
發布評論請先 登錄







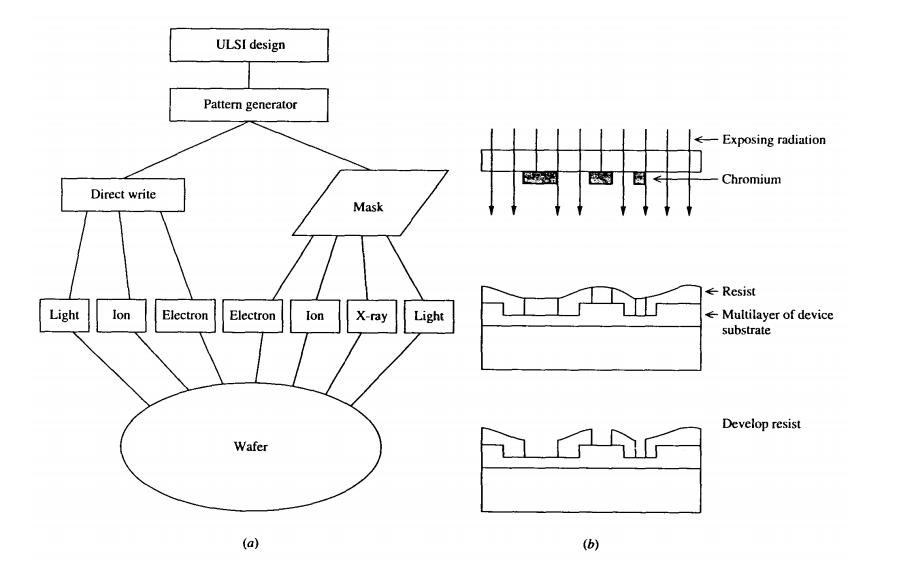
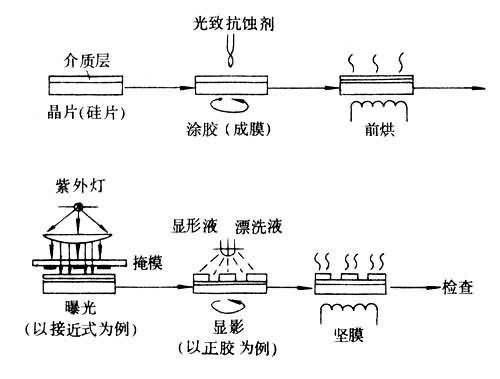











評論