電子發(fā)燒友網(wǎng)報道(文/李寧遠(yuǎn))近日,英特爾發(fā)表聲明展示“業(yè)界首款”用于下一代先進(jìn)封裝的玻璃基板,與現(xiàn)今使用的有機(jī)基板相比,玻璃基板具有卓越的機(jī)械、物理和光學(xué)特性,在單一封裝中可連接更多晶體管,提高延展性并能夠組裝更大的小芯片復(fù)合體。
英特爾指出,玻璃基板憑借優(yōu)秀的平面度有效改善光刻的聚焦深度,提升封裝的良品率,降低加工成本。此外,玻璃基板還具有利于層對層互連覆蓋的物理結(jié)構(gòu)穩(wěn)定性,進(jìn)一步提升封裝的晶體管密度上限,降低封裝功耗。
下一代封裝技術(shù),玻璃基板優(yōu)勢明顯
隨著半導(dǎo)體制程工藝提升越來越困難,先進(jìn)封裝技術(shù)的重要性則愈發(fā)凸顯,成為延續(xù)摩爾定律的關(guān)鍵。在封裝領(lǐng)域,大家聽到的更多的是先進(jìn)封裝技術(shù),其實封裝基板一直是封裝細(xì)分領(lǐng)域的重要組成部分。
封裝基板為芯片提供保護(hù)和支撐,既是芯片向外界散熱的主要途徑,也是實現(xiàn)芯片與外界之間進(jìn)行電流和信號傳輸?shù)闹匾d體。
根據(jù)封裝基板的材料、結(jié)構(gòu)和功能特點常見的封裝基板有很多分類,其中有機(jī)封裝基板是半導(dǎo)體行業(yè)常用的一種基板。有機(jī)封裝基板是一種采用有機(jī)材料作為基板的封裝方式。有機(jī)基板具有較低的成本、較好的加工性能和較輕的重量這些優(yōu)勢,在消費類電子產(chǎn)品的芯片封裝中很常見。
近日英特爾展示用于下一代先進(jìn)封裝的玻璃基板時表示,到本世紀(jì)末,有機(jī)材料基板會迎來技術(shù)瓶頸,有機(jī)材料基板無法進(jìn)一步提高晶體管密度的同時,還面臨著容易收縮形變的問題。例如數(shù)據(jù)中心的系統(tǒng)級封裝(SiP)具有數(shù)十個小片,功耗可能高達(dá)數(shù)千瓦,有機(jī)材料基板作為互連材料已經(jīng)開始乏力。
可以說芯片基板作為芯片的重要組成部分,對芯片性能和穩(wěn)定性有著重要影響,在芯片集成度不斷升級的需求下,有機(jī)材料基板逐漸不能滿足封裝需求。
本次展示的玻璃基板被英特爾譽(yù)為“重大突破”,能夠解決有機(jī)材質(zhì)基板用于芯片封裝產(chǎn)生的翹曲問題,突破有機(jī)材質(zhì)基板受限的性能天花板,讓半導(dǎo)體封裝晶體管數(shù)量極限最大化,同時還具有更省電、散熱更好的優(yōu)勢。
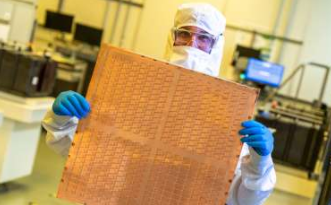
根據(jù)英特爾的說法,這并不意味著用玻璃取代整個基板,而是用玻璃取代有機(jī)封裝中的有機(jī)材料。
玻璃這種無機(jī)非金屬材料,其高硬度、高熔點、熱導(dǎo)性能良好的熱性是成為理想的芯片基板材料的基礎(chǔ)。同時,玻璃基板具有較好的表面平整度和尺寸穩(wěn)定性,玻璃基板的熱膨脹系數(shù)與硅相近,可以有效地減小熱應(yīng)力帶來的影響。而且,在光透過性上,玻璃基板的表現(xiàn)更出色。
根據(jù)公布的信息,該玻璃基板可以承受更高的溫度,將pattern distortion減少了50%,確保了制造過程的精密和準(zhǔn)確。并具有極低的平面度,可改善光刻的聚焦深度,并具有極其緊密的層間互連覆蓋所需的尺寸穩(wěn)定性。英特爾的目標(biāo)是在2030年前將單一封裝芯片中的晶體管數(shù)量上限提高至1萬億個,玻璃基板在內(nèi)的先進(jìn)封裝技術(shù)將會此目標(biāo)提供不少助力。
同時英特爾表示,使用玻璃材料基板能夠提高芯片的供電效率,互連密度相比有機(jī)材料可以提高10倍,將帶寬近翻倍提升至448G。
受益于互連密度的提高,數(shù)據(jù)密集型應(yīng)用的高密度、高性能芯片無疑將率先從這項技術(shù)中受益。英特爾也預(yù)計玻璃基板正式面世后最初將用于需要較大尺寸封裝的應(yīng)用,如涉及數(shù)據(jù)中心和人工智能方向。
助力芯片微縮化,算力增長催生玻璃基板需求
在算力需求迅猛增長的如今,算力已經(jīng)是無法替代的先進(jìn)生產(chǎn)力,是人工智能、大數(shù)據(jù)、物聯(lián)網(wǎng)等先進(jìn)技術(shù)落地應(yīng)用的基礎(chǔ)支撐。下一代先進(jìn)封裝的玻璃基板憑借單一封裝納入更多的晶體管,將實現(xiàn)更強(qiáng)大的算力,持續(xù)推進(jìn)摩爾定律極限。
先進(jìn)芯片的競爭,不論是先進(jìn)制程還是先進(jìn)封裝,都有一個共同點,即在單一封裝納入更多的晶體管進(jìn)一步微縮化,這也是實現(xiàn)更強(qiáng)大算力的前提。
在先進(jìn)制程領(lǐng)域,臺積電和三星都在為2nm制程節(jié)點沖刺,英特爾的Intel 20A、Intel 18A制程節(jié)點也在按計劃推進(jìn)中,預(yù)計在2025年先進(jìn)制程迎來龍頭間階段性的白熱化對決。為了解決芯片進(jìn)一步微縮的難題,業(yè)界也在不斷探索著新的芯片供電網(wǎng)絡(luò)方案。
在半導(dǎo)體先進(jìn)制程領(lǐng)域,工藝在向更小的制程節(jié)點突破,封裝領(lǐng)域的競爭也正在向細(xì)分領(lǐng)域蔓延。英特爾在業(yè)內(nèi)率先推出用于下一代先進(jìn)封裝的玻璃基板,如果進(jìn)展順利,將繼續(xù)推動摩爾定律以數(shù)據(jù)為中心的應(yīng)用的算力需求,為未來的算力時代提供助力。
隨著先進(jìn)技術(shù)對更強(qiáng)大計算需求的增加,半導(dǎo)體行業(yè)進(jìn)入在封裝中使用多個“Chiplet”通過內(nèi)部互聯(lián)的技術(shù)封裝在一起。信號傳輸速度、功率傳輸、設(shè)計規(guī)則和封裝基板穩(wěn)定性等任一項改進(jìn)都對先進(jìn)芯片來說至關(guān)重要。
玻璃基板優(yōu)越的機(jī)械、物理和光學(xué)性能允許在一個封裝內(nèi)連接更多的晶體管,傳輸信號的速度也會更快。芯片架構(gòu)師將能夠在一個封裝里封裝更多的Chiplet,同時實現(xiàn)性能、密度、靈活性的提升并降低功耗。對于半導(dǎo)體行業(yè)來說,芯片微縮進(jìn)程里玻璃基板或許是下一代封裝里必不可少的一環(huán)。
除了英特爾,此前韓國SK集團(tuán)的芯片封裝子公司Absolics宣布進(jìn)入玻璃基板賽道,目標(biāo)是今年建成將成為半導(dǎo)體封裝玻璃基板量產(chǎn)工廠,首先專注于小量生產(chǎn),并計劃自2024年第二季正式投入量產(chǎn)。
日本DNP也表示已開發(fā)出專注于新一代半導(dǎo)體封裝的玻璃基板,量產(chǎn)目標(biāo)時間定在2027年。Absolics和DNP的玻璃基板技術(shù)都源自美國GT PRC,不過二者目前研發(fā)的針對玻璃基板的應(yīng)用有所不同。
寫在最后
雖然玻璃基板技術(shù)距離量產(chǎn),距離引領(lǐng)半導(dǎo)體行業(yè)進(jìn)入下一個封裝時代還需要不少時間突破材料制備上的困難,同時成本和良率也很難在短時間內(nèi)和經(jīng)過長期驗證的有機(jī)基板競爭。但這一進(jìn)展的公布無疑是一個開始,封裝革命的開始,它讓業(yè)內(nèi)看到了玻璃基板已經(jīng)可以提供比當(dāng)前有機(jī)基板更好的信號性能和更密集的布線,是下一代封裝里重要一環(huán)。
隨著半導(dǎo)體行業(yè)的快速發(fā)展,尤其是算力需求的攀升,芯片制造領(lǐng)域的競爭越來越激烈,設(shè)計、制造、封測每個環(huán)節(jié)都可能成為芯片行業(yè)的勝負(fù)手。先進(jìn)封裝領(lǐng)域,競爭已經(jīng)在每一個細(xì)分領(lǐng)域打響。
英特爾指出,玻璃基板憑借優(yōu)秀的平面度有效改善光刻的聚焦深度,提升封裝的良品率,降低加工成本。此外,玻璃基板還具有利于層對層互連覆蓋的物理結(jié)構(gòu)穩(wěn)定性,進(jìn)一步提升封裝的晶體管密度上限,降低封裝功耗。
下一代封裝技術(shù),玻璃基板優(yōu)勢明顯
隨著半導(dǎo)體制程工藝提升越來越困難,先進(jìn)封裝技術(shù)的重要性則愈發(fā)凸顯,成為延續(xù)摩爾定律的關(guān)鍵。在封裝領(lǐng)域,大家聽到的更多的是先進(jìn)封裝技術(shù),其實封裝基板一直是封裝細(xì)分領(lǐng)域的重要組成部分。
封裝基板為芯片提供保護(hù)和支撐,既是芯片向外界散熱的主要途徑,也是實現(xiàn)芯片與外界之間進(jìn)行電流和信號傳輸?shù)闹匾d體。
根據(jù)封裝基板的材料、結(jié)構(gòu)和功能特點常見的封裝基板有很多分類,其中有機(jī)封裝基板是半導(dǎo)體行業(yè)常用的一種基板。有機(jī)封裝基板是一種采用有機(jī)材料作為基板的封裝方式。有機(jī)基板具有較低的成本、較好的加工性能和較輕的重量這些優(yōu)勢,在消費類電子產(chǎn)品的芯片封裝中很常見。
近日英特爾展示用于下一代先進(jìn)封裝的玻璃基板時表示,到本世紀(jì)末,有機(jī)材料基板會迎來技術(shù)瓶頸,有機(jī)材料基板無法進(jìn)一步提高晶體管密度的同時,還面臨著容易收縮形變的問題。例如數(shù)據(jù)中心的系統(tǒng)級封裝(SiP)具有數(shù)十個小片,功耗可能高達(dá)數(shù)千瓦,有機(jī)材料基板作為互連材料已經(jīng)開始乏力。
可以說芯片基板作為芯片的重要組成部分,對芯片性能和穩(wěn)定性有著重要影響,在芯片集成度不斷升級的需求下,有機(jī)材料基板逐漸不能滿足封裝需求。
本次展示的玻璃基板被英特爾譽(yù)為“重大突破”,能夠解決有機(jī)材質(zhì)基板用于芯片封裝產(chǎn)生的翹曲問題,突破有機(jī)材質(zhì)基板受限的性能天花板,讓半導(dǎo)體封裝晶體管數(shù)量極限最大化,同時還具有更省電、散熱更好的優(yōu)勢。
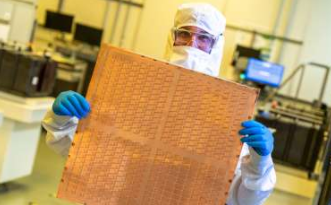
英特爾玻璃基板實物(圖源:英特爾)
根據(jù)英特爾的說法,這并不意味著用玻璃取代整個基板,而是用玻璃取代有機(jī)封裝中的有機(jī)材料。
玻璃這種無機(jī)非金屬材料,其高硬度、高熔點、熱導(dǎo)性能良好的熱性是成為理想的芯片基板材料的基礎(chǔ)。同時,玻璃基板具有較好的表面平整度和尺寸穩(wěn)定性,玻璃基板的熱膨脹系數(shù)與硅相近,可以有效地減小熱應(yīng)力帶來的影響。而且,在光透過性上,玻璃基板的表現(xiàn)更出色。
根據(jù)公布的信息,該玻璃基板可以承受更高的溫度,將pattern distortion減少了50%,確保了制造過程的精密和準(zhǔn)確。并具有極低的平面度,可改善光刻的聚焦深度,并具有極其緊密的層間互連覆蓋所需的尺寸穩(wěn)定性。英特爾的目標(biāo)是在2030年前將單一封裝芯片中的晶體管數(shù)量上限提高至1萬億個,玻璃基板在內(nèi)的先進(jìn)封裝技術(shù)將會此目標(biāo)提供不少助力。
同時英特爾表示,使用玻璃材料基板能夠提高芯片的供電效率,互連密度相比有機(jī)材料可以提高10倍,將帶寬近翻倍提升至448G。
受益于互連密度的提高,數(shù)據(jù)密集型應(yīng)用的高密度、高性能芯片無疑將率先從這項技術(shù)中受益。英特爾也預(yù)計玻璃基板正式面世后最初將用于需要較大尺寸封裝的應(yīng)用,如涉及數(shù)據(jù)中心和人工智能方向。
助力芯片微縮化,算力增長催生玻璃基板需求
在算力需求迅猛增長的如今,算力已經(jīng)是無法替代的先進(jìn)生產(chǎn)力,是人工智能、大數(shù)據(jù)、物聯(lián)網(wǎng)等先進(jìn)技術(shù)落地應(yīng)用的基礎(chǔ)支撐。下一代先進(jìn)封裝的玻璃基板憑借單一封裝納入更多的晶體管,將實現(xiàn)更強(qiáng)大的算力,持續(xù)推進(jìn)摩爾定律極限。
先進(jìn)芯片的競爭,不論是先進(jìn)制程還是先進(jìn)封裝,都有一個共同點,即在單一封裝納入更多的晶體管進(jìn)一步微縮化,這也是實現(xiàn)更強(qiáng)大算力的前提。
在先進(jìn)制程領(lǐng)域,臺積電和三星都在為2nm制程節(jié)點沖刺,英特爾的Intel 20A、Intel 18A制程節(jié)點也在按計劃推進(jìn)中,預(yù)計在2025年先進(jìn)制程迎來龍頭間階段性的白熱化對決。為了解決芯片進(jìn)一步微縮的難題,業(yè)界也在不斷探索著新的芯片供電網(wǎng)絡(luò)方案。
在半導(dǎo)體先進(jìn)制程領(lǐng)域,工藝在向更小的制程節(jié)點突破,封裝領(lǐng)域的競爭也正在向細(xì)分領(lǐng)域蔓延。英特爾在業(yè)內(nèi)率先推出用于下一代先進(jìn)封裝的玻璃基板,如果進(jìn)展順利,將繼續(xù)推動摩爾定律以數(shù)據(jù)為中心的應(yīng)用的算力需求,為未來的算力時代提供助力。
隨著先進(jìn)技術(shù)對更強(qiáng)大計算需求的增加,半導(dǎo)體行業(yè)進(jìn)入在封裝中使用多個“Chiplet”通過內(nèi)部互聯(lián)的技術(shù)封裝在一起。信號傳輸速度、功率傳輸、設(shè)計規(guī)則和封裝基板穩(wěn)定性等任一項改進(jìn)都對先進(jìn)芯片來說至關(guān)重要。
玻璃基板優(yōu)越的機(jī)械、物理和光學(xué)性能允許在一個封裝內(nèi)連接更多的晶體管,傳輸信號的速度也會更快。芯片架構(gòu)師將能夠在一個封裝里封裝更多的Chiplet,同時實現(xiàn)性能、密度、靈活性的提升并降低功耗。對于半導(dǎo)體行業(yè)來說,芯片微縮進(jìn)程里玻璃基板或許是下一代封裝里必不可少的一環(huán)。
除了英特爾,此前韓國SK集團(tuán)的芯片封裝子公司Absolics宣布進(jìn)入玻璃基板賽道,目標(biāo)是今年建成將成為半導(dǎo)體封裝玻璃基板量產(chǎn)工廠,首先專注于小量生產(chǎn),并計劃自2024年第二季正式投入量產(chǎn)。
日本DNP也表示已開發(fā)出專注于新一代半導(dǎo)體封裝的玻璃基板,量產(chǎn)目標(biāo)時間定在2027年。Absolics和DNP的玻璃基板技術(shù)都源自美國GT PRC,不過二者目前研發(fā)的針對玻璃基板的應(yīng)用有所不同。
寫在最后
雖然玻璃基板技術(shù)距離量產(chǎn),距離引領(lǐng)半導(dǎo)體行業(yè)進(jìn)入下一個封裝時代還需要不少時間突破材料制備上的困難,同時成本和良率也很難在短時間內(nèi)和經(jīng)過長期驗證的有機(jī)基板競爭。但這一進(jìn)展的公布無疑是一個開始,封裝革命的開始,它讓業(yè)內(nèi)看到了玻璃基板已經(jīng)可以提供比當(dāng)前有機(jī)基板更好的信號性能和更密集的布線,是下一代封裝里重要一環(huán)。
隨著半導(dǎo)體行業(yè)的快速發(fā)展,尤其是算力需求的攀升,芯片制造領(lǐng)域的競爭越來越激烈,設(shè)計、制造、封測每個環(huán)節(jié)都可能成為芯片行業(yè)的勝負(fù)手。先進(jìn)封裝領(lǐng)域,競爭已經(jīng)在每一個細(xì)分領(lǐng)域打響。
聲明:本文內(nèi)容及配圖由入駐作者撰寫或者入駐合作網(wǎng)站授權(quán)轉(zhuǎn)載。文章觀點僅代表作者本人,不代表電子發(fā)燒友網(wǎng)立場。文章及其配圖僅供工程師學(xué)習(xí)之用,如有內(nèi)容侵權(quán)或者其他違規(guī)問題,請聯(lián)系本站處理。
舉報投訴
-
芯片設(shè)計
+關(guān)注
關(guān)注
15文章
1041瀏覽量
55214 -
玻璃基板
+關(guān)注
關(guān)注
1文章
94瀏覽量
10516 -
基板
+關(guān)注
關(guān)注
2文章
291瀏覽量
23221 -
先進(jìn)封裝
+關(guān)注
關(guān)注
2文章
437瀏覽量
349
發(fā)布評論請先 登錄
相關(guān)推薦
迎接玻璃基板時代:TGV技術(shù)引領(lǐng)下一代先進(jìn)封裝發(fā)展
在AI高性能芯片需求的推動下,玻璃基板封裝被寄予厚望。據(jù)Prismark統(tǒng)計,預(yù)計2026年全球IC封裝基板行業(yè)規(guī)模將達(dá)到214億美元,而隨

AGC Inc:玻璃基板正在向美國和中國客戶提供樣品
和中國客戶提供樣品。 AGC Inc 前身為旭硝子株式會社,戰(zhàn)略創(chuàng)新產(chǎn)品包括 EUV 光掩模坯料和用于半導(dǎo)體 CMP 工藝的二氧化鈰漿料。玻璃芯基板被AGC認(rèn)為是繼EUV之后的下一代半

AMD加入玻璃基板戰(zhàn)局
流氓或競爭對手起訴它。包括英特爾和三星在內(nèi)的大多數(shù)芯片制造商都在探索未來處理器的玻璃基板。盡管AMD不再生產(chǎn)自己的芯片,而是將其外包給臺積電,但它仍然擁有硅片和芯片

京東方披露玻璃基板及先進(jìn)封裝技術(shù)新進(jìn)展
未來半導(dǎo)體于10月25日發(fā)布消息,在芯和半導(dǎo)體EDA用戶大會上,北京京東方傳感技術(shù)有限公司傳感研究院院長車春城透露了京東方(BOE)在先進(jìn)玻璃基板技術(shù)方面的最新動態(tài)。據(jù)悉,為了迎接20
淺談英特爾在先進(jìn)封裝領(lǐng)域的探索
隨著工藝節(jié)點的進(jìn)步,英特爾也在不斷推進(jìn)下一代封裝技術(shù)的發(fā)展。對高性能硅需求與工藝節(jié)點開發(fā)相結(jié)合,創(chuàng)造了一種新的方案,即處理器不再是單片硅,而是依賴于多個較小(且可能優(yōu)化過)的
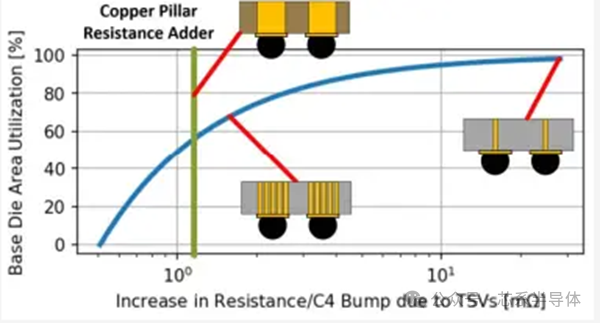
特種玻璃巨頭肖特發(fā)力半導(dǎo)體業(yè)務(wù),新材料基板成為下一代芯片突破口
后摩爾時代到來,全球行業(yè)頭部公司先后宣布,選擇特種玻璃作為下一代半導(dǎo)體封裝基板最具潛力的新材料之一,并且在近兩年紛紛布局相關(guān)產(chǎn)線。 行業(yè)數(shù)據(jù)
發(fā)表于 09-12 14:20
?1142次閱讀
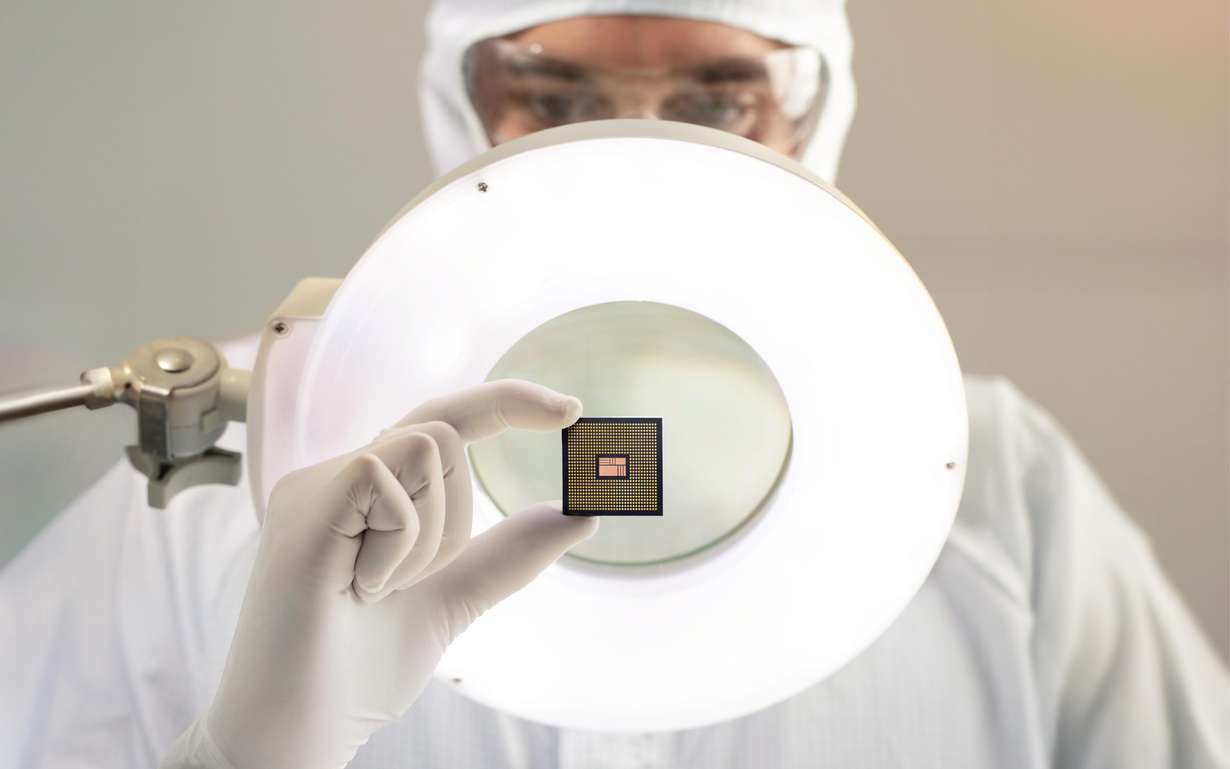
英特爾是如何實現(xiàn)玻璃基板的?
在今年9月,英特爾宣布率先推出用于下一代先進(jìn)封裝的玻璃基板,并計劃在未來幾年內(nèi)向市場提供完整的解
英特爾計劃最快2026年量產(chǎn)玻璃基板
在全球半導(dǎo)體封裝技術(shù)的演進(jìn)中,英特爾近日宣布了一項引人注目的計劃——最快在2026年實現(xiàn)玻璃基板的量產(chǎn)。這
英特爾引領(lǐng)未來封裝革命:玻璃基板預(yù)計2026年實現(xiàn)量產(chǎn)
在全球科技競爭日益激烈的今天,英特爾作為半導(dǎo)體行業(yè)的領(lǐng)軍者,不斷推動著技術(shù)創(chuàng)新的邊界。近日,英特爾宣布了一項重大計劃,預(yù)計將在2026年至2030年之間實現(xiàn)其玻璃
玻璃基板時代,TGV技術(shù)引領(lǐng)基板封裝
支持,是行業(yè)發(fā)展的重要方向。 ? 在先進(jìn)封裝領(lǐng)域,玻璃基板現(xiàn)在是半導(dǎo)體基板材料的前沿?zé)狳c,玻璃
英特爾加大玻璃基板技術(shù)布局力度
近日,全球領(lǐng)先的半導(dǎo)體制造商英特爾宣布,將大幅增加對多家設(shè)備和材料供應(yīng)商的訂單,旨在生產(chǎn)基于玻璃基板技術(shù)的下一代先進(jìn)
英特爾增加下一代先進(jìn)封裝技術(shù)訂單投入
盡管如此,英特爾在近期公布的報告中表示,新實施的出口限制措施將會給公司下個季度的營收帶來較大壓力。據(jù)悉,英特爾預(yù)計在2024年第二季度的收入仍將穩(wěn)定在125億至135億美元左右,然而,市場分析師普遍認(rèn)為這
下一代芯片重要技術(shù) —— 玻璃基板,封裝競爭新節(jié)點?
來源:EEPW,謝謝 編輯:感知芯視界 Link 根據(jù)最新市場消息。蘋果正積極與多家供應(yīng)商商討將玻璃基板技術(shù)應(yīng)用于芯片開發(fā),以提供更好散熱性能,使芯片在更長時間內(nèi)保持峰值性能。同時,玻璃




 英特爾公布玻璃芯研發(fā)進(jìn)展,玻璃基板或引領(lǐng)下一代先進(jìn)封裝
英特爾公布玻璃芯研發(fā)進(jìn)展,玻璃基板或引領(lǐng)下一代先進(jìn)封裝












評論