
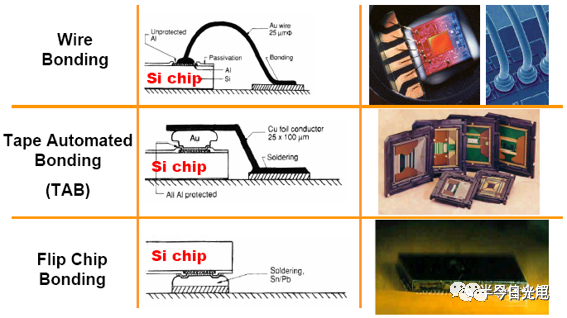
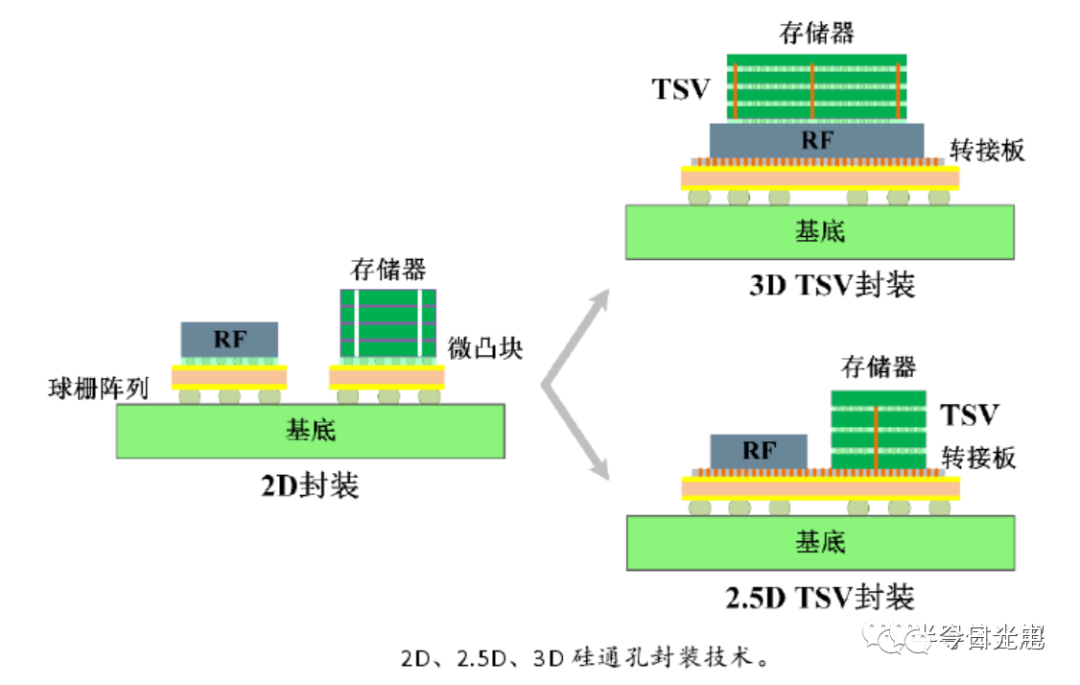



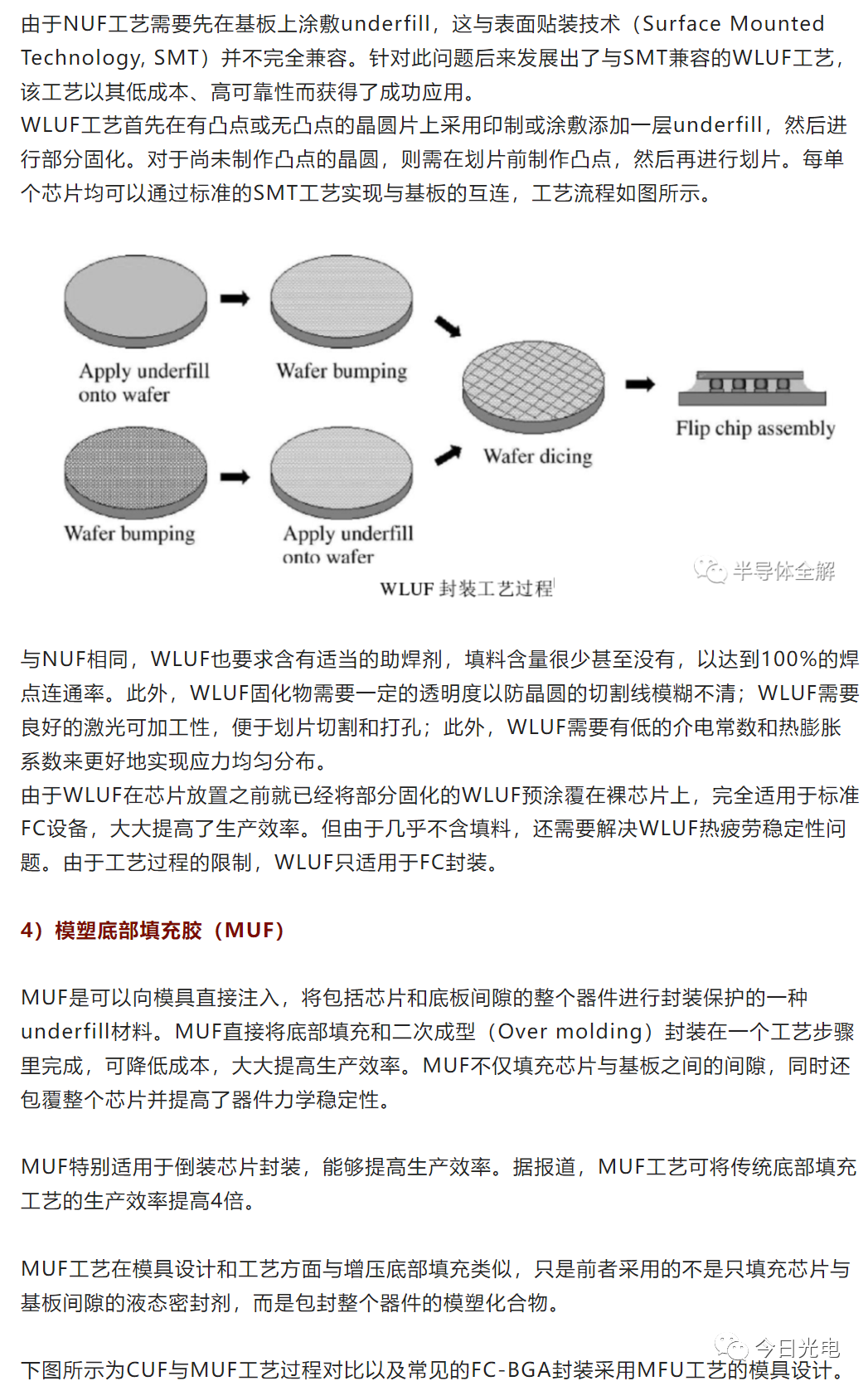

審核編輯:劉清
聲明:本文內容及配圖由入駐作者撰寫或者入駐合作網站授權轉載。文章觀點僅代表作者本人,不代表電子發燒友網立場。文章及其配圖僅供工程師學習之用,如有內容侵權或者其他違規問題,請聯系本站處理。
舉報投訴
-
PCB板
+關注
關注
27文章
1455瀏覽量
52329 -
晶體管
+關注
關注
77文章
9837瀏覽量
139493 -
嵌入式芯片
+關注
關注
4文章
231瀏覽量
27813 -
芯片封裝
+關注
關注
11文章
536瀏覽量
30876 -
TSV
+關注
關注
4文章
117瀏覽量
81654
原文標題:【光電集成】一文了解芯片封裝及底部填充(Underfill)技術
文章出處:【微信號:今日光電,微信公眾號:今日光電】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
相關推薦
【先進封裝】Underfill的基本特性
底部填充膠在使用過程中,主要的問題是空洞,出現空洞的原因與其封裝設計、點膠工藝、固化參數等相關。而要分析空洞就需要對Underfill的特性有個基本的認識。今天就分別就空洞的特征和
發表于 05-18 10:26
?922次閱讀

underfill底部填充工藝用膠解決方案
underfill底部填充工藝用膠解決方案由漢思新材料提供隨著手機、電腦等便攜式電子產品的發展趨向薄型化、小型化、高性能化,IC封裝也趨向小型化、高聚集化方向發展。而

芯片封裝膠underfill底部填充膠點膠工藝基本操作流程
的脫落。在烘烤工藝中,參數制定的依據PCBA重量的變化,具體可以咨詢漢思新材料。二、預熱對主板進行預熱,可以提高Underfill底部填充膠的流動性。要注意的是——

先進封裝Underfill工藝中的四種常用的填充膠CUF,NUF,WLUF和MUF介紹
今天我們再詳細看看Underfill工藝中所用到的四種填充膠:CUF,NUF,WLUF和MUF。 倒裝芯片的底部填充工藝一般分為三種:毛細





 芯片封裝及底部填充(Underfill)技術詳解
芯片封裝及底部填充(Underfill)技術詳解
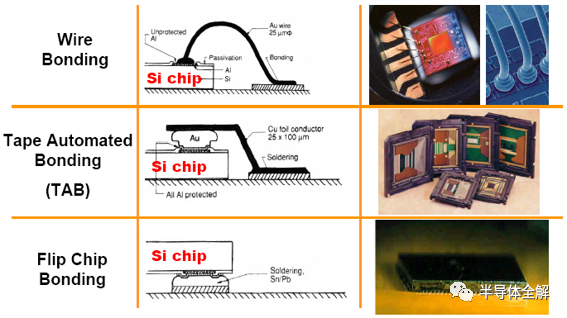




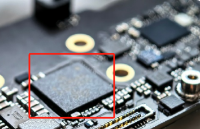


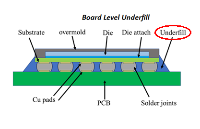











評論