英偉達AI芯片龍頭企業計劃于2026年前推廣面板級扇出型封裝,寄望以此解決CoWoS先進封裝產能緊張,AI芯片供應短缺的問題,打破當前CoWoS在AI先進封裝領域的壟斷地位。
臺灣封測廠商中,力成在面板級扇出型封裝方面的進展最為迅速,已經獲得多家國際IC設計大廠的合作意向,對英偉達引領面板級扇出型封裝新時代表示歡迎,期待抓住商業機遇。
業內人士普遍認為,英偉達的倡導將為臺灣封測行業帶來更多訂單機會。同時,英特爾、AMD等半導體巨頭也紛紛涉足面板級扇出型封裝,預計將使AI芯片供應更為流暢,推動AI技術的多元化發展。
據了解,采用玻璃作為封裝基板被視為芯片發展的“下一個重大趨勢”。隨著AI數據處理量的急劇增加,傳統塑料基板已無法滿足需求,玻璃基板時代即將到來,初期將主要應用于AI加速器和服務器CPU等高端產品,并逐步擴展到其他領域。
據悉,英偉達計劃最早于2026年引入面板級扇出型封裝,隨后英特爾、AMD等半導體巨頭也將跟進。鑒于AI市場的快速增長,各大廠商均將目光投向這一領域,如微軟、亞馬遜等相繼推出自主研發的AI芯片。面對AI需求的強勁增長以及先進封裝產能的不足,面板級扇出型封裝有望成為解決AI芯片供應問題的有效手段。
業界解釋稱,扇出型封裝分為晶圓級扇出型(FOWLP)和面板級扇出型(FOPLP)兩種類型。相比之下,面板級扇出型封裝無需使用傳統載板材料,從而降低封裝成本,減小厚度,提高芯片吸引力。力成早在2018年便提出,面板級扇出型封裝將改變未來封裝產業格局。
目前,力成在中國臺灣封測廠商中率先布局面板級扇出型封裝,為了搶占高端邏輯芯片封裝市場,已通過其位于竹科的三家工廠全面聚焦于面板級扇出型封裝和TSV CIS(CMOS影像感測器)等技術,強調通過扇出型封裝實現異質集成IC。
力成對面板級扇出型封裝時代所帶來的商業機會持樂觀態度。據分析,與晶圓級扇出型封裝相比,面板級扇出型封裝能夠產出更大的芯片面積,約為兩至三倍。
業界消息顯示,力成在面板級扇出型封裝領域深耕多年,已陸續獲得國際IC設計客戶的合作意向,憑借堅實的技術實力和成熟的制造工藝,力成已處于有利的競爭地位,準備迎接面板級扇出型封裝大放異彩的那一刻。
-
半導體
+關注
關注
335文章
28012瀏覽量
225455 -
英偉達
+關注
關注
22文章
3872瀏覽量
92448 -
ai技術
+關注
關注
1文章
1305瀏覽量
24680
發布評論請先 登錄
相關推薦
英偉達計劃2025年推出基于Arm架構的消費級CPU,挑戰英特爾和AMD
英偉達Blackwell AI服務器遭遇供應鏈挑戰
歐盟警告英偉達AI芯片供應壟斷趨勢
英偉達首席執行官黃仁勛:AI模型推動英偉達AI芯片需求
消息稱英偉達計劃將GB200提早導入面板級扇出型封裝
英偉達率先將GB200導入面板級扇出式封裝,引領市場新機遇
進一步解讀英偉達 Blackwell 架構、NVlink及GB200 超級芯片
新思科技攜手英偉達:基于加速計算、生成式AI和Omniverse釋放下一代EDA潛能
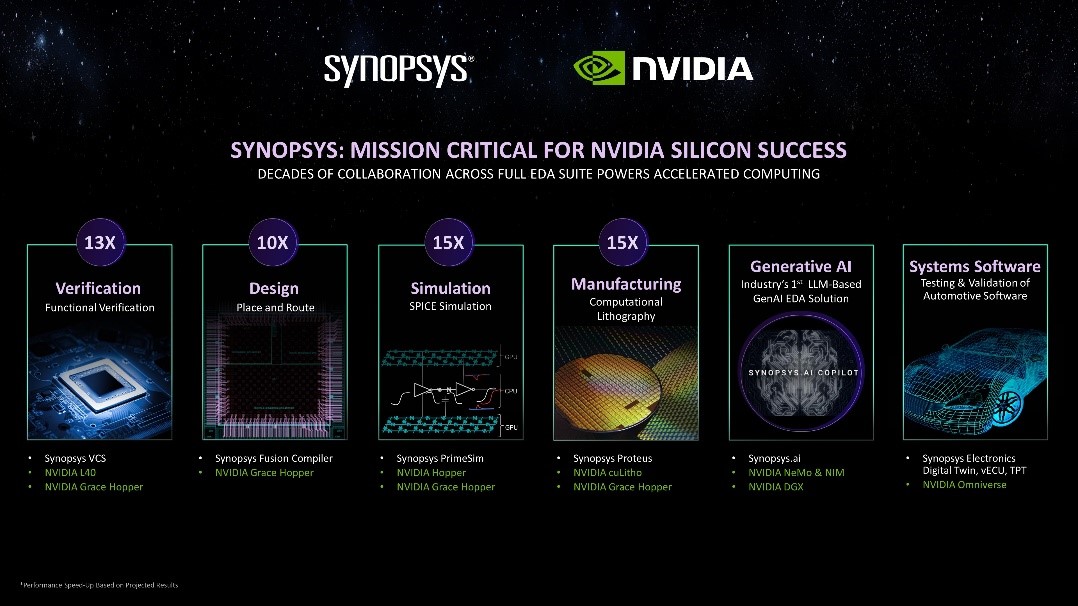




 英偉達AI芯片2026年將應用面板級扇出型封裝,推動市場供應
英偉達AI芯片2026年將應用面板級扇出型封裝,推動市場供應
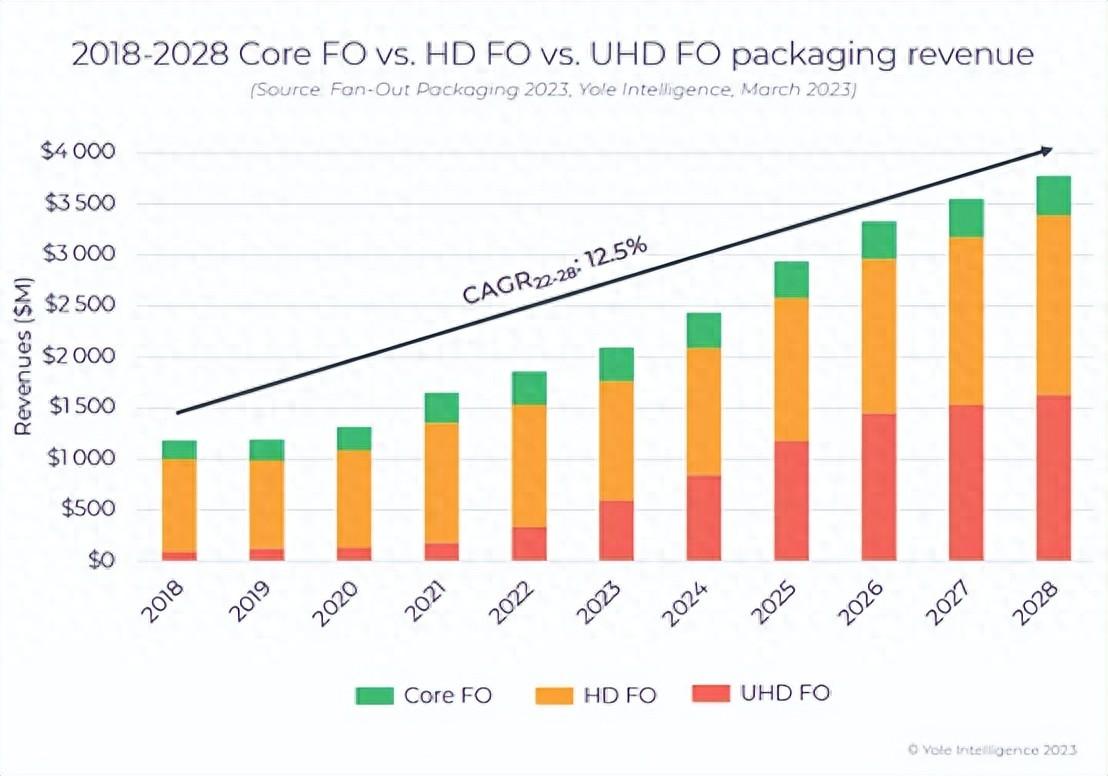
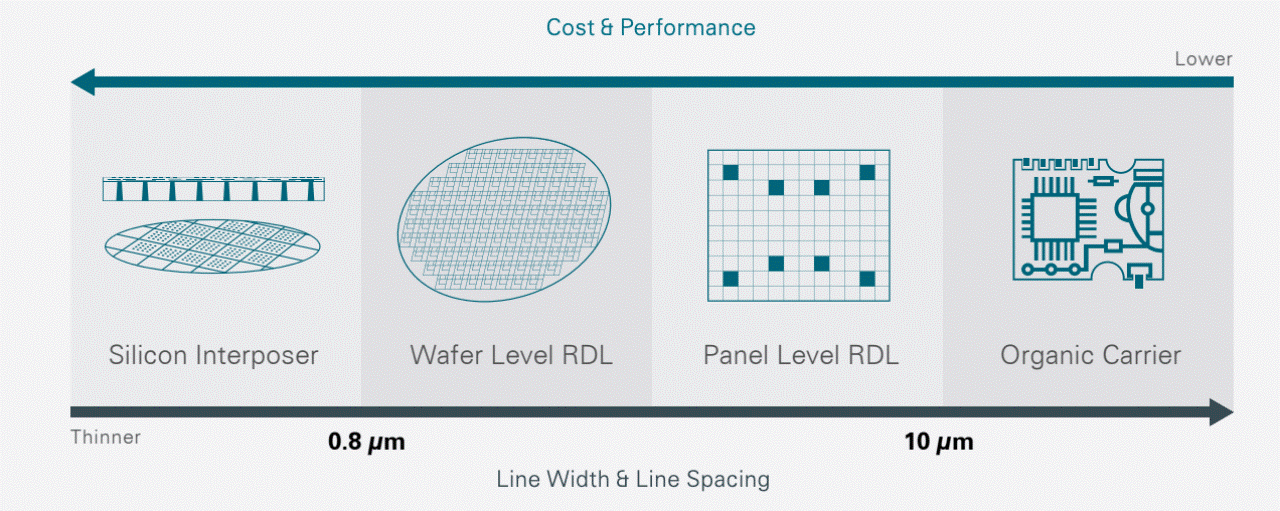











評論