與亞微米工藝類似,柵氧化層工藝是通過熱氧化形成高質(zhì)量的柵氧化層,它的熱穩(wěn)定性和界面態(tài)都非常好。
1)清洗。將晶圓放入清洗槽中清洗,得到清潔的表面。因?yàn)楹竺嬉坏拦ば蚴巧L(zhǎng)柵氧化層,對(duì)氧化膜的質(zhì)量要求非常高,不能有缺陷,所以生長(zhǎng)氧化硅前再過一道酸槽清除自然氧化層,同時(shí)熱氧化生長(zhǎng)的柵氧化層厚度會(huì)更精確。
2)生長(zhǎng)厚柵氧化層。利用爐管熱氧化生長(zhǎng)一層厚的二氧化硅柵氧化層,溫度為850°C左右。先用濕氧氧化法,通入H2和O2的混合氣體,然后用干氧氧化法,通入高純度的氧氣使硅氧化。干氧生長(zhǎng)的氧化物結(jié)構(gòu)、質(zhì)地和均勻性均比濕氧生長(zhǎng)的氧化物好,但用濕氧形成的氧化物的TDDB比較長(zhǎng)。圖4-170所示為生長(zhǎng)厚柵氧化層后的剖面圖。
3)厚柵氧光刻處理。通過微影技術(shù)將厚柵氧掩膜版上的圖形轉(zhuǎn)移到晶圓上,形成中壓器件柵氧化層的圖案,保留中壓器件區(qū)域的光刻膠。AA作為厚柵氧光刻曝光對(duì)準(zhǔn)。圖4-39所示為電路的版圖,工藝的剖面圖是沿 AA'方向,圖4-171 所示為厚柵氧光刻的剖面圖,圖4-172 所示為厚柵氧顯影的剖面圖。
4)測(cè)量厚柵氧光刻套刻,收集曝光之后的厚柵氧光刻與 AA的套刻數(shù)據(jù)。
5)檢查顯影后曝光的圖形。
6)濕法刻蝕去除低壓器件區(qū)域氧化層。通過濕法刻蝕去掉低壓器件區(qū)域的氧化層,留下中壓器件區(qū)域的柵氧。圖4-173所示為去除低壓器件區(qū)域氧化層的剖面圖。
7)去光刻膠。通過干法刻蝕和濕法刻蝕去除光刻膠。圖4-174所示為去除光刻膠后的剖面圖。
8)清洗。將晶圓放入清洗槽中清洗,得到清潔的表面,防止表面的雜質(zhì)在生長(zhǎng)薄柵氧化層時(shí)影響氧化層的質(zhì)量。
9)生長(zhǎng)薄柵氧化層。利用爐管熱氧化生長(zhǎng)一層薄的二氧化硅柵氧,溫度為800°C左右,先用濕氧氧化法,通入H2和O2的混合氣體,然后用干氧氧化法,通入高純度的氧氣使硅氧化。該步驟為低壓器件的柵氧,中壓器件的柵氧就是兩次所生長(zhǎng)的柵氧,但不是相加,因?yàn)橛醒趸瘜痈采w的區(qū)域和沒有氧化層覆蓋的區(qū)域柵氧的生長(zhǎng)速率是不一樣的。圖4-175所示為生長(zhǎng)薄柵氧和厚柵氧的剖面圖。
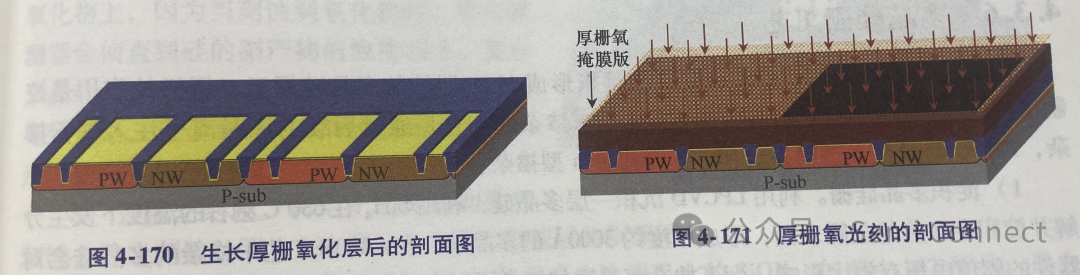
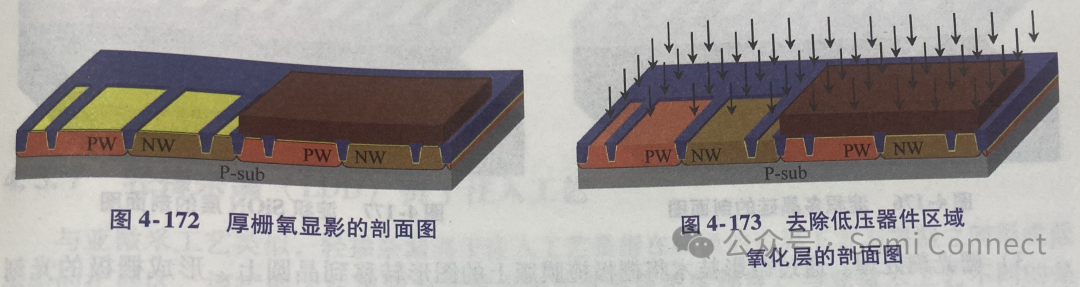
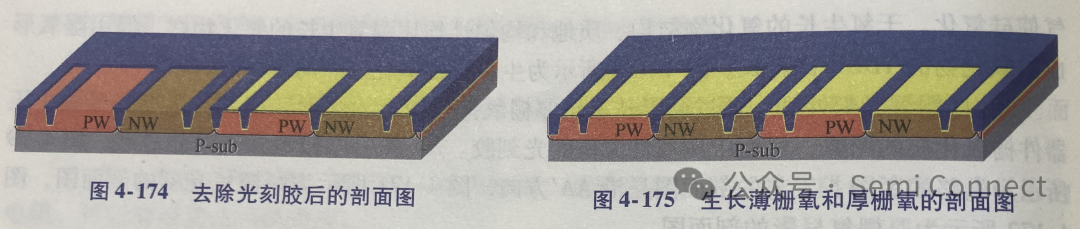
-
晶圓
+關(guān)注
關(guān)注
53文章
5149瀏覽量
129667 -
工藝
+關(guān)注
關(guān)注
4文章
680瀏覽量
29409 -
光刻
+關(guān)注
關(guān)注
8文章
346瀏覽量
30663
原文標(biāo)題:柵氧化層工藝-----《集成電路制造工藝與工程應(yīng)用》 溫德通 編著
文章出處:【微信號(hào):Semi Connect,微信公眾號(hào):Semi Connect】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
平面互補(bǔ)場(chǎng)效應(yīng)晶體管替代金屬柵工藝流程

高k金屬柵(HKMG)工藝詳解

【「大話芯片制造」閱讀體驗(yàn)】+ 芯片制造過程和生產(chǎn)工藝
什么是MOSFET柵極氧化層?如何測(cè)試SiC碳化硅MOSFET的柵氧可靠性?
晶圓制造工藝流程完整版
芯片的制造流程
氧化鋁生產(chǎn)工藝流程圖

柵氧化層和多晶硅柵工藝示意圖解析
微弧氧化工藝是什么?微弧氧化技術(shù)工藝流程及參數(shù)要求

柵介質(zhì)層的發(fā)展和挑戰(zhàn)

MOSFET晶體管的工藝制造流程






















評(píng)論