人工智能對高性能、可持續(xù)計算和網絡硅片的需求無疑增加了研發(fā)投入,加快了半導體技術的創(chuàng)新步伐。隨著摩爾定律在芯片層面的放緩,人們希望在ASIC 封裝內封裝盡可能多的芯片,并在封裝層面獲得摩爾定律的好處。
承載多個芯片的 ASIC 封裝通常由有機基板組成。有機基板由樹脂(主要是玻璃增強環(huán)氧層壓板)或塑料制成。根據封裝技術,芯片要么直接安裝在基板上,要么在它們之間有另一層硅中介層,以實現(xiàn)芯片之間的高速連接。有時在基板內嵌入互連橋而不是中介層來提供這種高速連接。
有機基板的問題在于它們容易出現(xiàn)翹曲問題,尤其是在芯片密度較高的較大封裝尺寸中。這限制了封裝內可封裝的芯片數量。
在此領域,玻璃通孔 (TGV) 是玻璃芯基板的支柱之一。TGV 為更緊湊、更強大的設備鋪平了道路,有助于提高層間連接密度。這些通孔有助于提高高速電路的信號完整性。連接之間的距離減小可減少信號損失和干擾,從而提高整體性能。TGV 的集成可以通過消除對單獨互連層的需求來簡化制造流程。然而,盡管 TGV 具有諸多優(yōu)勢,但它也面臨許多挑戰(zhàn)。由于制造過程的復雜性,TGV 更容易出現(xiàn)可能導致產品故障的缺陷。
同時,根據勢銀芯鏈了解,玻璃基板以及TGV技術通常意味著比其他解決方案更高的生產成本。對專用設備的需求加上缺陷風險可能會導致生產費用增加。TGV技術可以簡單的分為成孔技術、填孔技術以及高密度布線技術。

玻璃通孔(TGV)和硅通孔(TSV)工藝技術相比,玻璃通孔(TGV)的優(yōu)勢主要體現(xiàn)在以下幾個方面:
1、優(yōu)良的高頻電學特性。玻璃材料是一種絕緣體材料,介電常數只有硅材料的1/3左右,損耗因子比硅材料低2-3個數量級,使得襯底損耗和寄生效應大大減小,保證了傳輸信號的完整性;
2、大尺寸超薄玻璃襯底易于獲取。Corning、Asahi以及SCHOTT等玻璃廠商可以提供超大尺寸(>2m × 2m)和超薄(<50μm)的面板玻璃以及超薄柔性玻璃材料。
3、低成本。受益于大尺寸超薄面板玻璃易于獲取,以及不需要沉積絕緣層,玻璃轉接板的制作成本大約只有硅基轉接板的1/8;
4、工藝流程簡單。不需要在襯底表面及玻璃通孔(TGV)內壁沉積絕緣層,且超薄轉接板中不需要減薄;
5、機械穩(wěn)定性強。即便當轉接板厚度小于100μm時,翹曲依然較小;
6、應用領域廣泛。是一種應用于晶圓級封裝領域的新興縱向互連技術,為實現(xiàn)芯片-芯片之間距離最短、間距最小的互聯(lián)提供了一種新型技術途徑,具有優(yōu)良的電學、熱學、力學性能,在射頻芯片、高端MEMS傳感器、高密度系統(tǒng)集成等領域具有獨特優(yōu)勢,是下一代5G、6G高頻芯片3D封裝的首選之一。

-
工藝
+關注
關注
4文章
622瀏覽量
29014 -
玻璃基板
+關注
關注
1文章
94瀏覽量
10512
原文標題:目前大熱的TGV技術,可以應用在哪些領域?
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關注!文章轉載請注明出處。
發(fā)布評論請先 登錄
相關推薦
芯和半導體將參加2025年玻璃基板TGV產業(yè)鏈高峰論壇
2025年TGV玻璃基板市場規(guī)模預計將達到1.7411億美元

玻璃通孔(TGV)技術原理、應用優(yōu)勢及對芯片封裝未來走向的影響

TGV玻璃基板主流工藝詳解
HDI盲埋孔工藝及制程能力你了解多少?
DNP:推進玻璃芯板樣品驗證,到2030年投20億美元用于大規(guī)模量產

高性能半導體封裝TGV技術的最新進展
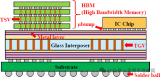




 玻璃通孔(TGV)工藝技術的應用
玻璃通孔(TGV)工藝技術的應用
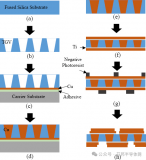
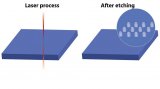


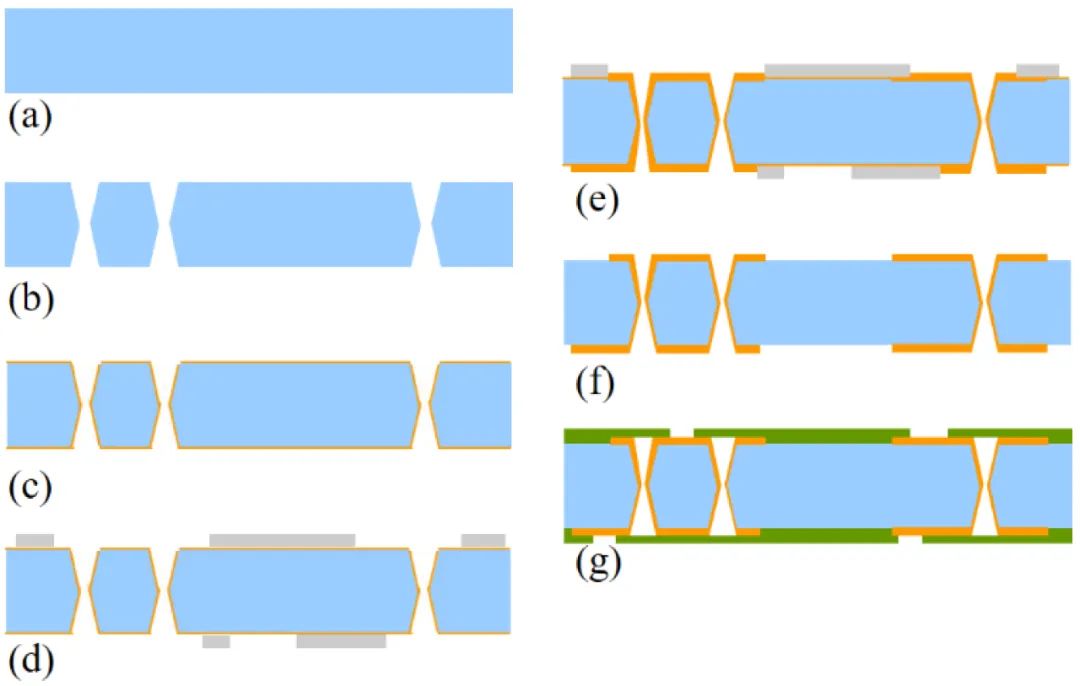











評論