AMD最近獲得了一項(xiàng)關(guān)于玻璃核心基板技術(shù)的專利,預(yù)示著在未來幾年內(nèi),玻璃基板有望取代傳統(tǒng)的多芯片處理器有機(jī)基板。這項(xiàng)專利不僅體現(xiàn)了AMD在相關(guān)技術(shù)領(lǐng)域的深厚研究,還使公司在未來能夠使用玻璃基板,避免了潛在的專利糾紛和競爭對手的訴訟。目前,包括英特爾和三星在內(nèi)的許多芯片制造商都在積極探索未來處理器中使用玻璃基板的可能性。盡管AMD已將自身的芯片生產(chǎn)外包給臺積電,但該公司依然在硅片和芯片的研發(fā)制作方面保持著活躍,能夠根據(jù)合作伙伴提供的工藝技術(shù)進(jìn)行定制化產(chǎn)品的開發(fā)。玻璃基板通常由硼硅酸鹽、石英和熔融石英等材料制成,相比傳統(tǒng)的有機(jī)基板,具有眾多優(yōu)勢。這些優(yōu)勢包括:平整度和尺寸穩(wěn)定性:改善系統(tǒng)級封裝中超密集互連的光刻聚焦。熱穩(wěn)定性和機(jī)械穩(wěn)定性:在高溫、重負(fù)荷的應(yīng)用場景中展現(xiàn)更高的可靠性,如數(shù)據(jù)中心處理器。根據(jù)AMD的專利,使用玻璃基板的一個(gè)主要挑戰(zhàn)在于實(shí)現(xiàn)玻璃通孔(TGV),這些通道用于傳輸信號和電力。制造TGV的技術(shù)包括激光鉆孔和濕法蝕刻,盡管激光鉆孔和磁性自組裝等方法仍在研發(fā)中。另外,再分布層是先進(jìn)芯片封裝中不可或缺的部分,它通過高密度互連在芯片與外部組件之間傳遞信號和電源。盡管主玻璃基板將使用玻璃材料,該封裝層仍將依賴于有機(jī)介電材料和銅,這要求新的生產(chǎn)工藝來適配玻璃基板的特點(diǎn)。該專利還介紹了一種新方法,即采用銅基鍵合替代傳統(tǒng)的焊料凸塊,從而實(shí)現(xiàn)多個(gè)玻璃基板之間牢固、無縫的連接。此技術(shù)不需要底部填充材料,使得多個(gè)基板的堆疊更為高效。AMD的專利指出,玻璃基板在熱管理、機(jī)械強(qiáng)度和信號路由能力方面的優(yōu)越性,使其在數(shù)據(jù)中心處理器領(lǐng)域展現(xiàn)了獨(dú)特優(yōu)勢。然而,該專利還暗示,這種基板可能被廣泛應(yīng)用于需要高密度互連的其他領(lǐng)域,包括移動設(shè)備、計(jì)算系統(tǒng)以及先進(jìn)傳感器等。AMD計(jì)劃在2025年至2026年間推出其玻璃基板,并積極與全球的元器件公司展開合作,以保持技術(shù)領(lǐng)先。據(jù)韓媒消息,AMD正對全球幾家半導(dǎo)體基板公司的玻璃基板樣品進(jìn)行性能評估測試,力圖將這一創(chuàng)新基板技術(shù)引入半導(dǎo)體制造行業(yè)。
審核編輯 黃宇
-
amd
+關(guān)注
關(guān)注
25文章
5572瀏覽量
136025 -
基板
+關(guān)注
關(guān)注
2文章
298瀏覽量
23443
發(fā)布評論請先 登錄
迎接玻璃基板時(shí)代:TGV技術(shù)引領(lǐng)下一代先進(jìn)封裝發(fā)展

一文解讀玻璃基板與陶瓷基板、PCB基板的優(yōu)缺點(diǎn)及適用領(lǐng)域
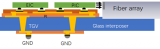
玻璃基板、柔性基板和陶瓷基板的優(yōu)劣勢

玻璃基板面臨的四大核心技術(shù)攻關(guān)難點(diǎn)

玻璃基板:半導(dǎo)體封裝領(lǐng)域的“黑馬”選手

玻璃基板的四大關(guān)鍵技術(shù)挑戰(zhàn)

玻璃基板的技術(shù)優(yōu)勢有哪些
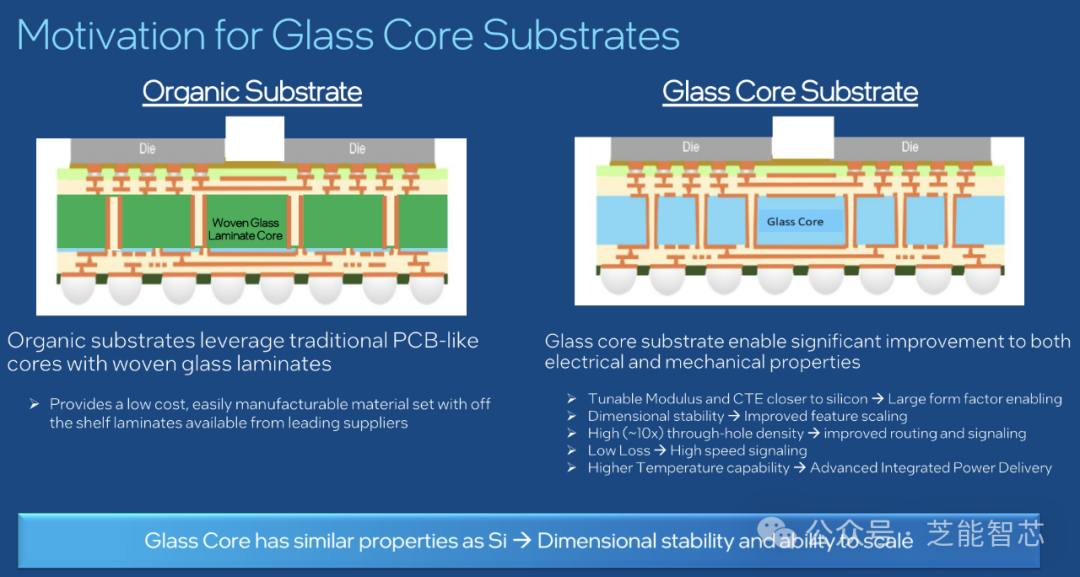
熱門的玻璃基板,相比有機(jī)基板,怎么切?






















評論