由深圳瑞沃微半導(dǎo)體科技有限公司發(fā)布
隨著3D先進(jìn)封裝、玻璃基板、小芯片Chiplet、3D堆疊SoIC等新一代先進(jìn)封裝技術(shù)的不斷涌現(xiàn),半導(dǎo)體行業(yè)正經(jīng)歷一場前所未有的技術(shù)革新。全球領(lǐng)先企業(yè)如三星電子、英特爾、臺積電、日月光等,正紛紛加大投資與擴(kuò)產(chǎn)力度,以期在下一代先進(jìn)封裝技術(shù)的競爭中占據(jù)先機,引領(lǐng)整個行業(yè)的發(fā)展方向。
AI人工智能的迅猛發(fā)展,為玻璃基板技術(shù)的崛起提供了絕佳的時代契機。英特爾預(yù)測,玻璃基板將首先被引入那些能夠最大程度發(fā)揮其優(yōu)勢的市場,如數(shù)據(jù)中心、人工智能、圖形處理等,這些領(lǐng)域需要更大外形封裝和更高速度能力的應(yīng)用程序和工作負(fù)載。這一趨勢預(yù)示著,玻璃基板將成為未來先進(jìn)封裝技術(shù)的重要組成部分。
在先進(jìn)封裝技術(shù)蓬勃發(fā)展的背景下,瑞沃微先進(jìn)封裝:1、首創(chuàng)面板級化學(xué)I/O鍵合技術(shù)。2、無載板鍵合RDL一次生成技術(shù)。3、新型TSV/TGV技術(shù)。4、新型Bumping技術(shù)。5、小于10微米精細(xì)線寬RDL技術(shù)。6、新型巨量轉(zhuǎn)移貼片技術(shù)等六大技術(shù)緊隨其后!
首創(chuàng)芯片I/O化學(xué)鍵合技術(shù)并應(yīng)用于半導(dǎo)體封裝行業(yè),其中,無載板或引線框架逆向增材制作技術(shù),在化學(xué)I/O鍵合&RDL一次性完成,解決Min&Micro-LEDi背光顯示成本、可靠性、散熱行業(yè)痛點,最小10微米線寬、線距的量產(chǎn)能力,解決行業(yè)更高分辨率痛點。
瑞沃微改變封裝行業(yè)高投入低產(chǎn)出、低利潤率的痛點,在散熱性能、10微 米以下引腳間距、低成本高性能的金屬凸塊、金屬通孔等技術(shù)方面 促進(jìn)了先進(jìn)封裝技術(shù)更高性能的實現(xiàn),提高了產(chǎn)品的可靠性,大幅 降低了生產(chǎn)制造成本,實現(xiàn)了半導(dǎo)體封裝行業(yè)的革命性創(chuàng)新。
業(yè)內(nèi)先進(jìn)封裝技術(shù)領(lǐng)航者日月光正在積極謀劃未來布局,在近期召開的股東大會上,日月光首席運營官吳田玉透露,到2025年,AI先進(jìn)封裝的需求將持續(xù)保持強勁態(tài)勢。今年,日月光AI相關(guān)的CoWoS先進(jìn)封裝營收預(yù)計將超出原先預(yù)期,增加2.5億美元以上,這將有力加速其營收的復(fù)蘇步伐。
為了應(yīng)對人工智能發(fā)展所帶來的多樣化整合設(shè)計和先進(jìn)封裝需求,瑞沃微將公司首創(chuàng)的化學(xué)I/O鍵合技術(shù)及其他新型封裝技術(shù)快速融大規(guī)模市場應(yīng)用與驗證中,并計劃根據(jù)市場需求在全球范圍內(nèi)擴(kuò)增先進(jìn)封裝產(chǎn)能。
在新型封裝產(chǎn)品實現(xiàn)的條件支撐下,瑞沃微的技術(shù)產(chǎn)品可靠性得到了更高提升,在業(yè)內(nèi)成本很高的情況下,瑞沃微進(jìn)行了大力降低措施,如今降本至50%以上的同時,又不耽誤解散熱性能,決了行業(yè)難題散熱低,將散熱性能提升30%以上。可封裝3*5mil以下尺寸芯片,適合嵌入式、異構(gòu)集成等功能性模組。
國內(nèi)各大半導(dǎo)體廠商也在積極跟進(jìn),加速布局先進(jìn)封裝技術(shù),瑞沃微相信這些新技術(shù)的推出,將進(jìn)一步推動先進(jìn)封裝技術(shù)的發(fā)展和完善!
總之,新一代先進(jìn)封裝技術(shù)的浪潮正在涌動,行業(yè)巨頭們正在積極布局先進(jìn)封裝技術(shù)的未來,瑞沃微緊隨其后。在這場技術(shù)革命中,誰將站在下一代先進(jìn)封裝發(fā)展浪頭引領(lǐng)行業(yè)發(fā)展?讓我們拭目以待!
-
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28666瀏覽量
233262 -
AI
+關(guān)注
關(guān)注
88文章
34405瀏覽量
275670 -
先進(jìn)封裝
+關(guān)注
關(guān)注
2文章
464瀏覽量
526
發(fā)布評論請先 登錄
萬“粽”一心,封裝共進(jìn),瑞沃微半導(dǎo)體祝大家端午安康!

紅冉引領(lǐng)視覺顯示的六大核心優(yōu)勢
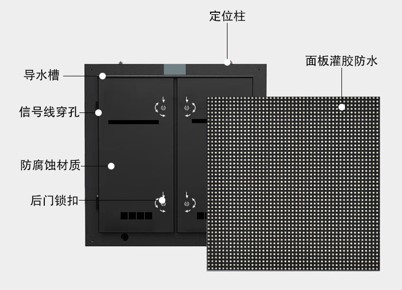
瑞沃微先進(jìn)封裝:突破摩爾定律枷鎖,助力半導(dǎo)體新飛躍

解鎖照明新境界,瑞沃微 CSP1111 以卓越性能引領(lǐng)未來
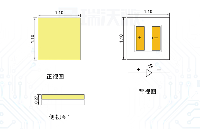
先進(jìn)封裝技術(shù)-19 HBM與3D封裝仿真

2025年電子元器件市場展望:瑞沃微深度剖析機遇與挑戰(zhàn)的前瞻預(yù)測

先進(jìn)封裝技術(shù)-17硅橋技術(shù)(下)

先進(jìn)封裝成為AI時代的核心技術(shù)發(fā)展與創(chuàng)新

Deloitte的六大技術(shù)趨勢

先進(jìn)封裝的核心概念、技術(shù)和發(fā)展趨勢

瑞沃微:一文詳解CSP(Chip Scale Package)芯片級封裝工藝

存算一體技術(shù)的分類

晶圓微凸點技術(shù)在先進(jìn)封裝中的應(yīng)用

瑞沃微發(fā)布CSP新品:SMD0201系列,高集成度先進(jìn)制造工藝



















評論