整合更多功能和提高性能是推動(dòng)先進(jìn)封裝技術(shù)的驅(qū)動(dòng),如2.5D和3D封裝。
2.5D/3D封裝允許IC垂直集成。傳統(tǒng)的flip-chip要求每個(gè)IC單獨(dú)封裝,并通過傳統(tǒng)PCB技術(shù)與其他IC集成。
2.5D封裝將die拉近,并通過硅中介連接。3D封裝實(shí)際上采用2.5D封裝,進(jìn)一步垂直堆疊die,使die之間的連接更短。通過這種方式直接集成IC,IC間通信接口通常可以減少或完全消除。這既可以提高性能,又可以減輕重量和功耗。
這種封裝的復(fù)雜性需要新穎的封裝和測試技術(shù)。
了解2.5D封裝與3D封裝
隨著半導(dǎo)體foundry開始達(dá)到工藝節(jié)點(diǎn)的潛在物理極限,芯片封裝正在成為提高性能的一種方式。flip chip封裝仍然是互連die最流行的方法,但硅中介的新進(jìn)展使2.5D封裝成為可能,進(jìn)而又使3D封裝成為可能。
什么是3D封裝?
當(dāng)然。3D封裝涉及垂直堆疊多個(gè)半導(dǎo)體die(或chiplet),創(chuàng)建三維封裝架構(gòu)。這種方法使不同組件在單個(gè)封裝中更緊密地集成。
同樣值得注意的是,3D異構(gòu)集成(3DHI)是3D封裝的一個(gè)子類別。“異質(zhì)”方面意味著這些die可能具有多種功能,并可能來自各種制造工藝或foundry。
2.5D和3D封裝有什么不同?
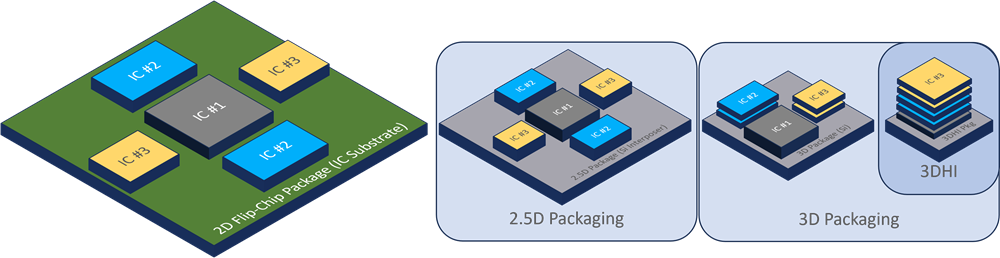
關(guān)鍵的區(qū)別在于die的垂直堆疊和粘接。傳統(tǒng)的封裝方法涉及將芯片并排放在平面上,限制了可以實(shí)現(xiàn)的集成量。在3D封裝中,組件相互堆疊,減少了它們之間的距離,并提供了更高的集成密度。
2.5D和3D封裝有什么好處?
3D封裝方法有很多好處。
縮小尺寸:3D封裝最明顯的好處之一是其卓越的尺寸效率。通過將半導(dǎo)體組件垂直堆疊在單個(gè)封裝中,它大大減少了封裝的物理尺寸。這種尺寸的縮小在空間有限的應(yīng)用中特別有價(jià)值,如移動(dòng)設(shè)備、航空航天系統(tǒng)和可穿戴技術(shù)。隨著電子設(shè)備尺寸的持續(xù)縮小,3D封裝可以在不影響性能的情況下創(chuàng)建更小、更緊湊的產(chǎn)品。

減輕重量:3D封裝有助于減輕電子系統(tǒng)的重量。通過垂直堆疊實(shí)現(xiàn)的緊湊和密集的集成設(shè)計(jì)導(dǎo)致設(shè)備的整體重量減輕。這在航空航天等行業(yè)至關(guān)重要,每一克都很重要。更輕的電子產(chǎn)品可以轉(zhuǎn)化為更省油的飛機(jī)和擴(kuò)展無人駕駛飛行器的任務(wù)能力。
能源效率:在能源效率方面,3D封裝中組件的垂直堆疊通常會(huì)導(dǎo)致互連長度更短。減少數(shù)據(jù)傳輸距離可以降低信號損耗和功耗。
3D封裝的這些優(yōu)勢在當(dāng)今快節(jié)奏的技術(shù)環(huán)境中越來越有優(yōu)勢。隨著電子設(shè)備變得更加便攜、輕便和節(jié)能,3D封裝成為這些進(jìn)步的關(guān)鍵推動(dòng)者。無論是在消費(fèi)電子產(chǎn)品、航空航天還是醫(yī)療設(shè)備應(yīng)用中,使電子產(chǎn)品更小、更輕、更節(jié)能的能力在未來都發(fā)揮著至關(guān)重要的作用。
-
3D
+關(guān)注
關(guān)注
9文章
2951瀏覽量
109439 -
封裝
+關(guān)注
關(guān)注
128文章
8484瀏覽量
144776 -
2.5D
+關(guān)注
關(guān)注
0文章
13瀏覽量
13896
原文標(biāo)題:什么是2.5D和3D封裝技術(shù)
文章出處:【微信號:深圳市賽姆烯金科技有限公司,微信公眾號:深圳市賽姆烯金科技有限公司】歡迎添加關(guān)注!文章轉(zhuǎn)載請注明出處。
發(fā)布評論請先 登錄
新型2.5D和3D封裝技術(shù)的挑戰(zhàn)
異構(gòu)集成基礎(chǔ):基于工業(yè)的2.5D/3D尋徑和協(xié)同設(shè)計(jì)方法
2.5D/3D芯片-封裝-系統(tǒng)協(xié)同仿真技術(shù)研究
分享一下小芯片集成的2.5D/3D IC封裝技術(shù)
3D封裝與2.5D封裝比較
3D封裝結(jié)構(gòu)與2.5D封裝有何不同?3D IC封裝主流產(chǎn)品介紹

智原推出2.5D/3D先進(jìn)封裝服務(wù), 無縫整合小芯片
2.5D和3D封裝的差異和應(yīng)用

探秘2.5D與3D封裝技術(shù):未來電子系統(tǒng)的新篇章!

2.5D與3D封裝技術(shù):未來電子系統(tǒng)的新篇章
2.5D/3D封裝技術(shù)升級,拉高AI芯片性能天花板
探秘2.5D與3D封裝技術(shù):未來電子系統(tǒng)的新篇章
一文理解2.5D和3D封裝技術(shù)

技術(shù)資訊 | 2.5D 與 3D 封裝




















評論