以下文章來源于學習那些事,作者小陳婆婆
失效機理
本文介紹內容為:半導體集成電路失效機理中與封裝有關的失效機理,分述如下
封裝材料α射線引起的軟誤差
水汽引起的分層效應
金屬化腐蝕:鋁互連線的腐蝕問題
1封裝材料α射線引起的軟誤差
產生機理
鈾或釷等放射性元素是集成電路封裝材料中天然存在的雜質。這些材料發射的α粒子進入硅中時,會在粒子經過的路徑上產生電子-空穴對。這些電子-空穴對在電場的作用下被電路結點收集,從而引起電路誤動作。具體表現為動態存儲器存儲電荷丟失、靜態隨機存儲器(RAM)存儲單元翻轉、動態邏輯電路信息丟失或其他邏輯單元電路漏極耗盡區中存儲的信息丟失。
吸收一個4MeV的α粒子能產生10^6^個電子-空穴對,電荷數量等于或大于動態存儲單元中存儲的電荷。在一個包含1000個16KB存儲器件的存儲系統中,典型的軟錯誤率可能是每1000小時發生一次軟誤差的數量級,相當于器件失效率為1000FIT(失效時間間隔)。
改進措施
針對封裝材料α射線引起的軟誤差問題,可以采取以下改進措施:
·提高封裝材料的純度:通過減少封裝材料中鈾、釷等放射性元素的含量,可以降低α粒子的來源,從而減少軟誤差的發生。
·片表面涂阻擋層:在芯片表面涂覆一層阻擋層,如聚酸胺系列有機高分子化合物等,可以有效阻止α粒子射入芯片中,從而降低軟誤差率。
·優化器件設計:從器件設計入手,增加存儲單元單位面積的電荷存儲容量。例如,采用介電系數大的材料或溝槽結構電容來增大存儲電容面積,或者在襯底中加隱埋層,提高雜質濃度并使雜質分布優化,以降低電荷收集效率而不提高結電容,從而保持電路性能。
·優化電路設計:采用糾錯碼(ECC)技術來優化電路設計。ECC技術可以檢測和糾正數據傳輸或存儲過程中出現的錯誤,從而降低軟誤差對系統性能的影響。
·改進時序控制電路:在DRAM等存儲器中,采用復雜的時序控制電路來縮短位線電壓的浮動時間。這有助于減少因α粒子引起的電路誤動作,從而降低軟誤差率。
綜上所述,通過提高封裝材料的純度、涂覆阻擋層、優化器件和電路設計以及改進時序控制電路等措施,可以有效降低封裝材料α射線引起的軟誤差率,提高集成電路的穩定性和可靠性。
2水汽引起的分層效應
塑封IC與水汽分層效應概述
塑封IC,即以塑料等樹脂類聚合物材料封裝的集成電路,在封裝過程中及后續使用中,可能因水汽吸附引發分層效應,導致器件失效。這種分層效應,俗稱“爆米花”效應,對集成電路的穩定性和可靠性構成嚴重威脅。
失效機理
塑封料中的水分在高溫環境下會迅速膨脹,這種膨脹力導致塑封料與其附著的金屬框架和芯片之間發生分離。當膨脹力達到一定程度時,塑封體甚至可能爆裂,嚴重損傷芯片、使鈍化層破裂、拉斷鍵合引線,從而導致器件失效。
危害
水汽引起的分層效應對集成電路的危害主要體現在以下幾個方面:
·損傷芯片:分層效應可能導致芯片表面或內部受到機械損傷,影響芯片的正常功能。
·鈍化層破裂:鈍化層是保護芯片免受外界環境影響的關鍵層,其破裂將降低芯片的防護能力。
·拉斷鍵合引線:鍵合引線是連接芯片與外部電路的關鍵部分,其斷裂將導致信號傳輸中斷。
水汽進入途徑
水汽主要通過以下途徑進入塑封IC:
·塑料體滲透:水汽通過塑料材料本身的微小孔隙滲透進入封裝體內部。
·交界面進入:水汽從塑料與金屬框架(外引線)的交界面處滲透進入封裝體。
改進措施
針對水汽引起的分層效應,可以采取以下改進措施:
減少封裝體內部氣泡:在IC后道封裝的塑封過程中,優化環氧模塑料的充填成型工藝,確保空氣及揮發性物質在壓實階段完全排出,避免內部氣泡的產生。采用樹脂預熱時溫差工藝,通過合理的溫度梯度控制,使樹脂在熔化過程中更有效地排出空氣。
減小金屬框架對封裝的影響:選擇銅質引線框架,以提高塑封IC的熱匹配性,減少因熱應力引起的分層效應。增加去除塑封沖制成形時毛刺的工序,減小應力集中,提高封裝的可靠性。
電裝要求:拆包后的器件應盡快進行裝配,避免長時間暴露在空氣中吸附水汽。未及時裝配的器件應保存在干燥的環境中,或在高溫烘烤后去除表面吸附的水汽后再進行電裝。
通過采取上述改進措施,可以有效降低水汽引起的分層效應對塑封IC的影響,提高器件的穩定性和可靠性。
3金屬化腐蝕:鋁互連線的腐蝕問題
在集成電路中,金屬鋁因其價格便宜和易于大量生產而被廣泛用作互連線材料。然而,鋁是一種化學活潑金屬,容易受到水汽的腐蝕。特別是在樹脂包封的集成電路中,水汽可以穿透樹脂層到達鋁互連線處,與其發生化學反應或電化學反應,導致鋁互連線的腐蝕。這種腐蝕現象對集成電路的穩定性和可靠性構成了嚴重威脅。
失效機理
金屬鋁的腐蝕主要分為化學腐蝕和電化學腐蝕兩種機制:
·化學腐蝕:當集成電路存放在高溫高濕環境中時,鋁會發生化學腐蝕。在干燥空氣中,鋁表面會形成一層氧化鋁(Al?O?)保護膜,防止化學腐蝕的發生。但在潮濕環境中,這層保護膜會被破壞,形成氫氧化鋁(Al(OH)?),該物質既溶于酸也溶于堿。

當有外部物質(如酸性或堿性物質)到達鋁表面時,會發生化學反應,導致鋁的腐蝕。特別是在引線鍵合處的Pad部分,金屬鋁是暴露于表面的,因此更容易受到化學腐蝕的攻擊。
·電化學腐蝕:當集成電路工作于高溫高濕環境中時,還會發生電化學腐蝕。根據鋁電極的電勢是正還是負,電化學腐蝕分為陽極腐蝕和陰極腐蝕。陽極腐蝕時,鋁電極是正電位,負離子(如Cl?)被吸引過來,與鋁發生化學反應,導致腐蝕。
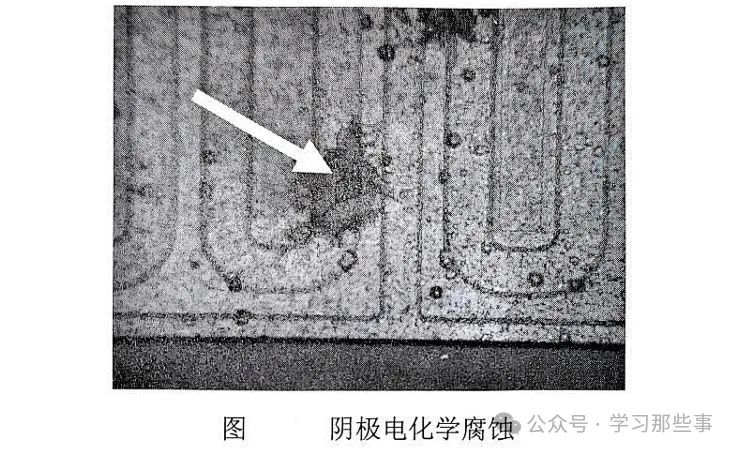
陰極腐蝕時,鋁電極是負電位,正離子(如Na?、K?)被吸引過來,與水電離產生的OH?離子反應,形成氫氧化鋁,從而產生腐蝕。
危害與影響
金屬鋁的腐蝕會導致互連線電阻增加、信號傳輸性能下降,甚至引起電路開路或短路,嚴重影響集成電路的穩定性和可靠性。此外,腐蝕還會破壞芯片表面的鈍化膜,進一步降低芯片的防護能力。
改進措施
為了防止鋁的腐蝕,可以采取以下改進措施:
·控制加工過程和裝配工藝的清潔度:確保在加工和裝配過程中,避免雜質和污染物的引入,降低封裝樹脂中的雜質濃度。
·使用陶瓷密封包裝:陶瓷材料具有良好的密封性和化學穩定性,可以有效防止水汽和雜質的滲透,保護鋁互連線不受腐蝕。
·去除殘余氯的鈍化方法:在片子腐蝕后而暴露于大氣之前,立即用CF?—O或O?等離子體處理去掉殘余的氯,進一步提高鋁互連線的穩定性。
·熱氧化金屬:通過熱氧化處理,可以在鋁表面形成一層致密的氧化鋁保護膜,提高鋁的耐腐蝕性。
·控制介質中的磷含量:在磷硅玻璃中保持6%的最小磷含量,可以減少對鋁合金結構的侵蝕。
綜上所述,通過采取上述改進措施,可以有效降低金屬鋁在集成電路中的腐蝕風險,提高集成電路的穩定性和可靠性。集成電路外引線及鍵合引線相關失效問題及改進措施。
-
集成電路
+關注
關注
5417文章
11942瀏覽量
367036 -
半導體
+關注
關注
335文章
28569瀏覽量
232348 -
封裝
+關注
關注
128文章
8474瀏覽量
144759
原文標題:封裝有關的失效機理
文章出處:【微信號:芯長征科技,微信公眾號:芯長征科技】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄







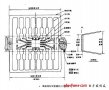












評論