EUV光刻有多強?目前來看,沒有EUV光刻,業界就無法制造7nm制程以下的芯片。EUV光刻機也是歷史上最復雜、最昂貴的機器之一。
EUV光刻有哪些瓶頸?
EUV光刻技術,存在很多難點。
1.1 光源技術方面
EUV光源的波長僅為13.5納米,遠遠小于可見光,因此產生和維持如此短波長光源的難度極大。
目前,最成熟的EUV光源是由高純度錫產生的高溫等離子體產生的。固體錫在液滴發生器內熔化,該儀器在真空室中每分鐘連續產生超過300萬個27μm的液滴。平均功率為25kW的二氧化碳(CO2)激光器用兩個連續脈沖照射錫液滴,分別使液滴成形并電離。但這個過程中,需要巨大的激光能力,還需要復雜冷卻系統和真空環境維持穩定運行。
1.2 光學系統方面
EUV光刻機的難點不止光源,還有光學系統。極紫外光的波長太短,傳統的透鏡根本無法使用,只能靠多片超光滑的反射鏡來引導光線。EUV反射鏡片的制造工藝相當復雜,鏡片表面的光滑度要求變態到極致,0.33NA的鏡面糙度達到驚人的0.05nm。可以這么理解,如果把反射鏡放大到中國國土這樣大的面積,那么整個國土最大的凸起和下凹高度不會超過0.4毫米。再加上能量損耗的問題,如何讓光線最終精準地打到晶圓上,也是一個不小的挑戰。
1.3 掩模技術方面
掩膜版又稱光罩、光掩膜、光刻掩膜版等,是微電子制造過程中的圖形轉移工具或母版,是承載圖形設計和工藝技術等知識產權信息的載體。
EUV掩膜版是整個光學系統的極為重要的一環。
EUV掩模版由襯底上的 40 到 50 層交替的硅和鉬層組成,每層膜厚度約3.4納米,形成 250納米到350納米厚的多層堆疊,嚴格控制每層膜的厚度誤差以避免EUV光的損耗。
在這方面,國際領先的掩模版制造商Toppan一直致力于掩模版業務,其于2005年收購了杜邦光掩模公司,并于同年開始與IBM、格羅方德半導體、三星聯合開發高端掩模版技術,從最初的45nm制程節點發展至目前的2nm制程節點。
1.4 光刻膠方面
光刻膠是一種具有光敏化學作用的高分子聚合物材料,外觀上呈現為膠狀液體。到目前為止,用于 EUV 光刻的大多數光刻膠都是基于 KrF 和 ArF 光刻膠平臺的化學放大光刻膠。
在相同條件下,光刻膠吸收的EUV光子數量僅為DUV 193nm波長的1/14。這就要求要么在EUV波段創造出極強的光源,要么發明更靈敏的光刻膠。
光刻膠的難點一方面是高分辨率與低粗糙度的平衡,因為在 EUV 光刻中,需要光刻膠具備高分辨率以精確地描繪出極小的芯片圖案特征。然而,提高光刻膠分辨率的同時,往往會導致線邊緣粗糙度(LER)增加。例如,當光刻膠對 EUV 光響應過于敏感,在光化學反應過程中,可能會使圖案邊緣的反應不均勻,造成線條邊緣不平整。
另一方面是敏感度要求高且精確。因為 EUV 光源的功率有限,且光刻過程需要在短時間內完成大量圖案的曝光,如果光刻膠敏感度不夠,就需要延長曝光時間或者增加光強,這會影響生產效率和設備壽命。但是,敏感度又不能過高,否則很容易受到環境因素(如微弱的雜散光)的影響而產生不必要的反應。舉個例子,在光刻車間的照明環境中,如果光刻膠過于敏感,可能會因為車間內的一些非 EUV 光源的微弱光線而提前發生反應,影響光刻質量。
EUV光刻的挑戰者們
2.1 納米壓印光刻(NIL)技術
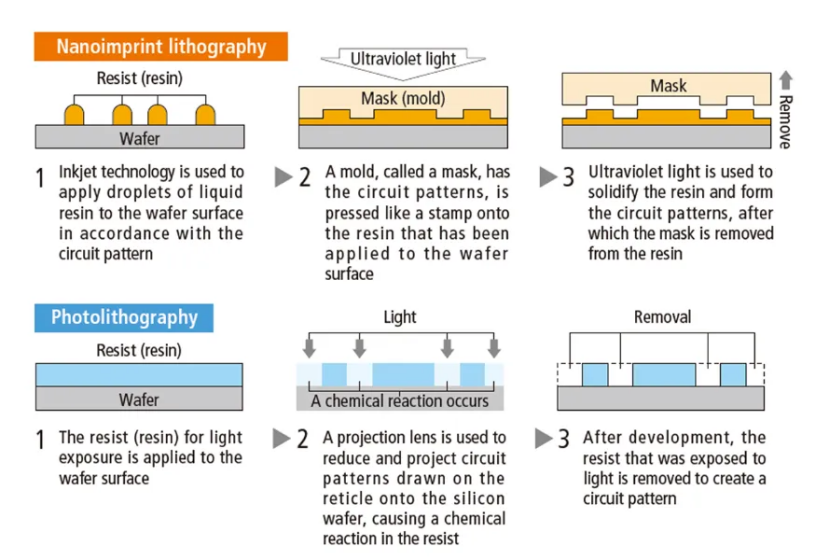
納米壓印與光學光刻流程對比
納米壓印光刻(NIL)技術是挑戰EUV的老對手了。
NIL的原理和傳統的光刻技術是本質性的不同。納米壓印是用機械變形-壓印來形成圖案,將預先圖形化的模具壓緊與涂布好的納米壓印膠, 從而在納米壓印膠上復制出模具上的結構圖案。
為了減少壓印的壓力,納米壓印膠需要在壓印時非常軟 ,如水一樣(液態聚合物)。納米壓印膠有加熱型:膠在加熱時變軟但冷下來變硬;有紫外光照型:膠在光照前時是軟但光照后變硬;及熱光混合型。壓印后,模具和納米壓印膠分離-脫模過程。
能夠成為EUV的挑戰者,NIL自然是有自己的優勢。
第一是分辨率高,從理論上可以實現極高的分辨率,目前報道的加工精度已經達到 2 納米,超過了傳統光刻技術達到的分辨率。
第二是成本較低,無論是耗電量、購買價格還是運行成本都更低,與采用 250 瓦光源的 EUV 系統相比,佳能估計 NIL 僅消耗十分之一的能量。
第三是工藝簡單、效率高,EUV 光刻需要千瓦級激光器將熔融的錫滴噴射成等離子體等一系列復雜操作,而 NIL 將復制掩模直接壓在涂有液態樹脂的晶圓表面上,像壓印印章一樣。并且,NIL 技術使用的模板可以反復使用,且操作步驟相對較少。
最先進的納米壓印光刻 NIL 系統,可實現最小 14nm 線寬的圖案化,支持 5nm 制程邏輯半導體生產。
2.2 自由電子激光(FEL)技術
FEL的工作原理與傳統激光不同,它利用自由電子在磁場中的運動產生激光。自由電子激光的優勢在于其光電轉換效率極高,可達到30%以上,遠遠優于EUV的3%到5%。這種高效性意味著FEL設備在相同能耗下可以產生更多的光子,極大地提高了設備的工作效率和生產能力。在電力消耗方面,FEL光源也要遠低于EUV-LPP光源。
不過,這項技術也與前文提到的激光器類似,解決的是EUV光源的問題。
值得注意的是,EUV-FEL還可升級為BEUV-FEL,可以使用更短的波長(6.6-6.7 nm)實現更精細的圖案化。它還可以可變地控制FEL光的偏振,以實現High NA光刻。在這方面,德國、美國、中國都有相關研究。
2.3 電子束光刻(E-beam Lithography)
電子束光刻(e-beam lithography;EBL)是無掩膜光刻的一種,它利用波長極短的聚焦電子直接作用于對電子敏感的光刻膠(抗蝕劑)表面繪制形成與設計圖形相符的微納結構。
EUV光刻機產能不足,很大一部分原因是光學鏡頭的供貨不足。蔡司公司是EUV光刻鏡頭的唯一供應商。電子束光刻采用電子源發出電子束而并非光源,因此電子束光刻技術解決的是光刻機對光學鏡頭的依賴。
電子束具有波長短的優勢,波長越短,越可以雕刻出更精細的電路,芯片工藝的納米數也可以做到更小。EUV光刻機的波長為13.5nm,而100KeV電子束的波長只有0.004nm,波長短使其在分辨率方面與EUV相比有絕對的優勢,也使得電子束能夠實現EUV光刻都實現不了的先進制程技術。
2.4 多重圖案化技術(Multi-patterning)
多重圖案化是一種克服芯片制造過程中光刻限制的技術。
多重圖案化技術的核心原理是將復雜的芯片圖案分解為多個相對簡單的圖案,通過多次光刻和蝕刻工藝來實現最終的精細圖案。例如,在雙圖案化(double - patterning)技術中,對于一個原本需要單次光刻實現的精細間距圖案,先光刻和蝕刻出圖案的一部分,然后通過一些工藝調整(如沉積間隔層材料),再進行第二次光刻和蝕刻,將剩余部分的圖案制作出來,最終組合成完整的精細圖案。
之所以能夠成為EUV光刻的挑戰者,多重圖案化的優勢在于:第一,成本低。在現有的成熟光刻設備(如深紫外光刻,DUV)基礎上進行的工藝創新,避免了對 EUV 光刻設備的依賴,從而降低了芯片制造前期的設備投資成本。第二,工藝成熟度相對較高。因為是在傳統光刻工藝基礎上發展而來的,現在DUV 光刻技術已經非常成熟,多重圖案化技術可以很好地與這些現有的工藝步驟和設備集成。
不過,多重圖案化技術通常依賴于復雜的圖案化堆疊和集成方案,而這些方案通常伴隨著性能和良率問題,以及對晶圓設計的限制——并且成本和周期時間明顯增加。如果使用193nm 波長光刻系統在芯片上對特征進行圖案化,當到達5nm時,使用多重圖案化已經非常困難了。
-
光刻
+關注
關注
8文章
341瀏覽量
30609 -
EUV
+關注
關注
8文章
609瀏覽量
86961
原文標題:EUV光刻,新的對手
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄
智慧路燈的推廣面臨哪些挑戰?
碳納米管在EUV光刻效率中的作用

納米壓印光刻技術旨在與極紫外光刻(EUV)競爭
華為云榮登Gartner?云數據庫挑戰者象限
日本首臺EUV光刻機就位
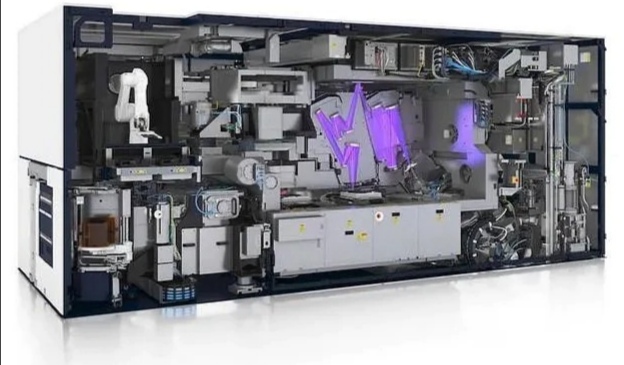









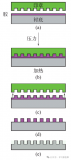












評論