文章來(lái)源:老虎說(shuō)芯
原文作者:老虎說(shuō)芯
本文介紹了光刻膠、曝光方式和光刻的主要步驟。
光刻工藝貫穿整個(gè)芯片制造流程的多次重復(fù)轉(zhuǎn)印環(huán)節(jié),對(duì)于集成電路的微縮化和高性能起著決定性作用。隨著半導(dǎo)體制造工藝演進(jìn),對(duì)光刻分辨率、套準(zhǔn)精度和可靠性的要求持續(xù)攀升,光刻技術(shù)也將不斷演化,支持更為先進(jìn)的制程與更復(fù)雜的器件設(shè)計(jì)。
一、光刻在集成電路制造中的地位
在制造集成電路時(shí),常需反復(fù)多次“轉(zhuǎn)印”設(shè)計(jì)圖形到硅襯底(硅片)上,而光刻正是承擔(dān)轉(zhuǎn)印這一核心任務(wù)的關(guān)鍵步驟。通過(guò)光刻工藝,我們能夠?qū)⒀谀0妫ㄒ喾Q(chēng)掩膜版、光罩)上的線(xiàn)路圖形,借助光敏材料(光刻膠)和光照,精準(zhǔn)地“曝光-顯影”到硅片表面所涂覆的光刻膠層中,并通過(guò)后續(xù)刻蝕等工序?qū)⒃搱D形最終“雕刻”到硅襯底或金屬層上。
由于光刻工藝區(qū)采用對(duì)光刻膠不敏感的黃色照明光源,因此光刻區(qū)域亦被稱(chēng)為“黃光區(qū)”。這不僅能防止雜散光對(duì)光刻膠造成非預(yù)期曝光,還使得工程人員可以在相對(duì)安全的環(huán)境中操作,而不必在完全黑暗中進(jìn)行。
二、光刻膠與曝光方式
1. 光刻膠的種類(lèi)
正膠(Positive Photoresist)
暴露在光(或特定波長(zhǎng))照射下的區(qū)域會(huì)變得更易溶于顯影液,曝光區(qū)域會(huì)被顯影劑“沖洗”掉,而未曝光區(qū)域則保留下來(lái)。
優(yōu)點(diǎn):能夠?qū)崿F(xiàn)納米級(jí)線(xiàn)寬的高分辨率,因而在先進(jìn)制程中普遍使用。
典型應(yīng)用:0.35 μm、0.25 μm 乃至 14 nm、7 nm 及以下節(jié)點(diǎn)。
負(fù)膠(Negative Photoresist)
暴露在光照下的區(qū)域會(huì)發(fā)生交聯(lián)反應(yīng),變得更加難溶于顯影液,最終保留在硅片表面,而未曝光區(qū)域則被沖洗掉。
優(yōu)點(diǎn):在某些大面積圖形或特定工藝中有穩(wěn)定的加工特性和較高的抗刻蝕能力。
局限:由于分辨率不如正膠,更多應(yīng)用在對(duì)線(xiàn)寬要求不極端苛刻的領(lǐng)域。
2. 光刻膠對(duì)波長(zhǎng)的敏感性
光刻膠的配方設(shè)計(jì)高度依賴(lài)所用光源的波長(zhǎng),比如:
i線(xiàn)(365nm)光刻膠通常采用重氮萘醌 (DNQ) 線(xiàn)性酚醛樹(shù)脂體系;
193nm(ArF)光刻膠需使用與該波段相匹配的新型聚合物及光敏成分,i線(xiàn)膠配方已不再適用;
先進(jìn)制程工藝(例如 EUV 13.5nm)更需專(zhuān)門(mén)的抗蝕劑材料方案。
3. 先進(jìn)制程中的“正膠負(fù)顯影”技術(shù)
對(duì)于 16nm/14nm 及以下節(jié)點(diǎn),在通孔和金屬層可使用“正膠負(fù)顯影”(PTD,Positive Tone Resist with Negative Development)工藝:
正膠正常情況下是“曝光后部分被顯影沖洗掉”,但通過(guò)采用負(fù)顯影液,將“未曝光”的部分清洗掉,留下的反而是“曝光區(qū)”。
優(yōu)勢(shì):能進(jìn)一步提升細(xì)小溝槽圖形的成像對(duì)比度,對(duì)某些關(guān)鍵層(如高深寬比通孔)有顯著好處。
三、光刻工藝的主要流程
1、底膜準(zhǔn)備
清洗與脫水
要徹底去除顆粒、金屬離子等污染物,以及襯底表面的水分。
提升襯底表面與光刻膠之間的黏附力,從而減少后續(xù)光刻中因膠層脫落造成的缺陷或圖形變形。
2、涂光刻膠與軟烘
旋涂光刻膠
將硅片置于旋涂設(shè)備(涂膠機(jī))中,通過(guò)高速旋轉(zhuǎn)使液態(tài)光刻膠均勻鋪展;
旋轉(zhuǎn)速度、膠液黏度和旋涂時(shí)間共同決定光刻膠膜厚度和均勻度。
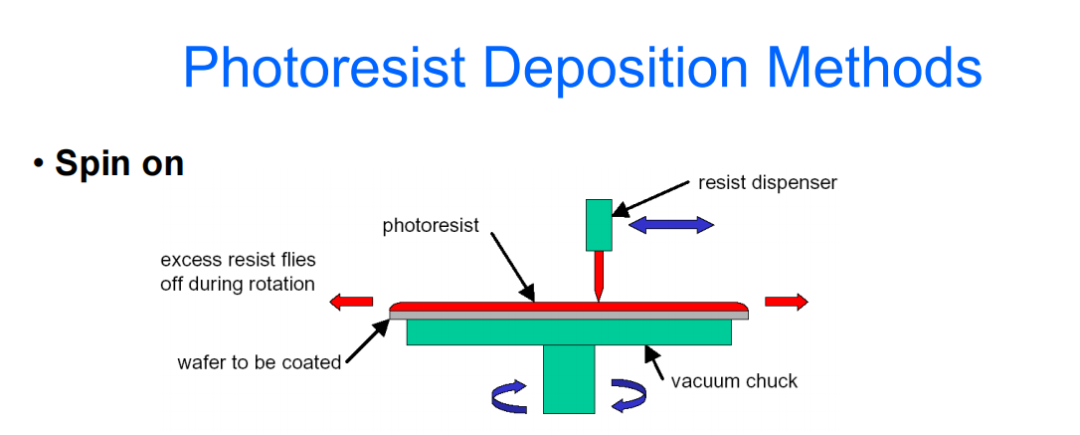
軟烘(Soft Bake)
通過(guò)低溫烘烤(一般 90~120°C 左右,具體視膠種而定),驅(qū)除光刻膠中的溶劑;
增強(qiáng)膠層與襯底的黏附性,提高厚度均勻性,為后續(xù)曝光顯影奠定基礎(chǔ)。
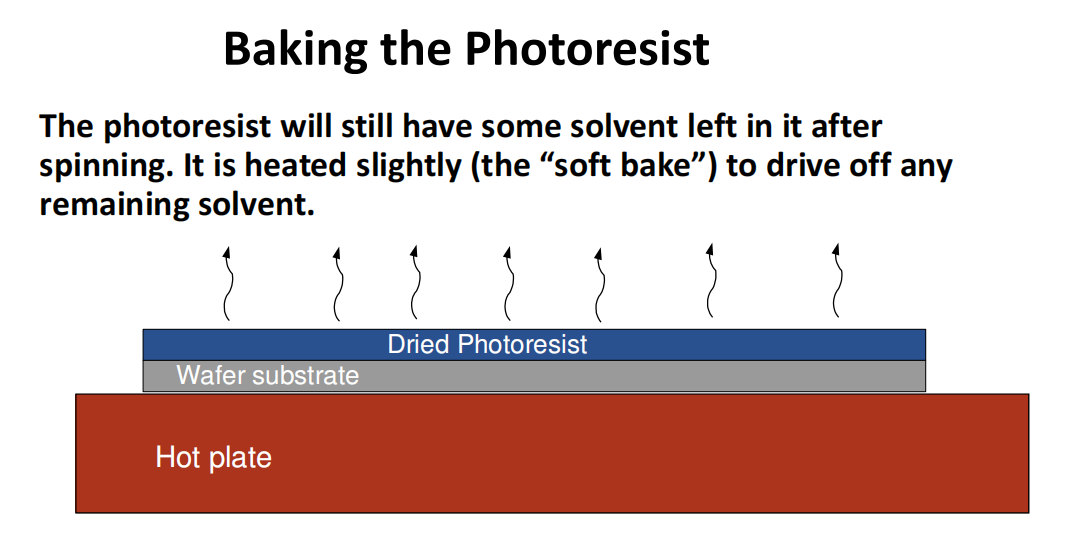
3、對(duì)準(zhǔn)、曝光與曝光后烘
對(duì)準(zhǔn)(Alignment):
將光刻機(jī)中的掩模版圖形與硅片上已形成的前層圖形進(jìn)行精確對(duì)準(zhǔn),確保層與層之間的電路通路和垂直位置吻合。
對(duì)準(zhǔn)精度是衡量光刻工藝質(zhì)量的重要指標(biāo)之一,也決定最終器件能否達(dá)成期望的尺寸與性能。
曝光(Exposure):
使用特定波長(zhǎng)的光源照射光刻膠,令光刻膠發(fā)生光化學(xué)反應(yīng);
193nm 的 ArF、365nm 的 i線(xiàn)等光刻工藝各具優(yōu)勢(shì)和局限,需要配合不同的設(shè)備與膠種。
光刻機(jī)是整條產(chǎn)線(xiàn)中最昂貴、最關(guān)鍵的裝備,其技術(shù)水平往往代表了一條生產(chǎn)線(xiàn)能否沖擊更先進(jìn)制程節(jié)點(diǎn)。
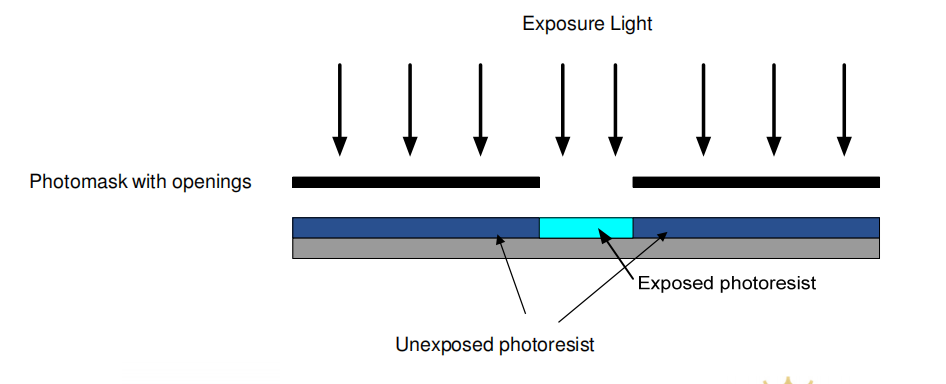
曝光后烘(Post-Exposure Bake, PEB):
對(duì)于深紫外 (DUV) 光刻膠,PEB 有助于去除保護(hù)基團(tuán),從而使膠層能更好地溶解于顯影液;
對(duì)于傳統(tǒng) i線(xiàn)光刻膠,PEB 可以減弱膠層中的駐波現(xiàn)象,提升圖形側(cè)壁的平滑度和形貌穩(wěn)定性。
4、顯影與堅(jiān)膜
顯影:
利用顯影液將曝光后(對(duì)正膠而言)可溶解的區(qū)域去除,將掩模版的圖形“顯”出來(lái);
顯影溫度、時(shí)間、顯影液濃度與清洗流程等都是影響線(xiàn)寬控制和圖形完整度的重要因素。
堅(jiān)膜(Hard Bake):
又稱(chēng)“堅(jiān)膜烘焙”,將顯影后光刻膠的殘余溶劑和水分進(jìn)一步去除,使得膠層更加堅(jiān)硬;
提高了光刻膠在后續(xù)刻蝕工序中對(duì)等離子體等惡劣環(huán)境的耐受力。
5、顯影檢測(cè)
通過(guò)自動(dòng)光學(xué)檢查(或圖像識(shí)別系統(tǒng))對(duì)顯影后圖形進(jìn)行缺陷檢測(cè);
若缺陷量超出可接受范圍,則判定為不良品,通常采取報(bào)廢或返工處理(光刻是少數(shù)可以“返工”的工藝之一,能夠通過(guò)去膠重新涂膠、再曝光來(lái)彌補(bǔ)錯(cuò)誤,減少?gòu)U片損失)。
四、光刻工藝關(guān)鍵指標(biāo)
分辨率 (Resolution)
能夠清晰分辨并成像的最小線(xiàn)寬/空間尺寸,是判斷光刻工藝極限能力的重要指標(biāo)。短波長(zhǎng)(如 193nm、13.5nm)并結(jié)合高數(shù)值孔徑(NA)鏡頭能實(shí)現(xiàn)更高分辨率。
靈敏度 (Sensitivity)
指光刻膠能在多大光劑量下充分發(fā)生化學(xué)變化。靈敏度過(guò)低意味著需要較長(zhǎng)曝光時(shí)間或更高劑量,易增加發(fā)熱、材料損傷或產(chǎn)能損失;靈敏度過(guò)高則可能因工藝窗口過(guò)小而造成穩(wěn)定性下降。
套準(zhǔn)精度 (Alignment Accuracy)
反映不同層圖形之間的重合偏差;隨著制程線(xiàn)寬愈來(lái)愈小,套準(zhǔn)誤差若過(guò)大將導(dǎo)致器件性能變差甚至失效。
缺陷率 (Defect Rate)
表征在曝光/顯影環(huán)節(jié)中是否產(chǎn)生不良孔洞、污點(diǎn)、圖形畸變等,缺陷率直接關(guān)系到最終良品率和成本。
五、類(lèi)比與直觀理解
“膠片攝影”類(lèi)比:可以將光刻理解為給“涂有感光材料的膠片”曝光并沖洗顯影的過(guò)程。掩模版好比底片,硅片表面的光刻膠好比膠片乳劑,曝光時(shí)將圖形“拍攝”下來(lái),顯影時(shí)則沖洗出圖形。不同之處在于半導(dǎo)體工業(yè)對(duì)尺寸和精度的要求極高,且種種化學(xué)及物理?xiàng)l件須精確控制。
“沖洗返工”優(yōu)勢(shì):在大多數(shù)半導(dǎo)體工藝步驟中,一旦發(fā)生錯(cuò)誤往往難以挽回,而光刻能夠通過(guò)再次“沖洗”掉光刻膠,重新涂膠與曝光來(lái)挽救某些失誤,這也是光刻工藝相對(duì)獨(dú)特之處。
六、總結(jié)與展望
總結(jié):光刻是將設(shè)計(jì)電路轉(zhuǎn)移到硅片表面的核心步驟,從襯底清洗、光刻膠涂布、對(duì)準(zhǔn)與曝光、顯影到堅(jiān)膜與檢測(cè),每一環(huán)節(jié)都有其嚴(yán)格的參數(shù)控制與質(zhì)量要求。光刻膠的選擇與光源波長(zhǎng)匹配、曝光機(jī)性能與套準(zhǔn)精度等都深刻影響最終制程的線(xiàn)寬與良率。
展望:隨著制程不斷邁向 7nm、5nm、3nm 乃至更小線(xiàn)寬,傳統(tǒng) DUV (ArF) 光刻逐漸由多重曝光或混合工藝與 EUV 光刻共同支撐。下一代光刻技術(shù)不僅在波長(zhǎng)上更短(EUV 13.5nm),設(shè)備與材料體系也變得更復(fù)雜昂貴。如何提高光刻膠抗蝕刻能力、解決 EUV 的掩模缺陷與光源效率問(wèn)題等,仍是行業(yè)重點(diǎn)攻關(guān)的關(guān)鍵課題。
-
集成電路
+關(guān)注
關(guān)注
5409文章
11765瀏覽量
365290 -
半導(dǎo)體
+關(guān)注
關(guān)注
335文章
28131瀏覽量
227024 -
制造工藝
+關(guān)注
關(guān)注
2文章
192瀏覽量
19998 -
光刻工藝
+關(guān)注
關(guān)注
1文章
32瀏覽量
1896
原文標(biāo)題:光刻工藝:光刻膠、曝光方式、光刻主要步驟
文章出處:【微信號(hào):bdtdsj,微信公眾號(hào):中科院半導(dǎo)體所】歡迎添加關(guān)注!文章轉(zhuǎn)載請(qǐng)注明出處。
發(fā)布評(píng)論請(qǐng)先 登錄
相關(guān)推薦
光刻工藝的基本步驟
示波器的關(guān)鍵指標(biāo)
光刻膠與光刻工藝技術(shù)
看懂光刻機(jī):光刻工藝流程詳解
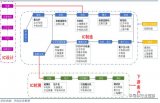
PCB蝕刻工藝原理_pcb蝕刻工藝流程詳解
半導(dǎo)體等精密電子器件制造的核心流程:光刻工藝
功率半導(dǎo)體分立器件工藝流程
什么是光刻工藝?光刻的基本原理

工業(yè)ai質(zhì)檢的關(guān)鍵指標(biāo)有哪些
光刻工藝的基本步驟 ***的整體結(jié)構(gòu)圖
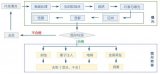
光刻工藝的基本知識(shí)




















評(píng)論