聚焦離子束(Focused-Ion-Beam, FIB)技術是一種先進的微納加工與分析手段。其基本原理是通過電場和磁場的作用,將離子束聚焦到亞微米甚至納米級別,并利用偏轉和加速系統控制離子束的掃描運動,實現微納圖形的監測分析以及微納結構的無掩模加工。
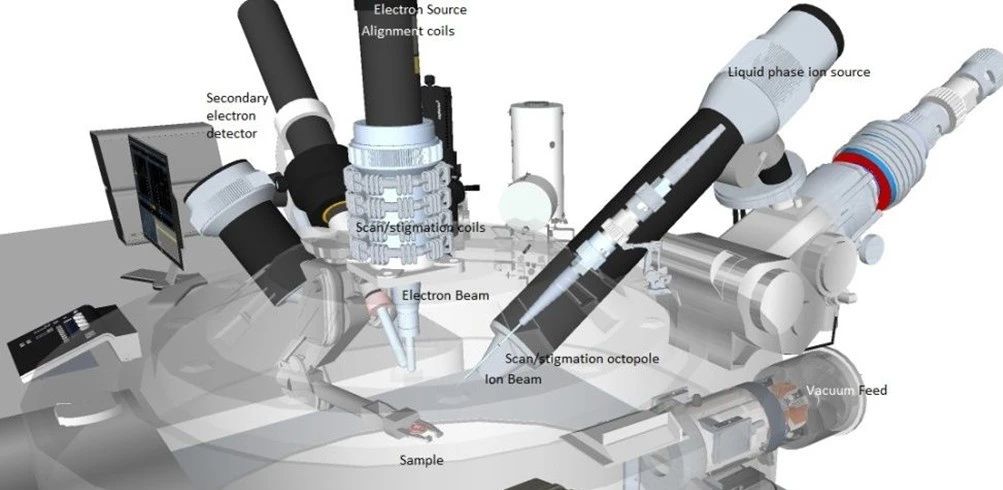
FIB系統基本組成
FIB系統由多個關鍵部分組成,如圖1所示。離子源是系統的核心,通常采用液態金屬離子源,如鎵離子源。針型液態金屬離子源的尖端是一個直徑約幾微米的鎢針,針尖正對著孔徑。在外加電場的作用下,加熱金屬使其液態化并浸潤針尖,從而形成離子流。離子源發射的離子經過光闌限束后,由聚焦系統聚焦,再通過不同孔徑的可變光闌,得到束流可控的離子束。離子束在偏轉系統的控制下,按照特定路徑進行掃描,最終通過物鏡入射到樣品表面。
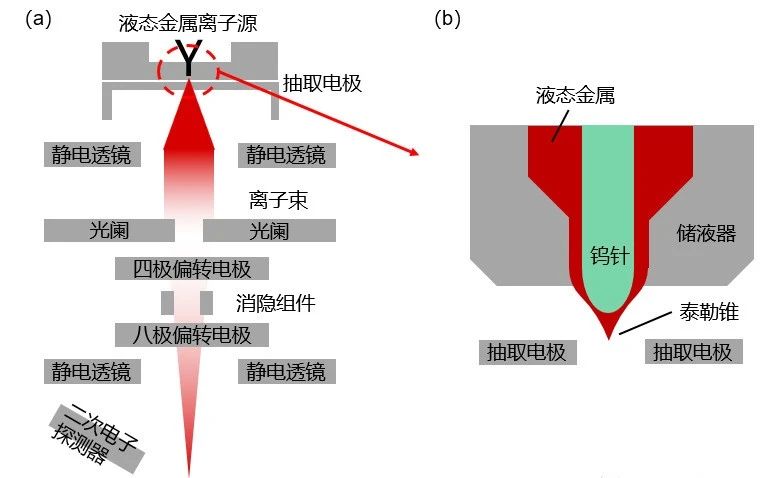
由于離子轟擊襯底會產生二次電子,通過掃描電子顯微鏡(Scanning Electron Microscope, SEM)可以監測二次電子,從而獲得樣品表面的形貌圖。這種同時具備FIB加工和觀測功能的系統通常被稱為雙束系統,例如FIB-SEM雙束系統和FIB-TEM雙束系統。金鑒實驗室具備Dual Beam FIB-SEM業務,包括透射電鏡( TEM)樣品制備,材料微觀截面截取與觀察、樣品微觀刻蝕與沉積以及材料三維成像及分析等。
FIB與電子束/光學光刻的對比
1.加工過程
FIB、電子束光刻(Electron Beam Lithography, EBL)和光學光刻(Photolithography)三種加工方式的本質都是將圖形轉移到特定襯底上,但由于工藝不同,其步驟和復雜程度也有所不同。光刻和EBL需要通過光或電子束使光刻膠變性,再通過顯影將變性的光刻膠洗掉,從而將圖案轉移到光刻膠上。隨后,通過刻蝕工藝將圖案轉移到襯底上。而FIB則可以直接利用離子束對樣品表面進行定點轟擊,完成微納結構加工,無需光刻膠和掩模版。
2.從刻蝕角度分析三者
雖然三者都需要通過離子將特定位置的原子剝離以完成圖案轉移,但具體使用的離子和刻蝕方式有所不同。FIB需要離子源對環境條件要求低,并且能提供大束流。其刻蝕過程為物理過程,濺射逸出的顆粒大部分被真空泵抽走,但部分顆粒會掉落在刻蝕區域附近,尤其在刻蝕大深寬比器件時,這種現象更為嚴重,可能會對光學器件的性能產生較大影響。相比之下,光刻和電子束光刻大多采用電感耦合等離子體反應離子刻蝕(Induction Coupling Plasma-Reactive Ion Etching, ICP-RIE)。這種刻蝕方法結合了物理和化學過程,在離子對襯底的濺射基礎上,增加了離子與襯底的化學反應并生成氣體。通過抽氣裝置和調節氣體流速,可以及時將襯底表面的氣體抽運走,從而不影響加工精度。
3.從加工速度分析
在加工速度方面,光刻是最快的,且吞吐量最大,能夠批量生產大量芯片。而EBL和FIB需要使用位移系統對刻蝕區域進行掃描。電子束只需誘導電子抗刻蝕劑變性,時間相對較短;而FIB需要對輻照區域進行剝離,對于面積大、深度深、精度高的刻蝕任務,所需時間較長。此外,光刻和EBL在刻蝕過程中由于有光刻膠保護,可以采用整體刻蝕,時間大大減少。
4.對比總結與光刻和電子束光刻相比,FIB的加工步驟明顯減少,能夠實現“即刻加工,所見即所得”,并且可以沉積微小結構。
其載物臺可以實現多軸移動,結合離子注入可以控制結構的內部應力,從而加工復雜的三維結構。
FIB應用
1.微納結構制備
FIB在微納結構制備方面具有獨特優勢。與電子束光刻相比,FIB省去了繁瑣的步驟,大大減少了加工參數的摸索時間,同時可以加工特征尺寸特別小的結構(幾十納米)。然而,其加工面積較小,加工的側壁可能不夠陡直。
2.芯片修補與線路編輯
FIB的離子束加工功能使其不僅可以刻蝕,還可以利用高能離子輻照誘導特定區域發生化學氣相沉積反應。結合離子束轟擊產生的二次電子,可以觀察樣品表面形貌圖像。FIB的“看”、“刻”、“生長”功能使其非常適用于芯片或掩模(Mask)的缺陷修復,例如切斷短路、對斷路進行沉積等。
3.透射電鏡(TEM)制樣
透射電鏡(TEM)樣品需要非常薄,以便電子能夠穿透并形成衍射圖像。FIB的靈活多軸載物臺可以對樣品進行復雜操作,從而輕松完成TEM樣品的制備。
-
fib
+關注
關注
1文章
94瀏覽量
11340 -
離子束
+關注
關注
0文章
85瀏覽量
7737
發布評論請先 登錄
FIB聚焦離子束電路修改服務
Dual Beam FIB(雙束聚焦離子束)
聚焦離子束應用介紹
聚焦離子束技術在納米加工中的應用與特性
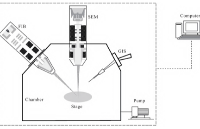
聚焦離子束技術:納米加工與分析的利器









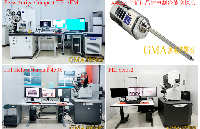



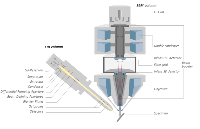













評論