本文聚焦于先進碳化硅(SiC)功率半導體封裝技術,闡述其基本概念、關鍵技術、面臨挑戰及未來發展趨勢。碳化硅功率半導體憑借低內阻、高耐壓、高頻率和高結溫等優異特性,在移動應用功率密度提升的背景下,對封裝技術提出全新要求。先進的封裝技術能夠充分發揮碳化硅器件的優勢,提升功率模塊的性能與可靠性,推動電力電子系統向更高效率、更高功率密度方向發展。
一、引言
在當今科技飛速發展的時代,電力電子系統在眾多領域扮演著至關重要的角色,如電動汽車、可再生能源發電、智能電網等。隨著這些領域對電力電子系統性能要求的不斷提高,傳統的硅基功率半導體器件逐漸難以滿足需求。碳化硅(SiC)功率半導體作為一種新型寬禁帶半導體材料,具有低內阻、高耐壓、高頻率和高結溫等優異特性,為電力電子系統的發展帶來了新的機遇。然而,要充分發揮碳化硅功率半導體的優勢,先進的封裝技術不可或缺。封裝技術不僅影響器件的電氣性能和可靠性,還決定了功率模塊的體積、重量和成本。因此,深入研究先進碳化硅功率半導體封裝技術具有重要的現實意義。
二、碳化硅功率半導體封裝概述
(一)碳化硅功率半導體的特性
碳化硅材料具有諸多獨特的物理特性,使其成為制作功率半導體的理想材料。其禁帶寬度約為硅基材料的3倍,臨界擊穿場強約為硅基材料的10倍,熱導率約是硅基材料的3倍,電子飽和漂移速率約是硅基材料的2倍。這些特性使得碳化硅功率半導體能夠在高溫、高壓、高頻環境下穩定工作,具有更低的導通損耗和開關損耗,能夠實現更高的功率密度和轉換效率。例如,在電動汽車中,采用碳化硅功率半導體器件的電機控制器,可使車輛續航里程提升5%—10%,同時充電速度也大幅加快。
(二)封裝的作用與要求
封裝是半導體制造的關鍵環節,對于碳化硅功率半導體而言,封裝的主要作用是實現器件與外部電路的電氣連接、提供機械支撐和保護、實現散熱以及提高器件的可靠性。由于碳化硅功率半導體的高溫、高頻特性,對封裝技術提出了更高的要求。封裝材料需要具備良好的高溫穩定性、高導熱性和低熱膨脹系數,以確保器件在高溫環境下能夠正常工作,并有效降低熱應力對器件性能的影響。同時,封裝結構需要優化,以降低寄生電感和電阻,提高器件的開關速度和效率。
三、先進碳化硅功率半導體封裝關鍵技術
(一)低雜散電感封裝技術
碳化硅器件的開關速度極快,開關過程中的dv/dt和di/dt均極高。雖然器件開關損耗顯著降低,但傳統封裝中雜散電感參數較大,在極高的di/dt下會產生更大的電壓過沖以及振蕩,引起器件電壓應力、損耗的增加以及電磁干擾問題。為了解決這一問題,國內外學者們研究開發了一系列新的封裝結構,用于減小雜散參數,特別是降低雜散電感。
- 單管翻轉貼片封裝:借鑒BGA的封裝技術,通過一個金屬連接件將芯片背部電極翻轉到和正面電極相同平面位置,然后在相應電極位置上植上焊錫球,消除了金屬鍵合線和引腳端子。相比傳統的TO-247封裝,體積減小了14倍,導通電阻減小了24%。
- DBC+PCB混合封裝:將DBC工藝和PCB板相結合,利用金屬鍵合線將芯片上表面的連接到PCB板,控制換流回路在PCB層間,大大減小了電流回路面積,進而減小雜散電感參數。該混合封裝可將雜散電感控制在5nH以下,體積相比于傳統模塊下降40%。
- 芯片正面平面互連封裝:采用平面互連的連接方式來實現芯片正面的連接,如Silicon Power公司采用端子直連(DLB)的焊接方法,類似的還有IR的Cu-Clip IGBT,Siemens的SiPLIT技術等。平面互連的方式不僅可以減小電流回路,進而減小雜散電感、電阻,還擁有更出色的溫度循環特性以及可靠性。
(二)高溫封裝技術
碳化硅器件的工作溫度可達到300℃以上,而現有適用于硅器件的傳統封裝材料及結構一般工作在150℃以下,在更高溫度時可靠性急劇下降,甚至無法正常運行。解決這一問題的關鍵在于找出適宜高溫工作的連接材料,匹配封裝中不同材料的熱性能。
- 高溫封裝材料:常見的覆銅陶瓷基板(DBC)主要采用氧化鋁(Al?O?)和氮化鋁(AlN),這兩種材料在300℃時僅20—30個循環次數便會失效,不適用于高溫封裝場合。SiC模塊封裝的趨勢是采用氮化硅陶瓷基板,并結合使用活性金屬釬焊(AMB)技術。AMB工藝可靠性明顯高于DBC,其基板材料主要有Si?N?和AlN,前者熱膨脹系數更低,可靠性更高,后者的熱導性更好。現階段,Si?N?導熱性與AlN相差不多,同時基板厚度可以薄至0.25mm(AlN需要0.63mm以上),因此Si?N?用于SiC模塊封裝越來越成為趨勢。
- 納米銀燒結技術:是大功率器件最合適的界面互連技術之一,具有傳統功率粘結材料無法比擬的優點,低溫燒結高溫使用,具有良好的高溫工作特性。納米銀燒結層的熱導率可以達到150—300W/(K·m),模塊溫度循環的可靠性提高5倍以上,其燒結面的電阻率可以降低至8×10??Ω·cm2。銀燒結工藝使用的焊料一般有銀膏和銀膜,銀膏燒結工藝流程是“銀膏印刷—預熱烘烤—芯片貼片—加壓燒結”,而銀膜燒結工藝流程是“芯片轉印—芯片貼片—加壓燒結”。銀燒結技術在車規級SiC器件/模塊中的重要性更顯著,據檢測機構分析,銀燒結+鋁線的組合可使SiC通過5萬次循環壽命的界限,而銅線+銀燒結的組合可超過車規級壽命需求。
(三)多功能集成封裝技術
多功能集成封裝技術以及先進的散熱技術在提升功率密度等方面也起著關鍵作用。通過在模塊中集成去耦電容、溫度/電流傳感器以及驅動電路等組件,實現模塊的功能集成,提高系統的集成度和可靠性。例如,一些先進的碳化硅功率模塊內置了溫度傳感器,且PTC安裝在靠近芯片的模塊中心位置,得到了一個緊密的熱耦合,可方便精確地對模塊溫度進行測量。同時,采用先進的散熱技術,如雙面散熱封裝,能夠有效降低模塊的熱阻,提高模塊的散熱能力。雙面散熱封裝模塊上下表面均采用DBC板進行焊接,所以可實現上下表面同時散熱。得益于上下DBC的對稱布線與合理的芯片布局,該封裝可將回路寄生電感參數降到3nH以下,模塊熱阻相比于傳統封裝下降38%。
四、先進碳化硅功率半導體封裝面臨的挑戰
(一)成本問題
高成本是目前SiC功率模塊發展的最大瓶頸,相較于硅基IGBT模塊,其成本現階段仍高出2—3倍。這主要是由于SiC材料制備成本高、封裝工藝復雜以及生產規模較小等原因導致的。為了降低成本,需要不斷提高SiC材料的制備工藝水平,降低材料成本;同時,優化封裝工藝,提高生產效率,降低封裝成本。此外,隨著SiC功率模塊市場需求的增加,生產規模的擴大也將有助于降低成本。
(二)可靠性問題
盡管SiC材料本身具有優異的性能,但在封裝過程中,由于不同材料之間的熱膨脹系數不匹配、界面熱應力等問題,容易導致封裝結構的可靠性下降。例如,在高溫工作環境下,封裝材料與SiC芯片之間的熱膨脹系數差異會產生熱應力,長期作用下可能導致封裝結構開裂、芯片脫落等問題,影響器件的可靠性和壽命。為了提高封裝可靠性,需要選擇熱膨脹系數與SiC芯片相匹配的封裝材料,優化封裝結構設計,減少熱應力的產生。同時,加強對封裝工藝的質量控制,確保封裝結構的質量和可靠性。
(三)技術標準與規范不完善
目前,碳化硅功率半導體封裝技術還處于發展階段,相關的技術標準與規范還不夠完善。這導致不同廠家生產的碳化硅功率模塊在性能、尺寸、接口等方面存在差異,給產品的選型和應用帶來了一定的困難。為了促進碳化硅功率半導體封裝技術的健康發展,需要加快制定統一的技術標準與規范,明確產品的性能指標、測試方法、接口標準等,提高產品的兼容性和互換性。
五、未來發展趨勢
(一)封裝結構進一步優化
未來,碳化硅功率半導體封裝結構將朝著更緊湊、更高效的方向發展。通過采用新型的
-
功率半導體
+關注
關注
23文章
1294瀏覽量
43932 -
半導體設備
+關注
關注
4文章
395瀏覽量
15868
發布評論請先 登錄
熱泵與空調全面跨入SiC碳化硅功率半導體時代:能效革命與產業升級

國產SiC碳化硅功率半導體企業引領全球市場格局重構
基本半導體攜碳化硅功率器件亮相PCIM Europe 2025









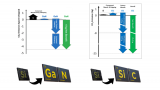

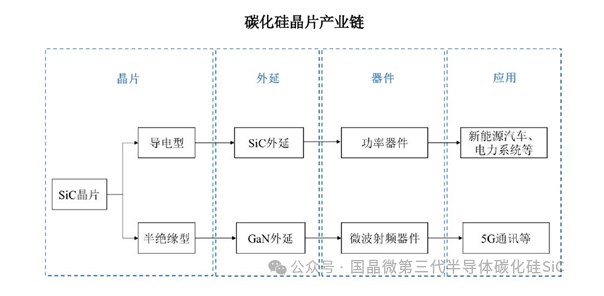
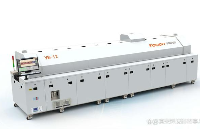
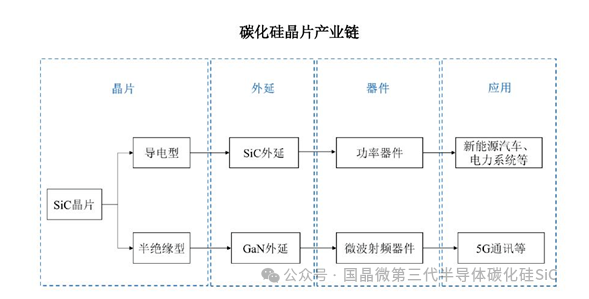











評論