文章來源:晶格半導體
原文作者:晶格半導體
本文介紹了用TSSG法生長SiC單晶來解決傳統方法生長的困難。
傳統熔體法的局限
SiC的物理特性決定了其生長難度。在常壓環境下,SiC并無熔點,一旦溫度攀升至2000℃以上,便會直接發生氣化分解現象。從理論層面預測,只有在壓強高達109Pa且溫度超過3200℃的極端條件下,才有可能獲取滿足化學計量比的SiC熔體。如此嚴苛的條件,使得通過傳統的同成分SiC熔體緩慢冷卻凝固的熔體法來生長SiC單晶變得極為困難,不僅對設備的耐高溫、耐壓性能要求近乎苛刻,還會導致生產成本飆升,生長過程的可操作性和穩定性極差。
液相法生長的理論突破
轉機來自對Si-C二元相圖的研究。在相圖的富Si端,存在著“L+SiC”的二相區,這一發現為SiC的液相法生長開辟了新路徑。起初,研究人員嘗試以純Si作為自助熔劑,采用高溫溶液生長法(HTSG)來生長SiC單晶。然而,在2000℃以下的溫度區間,Si熔體對C的溶解度極低,不足1% 。這一低溶解度嚴重限制了SiC晶體生長時對C元素的需求,導致晶體生長速率緩慢,結晶質量難以提升,尺寸拓展也面臨瓶頸。即便試圖通過升高溫度來增加Si熔體對C的溶解度,又會引發Si熔體大量揮發的問題,使得晶體生長難以持續穩定進行。
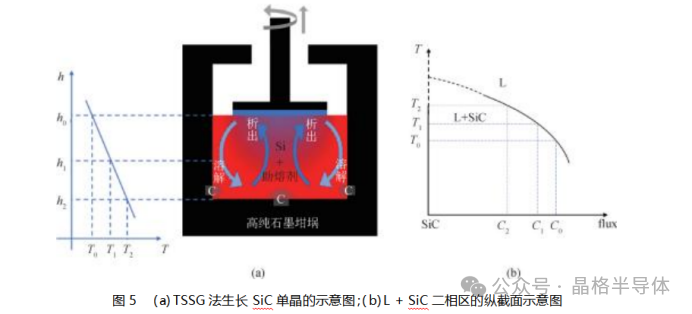
TSSG法核心原理的形成
為突破上述困境,科研人員探索出兩種途徑。第一種是高溫高壓技術,雖能在一定程度上升溫提高C的溶解度,同時利用高氣壓抑制Si的揮發,但該方法技術難度極大,生長成本高昂,且對C溶解度的提升效果有限,后續發展受限。第二種途徑則是在Si熔體中添加對C有較高溶解度的助熔劑元素(如過渡族金屬元素或稀土元素等)。這一方法不僅能夠有效提高C在高溫溶液中的溶解度,還能大幅降低晶體生長所需的溫度和氣壓,極大地降低了HTSG法生長SiC單晶的技術門檻和成本,成為當前TSSG法的核心原理基礎,被廣泛應用。
TSSG法生長過程的原理闡釋
(一)原料與裝置的原理設計
TSSG法生長SiC單晶的裝置設計蘊含著精妙的原理。通常,將Si和助熔劑元素放置在高純石墨坩堝中,籽晶桿與冷端相連。高純石墨坩堝在此扮演著雙重關鍵角色,一方面,它作為容器盛放高溫溶液;另一方面,鑒于高溫溶液對C的溶解度較低,為實現大的生長量,在生長過程中持續補充C至關重要,而高純石墨坩堝能夠穩定地為晶體生長提供C源,這是一種既簡便又高效的供C方式,保障了晶體生長過程中C元素的穩定供應。

(二)溫場控制與生長啟動原理
生長伊始,將坩堝中的原料加熱至熔融狀態,此時,精確控制溫場成為關鍵環節。通過特定的技術手段,使高溫溶液在軸向上形成特定的溫度梯度。穩定的溫場建立后,當高溫溶液中C的濃度達到平衡時,便將籽晶下推使其與高溫溶液接觸,由此正式啟動晶體生長。這一過程中,溫場的精確控制原理在于利用溫度差來驅動溶質的傳輸和晶體的生長。溫度梯度的存在使得高溫溶液中的溶質具有從高溫區域向低溫區域擴散的趨勢,為晶體生長提供了物質傳輸的動力,而籽晶的引入則為晶體生長提供了結晶核心,引導SiC晶體在籽晶表面有序生長。
(三)溶質傳輸與晶體持續生長原理
在晶體生長過程中,坩堝底部的高溫溶液會持續地從石墨坩堝壁溶解C。這一溶解過程基于石墨在高溫下的穩定性和C元素的活性,使得C能夠不斷融入高溫溶液。隨后,在高溫溶液對流和溶質擴散作用下,C被源源不斷地傳輸到溫度相對較低的晶體生長界面處。晶體生長的驅動力f與高溫溶液中C濃度緊密相關,根據公式f∝-ΔG=RTln(C/C0)(其中C為晶體生長界面處C的實際濃度,C0為高溫溶液在溫度為T時C的飽和濃度),當C>C0時,意味著高溫溶液處于過飽和狀態,此時晶體生長的驅動力f>0,SiC會不斷從高溫溶液中析出,進而實現晶體的持續生長。這一原理揭示了溶質濃度差在晶體生長中的關鍵作用,通過維持晶體生長界面處的過飽和狀態,保證了晶體生長的持續進行。

生長關鍵平衡與調控原理
(一)多平衡體系的協同原理
理想的TSSG法生長SiC單晶狀態,依賴于多個關鍵平衡的協同維持。坩堝內高溫溶液中C的溶解、傳輸與消耗的平衡,確保了C元素在整個生長體系中的穩定供應與合理利用;坩堝中熱量輸入與耗散的平衡,維持了生長環境溫度的穩定,避免因溫度波動影響晶體生長;晶體生長界面處溶質的傳入與單晶生長消耗的平衡,保證了晶體生長的連續性和穩定性;晶體生長界面處熱量輸入與傳出的平衡,有助于維持晶體生長界面的穩定性,避免因熱量積聚或散失過快導致晶體缺陷。這些平衡相互關聯、相互影響,共同構建起一個穩定的晶體生長環境。
(二)溶質傳輸的核心原理
溶質C的傳輸在TSSG法生長SiC單晶過程中占據核心地位。熱量傳輸所形成的溫度梯度是溶質傳輸和晶體生長的根本驅動力。高溫溶液的熱力學性質,諸如對C的溶解度、黏度以及與SiC之間的界面能等,都會對溶質C的溶解、傳輸供應和單晶生長消耗產生顯著影響。同時,坩堝中溫度梯度、坩堝結構和尺寸等因素,會改變高溫溶液的對流形式,進而影響溶質C在整個體系中的傳輸過程。例如,合理的坩堝結構和溫度梯度設置,可以促進高溫溶液形成有利于溶質傳輸的對流模式,增強C元素向晶體生長界面的傳輸效率,從而推動晶體生長。
(三)生長速率與質量調控原理
一般情況下,生長過程中C的供應速率越大,晶體生長界面附近的過飽和度越大,晶體的生長速率也就越大。然而,當C供應速率過快,導致過飽和度太大時,會使晶體生長界面失穩。這是因為過大的過飽和度會破壞晶體生長界面的原子排列有序性,引發高溫溶液在晶體中的包裹現象,以及在晶體表面形成溝槽狀缺陷,甚至會促使SiC在高溫溶液中均勻形核,這些問題都會嚴重影響單晶的生長質量。因此,精確調控高溫溶液的熱力學性質以及溶質傳輸過程和晶體生長界面處的動力學,使溶質C在整個生長系統中實現良好的供需動態平衡,成為調控晶體生長速率與質量的關鍵原理。通過優化助熔劑的成分和配比、調整溫場參數以及控制生長工藝等手段,可以實現對這一平衡的精準調控,從而生長出高質量的SiC單晶。
-
晶體
+關注
關注
2文章
1386瀏覽量
36172 -
工藝
+關注
關注
4文章
677瀏覽量
29289 -
SiC
+關注
關注
31文章
3174瀏覽量
64557
原文標題:TSSG法生長SiC單晶的原理
文章出處:【微信號:bdtdsj,微信公眾號:中科院半導體所】歡迎添加關注!文章轉載請注明出處。
發布評論請先 登錄


我國SiC單晶生長設備和粉料獲新突破
淺談半導體工藝的頭道工序——單晶體拉胚的單晶爐
天科合達談八英寸SiC
PVT法碳化硅SIC單晶生長工藝真空壓力控制裝置的解決方案

液相法、3C-SiC!中科院又取得新成果
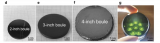
SiC碳化硅單晶的生長原理








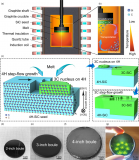


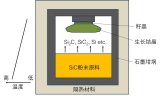












評論