在傳統MOSFET中,載流子從源極越過pn結勢壘熱注入到溝道中。而隧穿場效應晶體管(Tunneling Field-Effect Transistor或者TFET)的工作原理是帶間隧穿(Band-to-band tunneling或者BTBT)。BTBT最早由Zener在1934年提出來。pn結在反偏狀態下,當n區導帶中某些未被電子占據的空能態與p區價帶中某些被電子占據的能態具有相同的能量,而且勢壘區很窄時,電子會從p區價帶隧穿到n區導帶。下圖是一個典型的雙柵結構的Si TFET示意圖,其中tox表示柵介質的厚度,tsi表示體硅的厚度。TFET是一個p+-i-n+結構,i區上方是柵介質和柵電極。它通過柵極電壓的變化調制i區的能帶來控制器件的電流。

在理想狀態下,一個p+區和n+區摻雜對稱的TFET在不同極性的柵極電壓偏置下可以表現出雙極性。所以對于n型TFET來說,p+區是源區,i區是溝道區,n+區是漏區。對于p型TFET來說,p+區是漏區,i區是溝道區,n+區是源區。漏極電壓用Vd表示,柵極電壓用Vs表示,柵極電壓用Vg表示。
隧穿場效應晶體管是什么----隧穿場效應晶體管工作原理
隧穿場效應晶體管(TFET)的工作原理是帶間隧穿,其S可以突破60mV/decade的限制,而且TFET的Ioff非常低,所以TFET的工作電壓可以進一步地降低。如下圖中的虛線所示,在比較小的柵電壓條件下,TFET的Ion和Ion/Ioff都會大于傳統MOSFTE的Ion和Ion/Ioff。所以TFET被看做是非常有前景的低工作電壓和低功耗的邏輯CMOS器件。
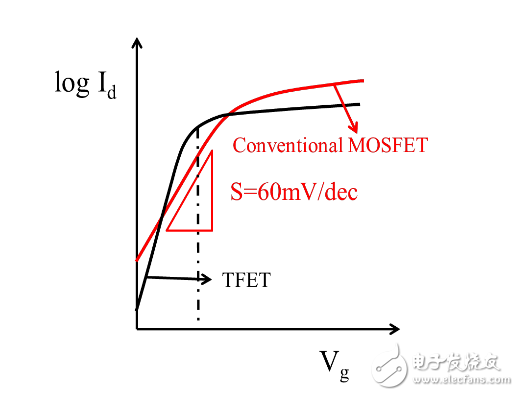
除了使用多柵結構提高器件的柵控能力和S小于60mV/decade的TFET,另一種減小集成電路功耗的方法是降低晶體管的工作電壓Vdd。傳統的MOSFET等比例縮小原則假設閾值電壓也能等比例的縮小,但是實際上閾值電壓并不遵循這樣的原則。所以持續地減小工作電壓必然會導致柵極的驅動能力(Vdd-Vth)降低。當柵極驅動能力降低時,器件的驅動電流Ion會減小。Ion的減小使器件的延遲(t=CVdd/Ion)增加或者器件的開關速度減小。由于InAs和GaAs的電子遷移率高于Si的電子遷移率,Ge和InSb的空穴遷移率高于Si的空穴遷移率,如果選用上述高遷移率的材料作為器件的溝道材料可以緩解(Vdd-Vth)的降低帶來的Ion減小,所以在高速度和低功耗的集成電路中,III-V材料和Ge都是很有前景的器件溝道材料。
